Диодная структура с р – n переходом
1. Схема устройства и виды диодной структуры
Приведенные выше аналитические соотношения для электронно-дырочного перехода и его вольт-амперной характеристики (ВАХ) относятся фактически к идеальному р – n переходу, так как учитывают не все явления, присущие реальной р – n структуре. К таким явлениям в первую очередь относятся: термогенерация пар носителей заряда в самом переходе, рекомбинация в нем основных носителей заряда, внедрившихся в переход, но не преодолевших потенциального барьера, токи утечки, конечное сопротивление областей р – n структуры, примыкающих к переходу, пробой перехода при определенных обратных напряжениях и др. Поэтому реальная ВАХ р – n перехода будет отличаться от теоретической.
Под диодной структурой (ДС) с р – n переходом будем понимать реальную р – n структуру (рис.1), на основе которой могут быть созданы различного вида полупроводниковые дискретные электронные приборы, элементы и компоненты интегральных микросхем, использующие в различной степени те или иные свойства электронно-дырочного перехода.
Основные элементы ДС. Схема устройства диодной структуры (рис.1) включает следующие основные элементы: 1 – электронно-дырочный переход, 2 – примыкающие к р – n переходу области полупроводника, 3 – омические контакты.
Ранее отмечалось, что на практике используются несимметричные
р – n переходы. Область, из которой происходит инжекция носителей заряда, 
|
 ; область, в которую происходит инжекция носителей заряда, называет ся базой, она имеет концентрацию примеси
; область, в которую происходит инжекция носителей заряда, называет ся базой, она имеет концентрацию примеси  .
.
Соответственно величина  >>
>>  .
.
Такое соотношение уровней примесей, в частности, для варианта ДС, когда  =
=  ,
,  =
=  (
(  >>
>>  ) позволяет при прочих одинаковых условиях достичь большей величины обратного напряжения, при которой нарушается нормальная работа р – n перехода. Это связано с тем, что основной составляющей обратного тока через переход будет дырочный ток, так как
) позволяет при прочих одинаковых условиях достичь большей величины обратного напряжения, при которой нарушается нормальная работа р – n перехода. Это связано с тем, что основной составляющей обратного тока через переход будет дырочный ток, так как
 >>
>>  , а подвижность дырок
, а подвижность дырок  <
<  .
.
Примыкающие к переходу области полупроводника вместе с сопротивлением омических контактов характеризуются сопротивлением  , которое в основном определяется сопротивлением низколегированной области, которой является база ДС.
, которое в основном определяется сопротивлением низколегированной области, которой является база ДС.
В качестве полупроводниковых материалов при изготовлении ДС чаще всего используются кремний и германий, а также арсенид галлия и карбид кремния.
Виды диодных структур. ДС подразделяются по многим признакам. Среди них в первую очередь выделяют различия по конструкции и технологии производства.
По конструкции различают плоскостные, точечные и поликристаллические ДС. По технологии производства ДС различаются методами изготовления - сплавления, диффузии, эпитаксии и имплантации.
Плоскостные ДС. В плоскостных ДС линейные размеры перехода, определяющие его площадь, значительно больше его толщины. Плоскостные ДС изготавливают главным образом по сплавной и диффузионной технологиям с применением операций эпитаксии и имплантации.
На рис.2 в качестве примера приведены схемы ДС, выполненных методами сплавления (а), диффузии (б) и с применением эпитаксиального наращивания (в).
При изготовлении методом сплавления в исходную пластину, например, германия n - типа, выполняющую роль базы, вплавляют при температуре 500о С каплю индия, которая растворяет прилегающую к ней поверхность пластины германия. При остывании на границе сплава кристаллизуется тонкий слой германия, легированный индием, т.е. образуется область  - типа (эмиттер). Омические контакты формируются, например, с помощью свинцово-оловянного припоя, а также путем припаивания к индию проволочки из никеля.
- типа (эмиттер). Омические контакты формируются, например, с помощью свинцово-оловянного припоя, а также путем припаивания к индию проволочки из никеля.
При изготовлении ДС сплавным методом получают резкие или ступенчатые переходы, в которых толщина области изменения концентрации примесей меньше толщины области пространственного заряда, образующего р – n переход.
В случае изготовления плоскостного перехода диффузионным методом (рис.2,б) производится диффузия, например, акцепторной примеси из газовой среды вглубь исходной высокоомной пластины из кремния (базы) с проводимостью n – типа, приводя к образованию области с проводимостью  - типа (эмиттер). В такой структуре концентрация введенной в поверхностный слой примеси уменьшается с глубиной (рис.3), поэтому переход получается плавным, так как толщина области изменения концентрации примесей сравнима с толщиной области пространственного заряда (запирающего слоя). Омические контакты с кремнием создаются путем напыления алюминия в вакууме.
- типа (эмиттер). В такой структуре концентрация введенной в поверхностный слой примеси уменьшается с глубиной (рис.3), поэтому переход получается плавным, так как толщина области изменения концентрации примесей сравнима с толщиной области пространственного заряда (запирающего слоя). Омические контакты с кремнием создаются путем напыления алюминия в вакууме.
При изготовлении ДС с использованием метода эпитаксии на пластину (подложку) монокристалла с акцепторной примесью  наращивают тонкую эпитаксиальную пленку, повторяющую структуру подложки и ее кристаллографическую ориентацию, вводя одновременно в нее соответствующую примесь, в данном случае донорную. В результате получается резкий
наращивают тонкую эпитаксиальную пленку, повторяющую структуру подложки и ее кристаллографическую ориентацию, вводя одновременно в нее соответствующую примесь, в данном случае донорную. В результате получается резкий
р – n переход.
Метод эпитаксиального наращивания позволяет, в частности, расположить между слоями с проводимостью n и  – типа тонкий слой с малым содержанием акцепторной примеси
– типа тонкий слой с малым содержанием акцепторной примеси  (см. рис.2,в). Этот слой, выполняет роль базы и, обладая малой концентрацией основных носителей заряда, обеспечивает относительно большую толщину р – n перехода.
(см. рис.2,в). Этот слой, выполняет роль базы и, обладая малой концентрацией основных носителей заряда, обеспечивает относительно большую толщину р – n перехода.
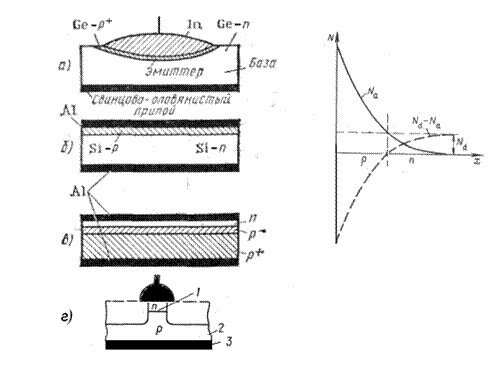
Рис.2 Рис.3
Введение примесей в верхний слой исходной пластины или эпитаксиальной пленки может быть выполнено, например, путем их ионного легирования в процессе бомбардировки ионами примеси (имплантации).
Одним из вариантов плоскостных диодных структур являются мезаструктуры (рис.2г). Основой мезаструктуры является пластина 2 исходного полупроводника, например р – типа, соединенная с электродом 3 с помощью омического контакта 3. Путем диффузии (или сплавления) донорной примеси в этой пластине на некоторой глубине создается р – n переход 1. С целью уменьшения площади перехода часть пластины, показанная на рисунке штриховой линией, удаляется электролитическим или химическим травлением. Оставшаяся часть структуры по внешнему виду напоминает стол, откуда и произошло название структуры (от исп. mesa – cтол). Мезаструктура помимо уменьшения площади перехода позволяет также улучшить от перехода теплоотвод.
Точечные ДС. В точечных ДС линейные размеры р – n перехода меньше так называемой характеристической длины , определяющей физические процессы в переходе и прилегающих к нему областях структуры, т.е. меньше толщины пространственного заряда, диффузионной длины носителей заряда и др. Точечная электронно-дырочная структура создается в месте касания тонкой пружинящей иглы и кристалла путем пропускания через образовавшийся таким образом контакт импульса тока (в несколько ампер). Этот процесс называют формовкой. Если до формовки полупроводник имел, например, проводимость n – типа, то в процессе формовки вблизи места касания с кристаллом образуется р – область (рис.4).
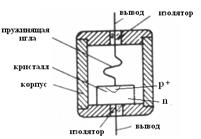
|
имеющих свойства акцепторов. Для усиления дырочного характера области игла покрывается другим материалом, способным создать примесные уровни нужного вида (в данном случае акцепторные). Точечные ДС имеют плавные р – n переходы.
Следует отметить, что появившиеся в последнее время так называемые микроплоскостные или микросплавные ДС имеют по сравнению с точечными несколько больший по площади р – n переход.
Поликристаллические ДС имеют р – n переход, образованный полупроводниковыми слоями, состоящими из большого количества кристаллов малого размера, различно ориентированных друг относительно друга и не представляющих единого монокристалла. Эти ДС бывают селеновыми, меднозакисными (купроксными) и титановыми.
2. Вольт-амперная характеристика диодной структуры
Выше отмечалось, что при рассмотрении процессов в р – n структуре в силу принятых допущений теоретическая ВАХ р – n перехода должна отличаться от ВАХ ДС (рис.5). Основные отличия вольт-амперной характеристик ДС от ВАХ перехода (кривая 1 – штриховая линия) состоят в её меньшем наклоне к оси напряжения прямого включения  (прямая ветвь характеристики - кривая 2) и расположении характеристики в области больших обратных токов при напряжении обратного включения
(прямая ветвь характеристики - кривая 2) и расположении характеристики в области больших обратных токов при напряжении обратного включения  (кривые 3 – 5). Это свидетельствует о том, что вентильные свойства ДС хуже вентильных свойств идеального р – n перехода. Основными причинами ухудшения вентильных свойств ДС являются следующие.
(кривые 3 – 5). Это свидетельствует о том, что вентильные свойства ДС хуже вентильных свойств идеального р – n перехода. Основными причинами ухудшения вентильных свойств ДС являются следующие.
Прямая ветвь ВАХ. Меньший наклон характеристики связан с падением части напряжения внешнего источника на сопротивлении  . Воспользовавшись уравнением для ВАХ р – n перехода можно записать
. Воспользовавшись уравнением для ВАХ р – n перехода можно записать
 =
=  +
+ 
 , (1)
, (1)
откуда следует, что с увеличением прямого тока падение напряжения на переходе пропорционально логарифму тока, а на сопротивлении  - току. Поэтому при относительно больших прямых токах ВАХ будет определяться (ограничиваться) сопротивлением
- току. Поэтому при относительно больших прямых токах ВАХ будет определяться (ограничиваться) сопротивлением  и участок прямой ветви характеристики становится прямолинейным (омическим). Это произойдет при токе, когда напряжение
и участок прямой ветви характеристики становится прямолинейным (омическим). Это произойдет при токе, когда напряжение 

 . При этом потенциальный барьер, оставаясь весьма малым, не исчезает.
. При этом потенциальный барьер, оставаясь весьма малым, не исчезает.
Другой причиной, ведущей к уменьшению наклона прямой ветви характеристики и проявляющейся главным образом в кремниевых ДС, является рекомбинация носителей, не преодолевших потенциального барьера, в самом переходе.
Обратная ветвь ВАХ. Из рис.5 следует, что отличие состоит в большей величине обратного тока  по сравнению с тепловым током
по сравнению с тепловым током  и его резком увеличении при определенной величине обратного напряжения. Это связано с тем, что к току
и его резком увеличении при определенной величине обратного напряжения. Это связано с тем, что к току  добавляются еще два тока – ток утечки
добавляются еще два тока – ток утечки  и ток термогенерации
и ток термогенерации  ,т.е.
,т.е.
 =
=  +
+  +
+  (2)
(2)
Ток утечки  обусловлен состоянием поверхности полупроводникового материала ДС, при котором возникает вероятность появления на ней свободных электронов и незаполненных ковалентных связей, способствующих поверхностной проводимости полупроводника. Такие поверхностные состояния возникают в результате взаимодействия полупроводника и окружающей среды, ведущего к образованию различных химических соединений, отличающихся по своим свойствам от основного материала. Кроме того, при обработке кристалла появляются дефекты кристаллической решетки на поверхности полупроводника ДС.
обусловлен состоянием поверхности полупроводникового материала ДС, при котором возникает вероятность появления на ней свободных электронов и незаполненных ковалентных связей, способствующих поверхностной проводимости полупроводника. Такие поверхностные состояния возникают в результате взаимодействия полупроводника и окружающей среды, ведущего к образованию различных химических соединений, отличающихся по своим свойствам от основного материала. Кроме того, при обработке кристалла появляются дефекты кристаллической решетки на поверхности полупроводника ДС.
Ток термогенерации  обусловлен генерацией пар носителей заряда в самом р – n переходе. Он зависит при прочих одинаковых условиях от ширины запрещенной зоны полупроводника и концентрации примесей, определяющих концентрацию равновесных носителей заряда в полупроводнике
обусловлен генерацией пар носителей заряда в самом р – n переходе. Он зависит при прочих одинаковых условиях от ширины запрещенной зоны полупроводника и концентрации примесей, определяющих концентрацию равновесных носителей заряда в полупроводнике
(  =
=  ). Так, с ростом ширины запрещенной зоны концентрация
). Так, с ростом ширины запрещенной зоны концентрация  уменьшается, поэтому, например, у германиевых ДС по сравнению с кремниевыми ток термогенерации значительно больше.
уменьшается, поэтому, например, у германиевых ДС по сравнению с кремниевыми ток термогенерации значительно больше.
С увеличением обратного напряжения при некоторой его величине, определяемой концентрацией примесей и температурой, происходит резкое возрастание обратного тока, обусловленного пробоем р – n перехода.
Различают два вида пробоя перехода – тепловой и электрический (туннельный и лавинный).
Тепловой пробой. Тепловой пробой связан с условиями отвода тепла от перехода, которое выделяется в нем при подведении к нему мощности  =
= 
 , расходуемой на его нагрев. Выделяемое в переходе тепло отводится в окружающее пространство за счет теплопроводности структуры и ее элементов. С увеличением напряжения
, расходуемой на его нагрев. Выделяемое в переходе тепло отводится в окружающее пространство за счет теплопроводности структуры и ее элементов. С увеличением напряжения  растет мощность
растет мощность  и соответственно выделяемое в переходе тепло. Если, начиная с некоторого количества выделяемого тепла, последнее по условиям теплопроводности не успевает в должной мере отводиться от перехода ДС в окружающее пространство, то переход и структура начинают разогреваться, ток
и соответственно выделяемое в переходе тепло. Если, начиная с некоторого количества выделяемого тепла, последнее по условиям теплопроводности не успевает в должной мере отводиться от перехода ДС в окружающее пространство, то переход и структура начинают разогреваться, ток  увеличивается, что в свою очередь ведет к дальнейшему разогреву перехода и структуры и возрастанию обратного тока. В результате возникает лавинообразный процесс, приводящий к резкому увеличению обратного тока с одновременным снижением напряжения на переходе (из-за уменьшения сопротивления запирающего слоя вследствие возрастания концентрации пар носителей заряда в нем), т.е. происходит тепловой пробой перехода (кривая 3). Из-за сильного разогрева перехода и структуры возникают необратимые явления в кристаллической решетке полупроводника, поэтому, как правило, при снятии с перехода обратного напряжения свойства перехода не восстанавливаются, т.е. тепловой пробой является необратимым.
увеличивается, что в свою очередь ведет к дальнейшему разогреву перехода и структуры и возрастанию обратного тока. В результате возникает лавинообразный процесс, приводящий к резкому увеличению обратного тока с одновременным снижением напряжения на переходе (из-за уменьшения сопротивления запирающего слоя вследствие возрастания концентрации пар носителей заряда в нем), т.е. происходит тепловой пробой перехода (кривая 3). Из-за сильного разогрева перехода и структуры возникают необратимые явления в кристаллической решетке полупроводника, поэтому, как правило, при снятии с перехода обратного напряжения свойства перехода не восстанавливаются, т.е. тепловой пробой является необратимым.
Тепловой пробой наблюдается преимущественно в германиевых ДС. У кремниевых ДС обратный ток настолько мал, что тепловой пробой при отсутствии электрического пробоя практически исключен.
Туннельный пробой ДС возникает при туннельном прохождении неосновных носителей заряда (электронов) из валентной зоны р – области структуры в зону проводимости n – области без затраты энергии. Образующиеся при этом пары носителей заряда приводят к увеличению обратного тока (кривая 4). Туннельный пробой становится возможным, если напряженность электрического поля в переходе ДС, например, из кремния достигает 4·105 В/см. Такое значение напряженности достигается в тонких переходах, которые получаются при концентрации примесей порядка 1018 см-3. При этом обратное напряжение на переходе составляет единицы вольт (малые напряжения). С уменьшением концентрации примесей вероятность туннельного пробоя снижается и в р – n переходе наблюдается лавинный пробой.
Лавинный пробой возникает, когда в переходе под действием сильного электрического поля становится возможным ударная ионизация атомов собственного вещества, приводящая к лавинообразному размножению пар неосновных носителей заряда и лавинообразному нарастанию обратного тока (кривая 5). Ударная ионизация возможна, если толщина перехода больше длины свободного пробега носителей заряда. В этом случае носители заряда могут приобрести в ускоряющем электрическом поле кинетическую энергию, достаточную для ударной ионизации. В результате образуются два носителя заряда, способных в свою очередь вызвать ударную ионизацию. При достаточно большой напряженности этот процесс приобретает лавинообразный характер и вызывает резкое увеличение обратного тока, т.е. возникает лавинный пробой перехода. Лавинный пробой характерен для широких р – n переходов и является по сравнению с туннельным высоковольтным (обратное напряжение единицы – десятки и более вольт).
Электрический пробой является обратимым, если он из-за увеличения обратного тока не перешел в тепловой с выходом перехода и ДС из строя. Во избежание этого необходимо ограничить значение обратного тока, включив, например, во внешнюю цепь последовательно с ДС резистор.
 |
Рис.5
Влияние температуры. ВАХ ДС р – n переходом в сильной степени зависит от температуры окружающей среды (рис.6). При этом главным образом изменяется обратная ветвь характеристики из-за изменения теплового тока и тока термогенерации. Обычно полагают, что обратный ток кремниевых и германиевых ДС в диапазоне температур, близких к комнатной, удваивается при увеличении температуры на 10 К (или 10оС). Увеличение обратного тока связано главным образом с ростом концентрации неосновных носителей заряда ДС.
Прямая ветвь ВАХ также несколько изменяет свое положение, смещаясь в сторону больших прямых токов при изменении температуры, что связано с уменьшением контактной разности потенциалов  . Однако относительное изменение прямого тока по сравнению с относительным изменением обратного невелико. Поэтому с ростом температуры вентильное свойство ДС с р – n переходом ухудшается.
. Однако относительное изменение прямого тока по сравнению с относительным изменением обратного невелико. Поэтому с ростом температуры вентильное свойство ДС с р – n переходом ухудшается.

|

Иногда прямые ветви ВАХ при изменении температуры пересекаются (рис.7), что связано с влиянием областей ДС, примыкающих к р – n переходу. Если сопротивление  растет с увеличением температуры, то на
растет с увеличением температуры, то на

|
|
Изменение температуры окружающей среды оказывает также влияние на величину напряжения пробоя р – n перехода. При тепловом пробое с увеличением температуры напряжение пробоя уменьшается, что связано с ростом обратного тока и достижением значения мощности и соответственно количества выделяемого в структуре тепла, при которых происходит тепловой пробой, при меньших значениях обратного напряжения.
При туннельном пробое с ростом температуры наблюдается уменьшение напряжения пробоя, так как происходит уменьшение толщины перехода и соответственно рост напряженности электрического в переходе, и величина напряженности электрического поля, при которой происходит туннельный пробой перехода достигается при меньшем значении обратного напряжения.
При лавинном пробое с увеличением температуры напряжение пробоя возрастает, так как уменьшается подвижность носителей заряда и соответственно длина их свободного пробега, что требует увеличения обратного напряжения до значения, при котором кинетическая энергия носителей заряда достигает величины, достаточной для образования лавинного процесса размножения носителей заряда.

|
Влияние радиации. Прямая ветвь ВАХ ДС (рис.8) при облучении и с увеличением дозы облучения  , например, потоком быстрых нейтронов, располагается более полого. Это объясняется увеличением сопротивления
, например, потоком быстрых нейтронов, располагается более полого. Это объясняется увеличением сопротивления  и в первую очередь сопротивления базовой (высокоомной) области структуры. Увеличение сопротивления
и в первую очередь сопротивления базовой (высокоомной) области структуры. Увеличение сопротивления  при облучении связано с уменьшением концентрации
при облучении связано с уменьшением концентрации
основных носителей заряда из-за возникновения в полупроводнике радиационных дефектов, играющих роль ловушек для основных носителей заряда. Ловушки, захватывая и удерживая основные носители заряда, увеличивают удельное сопротивление полупроводниковых областей структуры.
Появление радиационных дефектов (ловушек) обусловлено смещением атомов в узлах кристаллической решетки полупроводника под действием их бомбардировки частицами. При высокой концентрации радиационных дефектов (при относительно больших дозах облучения) все основные носители заряда могут быть вообще захвачены ловушками. Обратная ветвь ВАХ ДС при облучении смещается в сторону больших обратных токов, так как увеличивается концентрация неравновесных носителей из-за ионизации атомов полупроводника.
4. Параметры диодной структуры. Максимально допустимые параметры
Электрические свойства ДС с электронно-дырочным переходом характеризуются следующими основными параметрами:
- статическими — сопротивлением постоянному току и сопротивлением переменному току (дифференциальным сопротивлением);
- емкостями — барьерной (зарядной) и диффузионной.
Статические параметры. Нелинейность вольт-амперной характеристики ДС оценивается величинами сопротивлений постоянному и переменному току
Сопротивление постоянному току при прямом и обратном включениях: 
 =
=  ,
, 
 =
=  (3)
(3)
Сопротивление переменному току (дифференциальное сопротивление)
 =
= 

 ,
,  =
= 

 (4)
(4)
Воспользовавшись формулой для ВАХ р – n перехода, можно показать, что сопротивление  =
=  /
/  . При величине прямого напряжения 0<
. При величине прямого напряжения 0<  <<
<<  и температуре Т = 300 К следует, что
и температуре Т = 300 К следует, что
 = 0,025/
= 0,025/  (5)
(5)
При относительно больших токах (на омическом участке ВАХ) сопротивление 

 .
.
Сопротивления ДС могут быть определены по её ВАХ.
Соотношения сопротивлений постоянному и переменному току в относительных единицах, характеризующие нелинейность ВАХ, иллюстрирует рис.9.

|
Емкости р – n перехода. Изменение внешнего напряжения, подводимого к р – n переходу приводит к изменению высоты его потенциального барьера, что связано с изменениями толщины перехода и соответственно величины пространственного заряда ионизированных атомов примесей в переходе. Кроме того, изменение потенциального барьера, сопровождаемое инжекцией неосновных носителей заряда в области структуры, расположенные за границами перехода, и соответственно протеканием через переход тока диффузии, приводит, как отмечалось ранее, к притоку к месту их внедрения основных носителей заряда от источника питания, т.е. накапливанию подвижных носителей заряда в этих областях структуры. Увеличение или снижение потенциального барьера и соответственно диффузионного тока ведет к изменению накапливаемого заряда, т.е. притоку или оттоку основных носителей заряда от источника внешнего напряжения. Иными словами ДС с р – n переходом обладает свойством аккумулировать заряды, характеризуемым как емкость. Эту емкость представляют в виде двух составляющих - барьерной (зарядной) и диффузионной.
Барьерная емкость наиболее ярко проявляется при обратном включении перехода, когда диффузионная емкость, обусловленная прохождением диффузионного тока, практически отсутствует. Наоборот, диффузионная емкость преобладает при прямом включении перехода, когда барьерную емкость можно не учитывать.
Величины емкостей определяются соотношениями С =  и
и
С =  (где
(где  - заряд), характеризующими дифференциальную и интегральную емкости. Наиболее часто используются дифференциальные емкости, которые и будут рассмотрены дальше.
- заряд), характеризующими дифференциальную и интегральную емкости. Наиболее часто используются дифференциальные емкости, которые и будут рассмотрены дальше.
Барьерная емкость может быть представлена как емкость плоского конденсатора с площадью пластин  и расстоянием между пластинами, равными толщине перехода
и расстоянием между пластинами, равными толщине перехода  :
:
 =
=  =
=  (6)
(6)
С учетом формулы для величины  получим
получим
 =
=  , (7)
, (7)
где  - емкость р – n переход при
- емкость р – n переход при  = 0, определяемая выражением
= 0, определяемая выражением
 =
=  (8)
(8)
В выражении (7) величина  - коэффициент, зависящий от типа р – n перехода — для резких переходов
- коэффициент, зависящий от типа р – n перехода — для резких переходов  =1/2, для плавных
=1/2, для плавных  = 1/3.
= 1/3.
Можно показать, что величина интегральной барьерной емкости в два раза больше дифференциальной. Величина барьерной емкости имеет порядок десятков- сотен пФ. Так, при  = 0,01 см2,
= 0,01 см2,  = - 2 В,
= - 2 В,  = 0,6 мкм,
= 0,6 мкм,  = 0.35 В барьерная емкость
= 0.35 В барьерная емкость  = 90 пФ.
= 90 пФ.
Из выражений (7) и(8) следует, что увеличением концентрации примесей барьерная емкость увеличивается, так как уменьшается толщина перехода  . С ростом напряжения
. С ростом напряжения  величина
величина  падает (рис.10).
падает (рис.10).
Диффузионная емкость определяется соотношением
 =
=  , (9)
, (9)
где  - инжектированный заряд.
- инжектированный заряд.
Примем для определенности, что ДС имеет несимметричный р – n переход при  >>
>>  . В этом случае, поскольку дырочный ток диффузии значительно больше тока электронного
. В этом случае, поскольку дырочный ток диффузии значительно больше тока электронного  >>
>>  , то диффузионная емкость будет определяться главным образом инжекцией дырок в n - область структуры. Тогда заряд
, то диффузионная емкость будет определяться главным образом инжекцией дырок в n - область структуры. Тогда заряд  =
=  =
= 
 , где
, где  -время жизни дырок. Воспользовавшись уравнением ВАХ р – n перехода, получим
-время жизни дырок. Воспользовавшись уравнением ВАХ р – n перехода, получим
 =
=  , (10)
, (10)
Из формулы (10) следует, что диффузионная емкость пропорциональна диффузионному току, увеличиваясь с его ростом. При токе  =
=  диффузионная емкость равна нулю. Это означает, что при обратном напряжении диффузионная емкость резко уменьшается.
диффузионная емкость равна нулю. Это означает, что при обратном напряжении диффузионная емкость резко уменьшается.
При прямом включении, учитывая, что  >>
>>  , если |
, если |  | >>
| >>  ,
,
 =
=  (11)
(11)
Можно показать, что емкость  =
=  . Это означает, что время рекомбинации является постоянной времени заряда диффузионной емкости через сопротивление перехода
. Это означает, что время рекомбинации является постоянной времени заряда диффузионной емкости через сопротивление перехода  .
.
Расчет диффузионной емкости при токе  = 10 мА,
= 10 мА,  = 10 мкс и
= 10 мкс и
 = 0,025 В дает значение
= 0,025 В дает значение  = 4 мкФ. Отсюда следует, что величина диффузионной емкости значительно превышает величину барьерной емкости р – n перехода (рис. 10).
= 4 мкФ. Отсюда следует, что величина диффузионной емкости значительно превышает величину барьерной емкости р – n перехода (рис. 10).
Полная емкость перехода равна сумме барьерной и диффузионной
 =
=  +
+  (12)
(12)

Величина емкости перехода ДС проявляется на переменном токе и сказывается в том, что полное сопротивление диода становится комплексным – наряду с активным сопротивлением  появляется реактивная составляющая 1/
появляется реактивная составляющая 1/  . Конечное время заряда и перезаряда емкостей перехода ограничивает возможные скорости изменения токов через переход, а также приводит к появлению фазовых сдвигов между током и напряжением ДС.
. Конечное время заряда и перезаряда емкостей перехода ограничивает возможные скорости изменения токов через переход, а также приводит к появлению фазовых сдвигов между током и напряжением ДС.
Максимально допустимые параметры. Рассмотренные выше величины, характеризующие свойства ДС с р – n переходом, являются параметрами ДС, которые в свою очередь зависят от параметров электрического режима ДС (тока, напряжения, выделяемой на переходе мощности) и условий эксплуатации, определяемых также соответствующими параметрами (климатическими – интервалом рабочих температур, относительной влажностью, давлением; механическими – вибрационными, ударными; радиационными и др.). Для того чтобы ДС была надежной, т.е. безотказно работала в течение определенного заданного времени, параметры режимов эксплуатации ДС не должны выходить за пределы значений, превышение которых может привести к снижению надежности ДС и выходу её из строя. Эти параметры получили название максимально допустимых, а области, ограниченные значениями этих параметров – областями безопасных режимов работы (ОБР).
Электрические параметры. К максимально допустимым параметрам относятся: допустимые прямой ток и обратное напряжение, допустимая мощность, рассеиваемая структурой.
Максимально допустимый прямой ток  определяет возможность теплового или токового пробоя р – n перехода. При тепловом пробое происходит разогрев перехода и он разрушается.Токовый пробой характеризуется локализацией тока на ограниченном участке перехода из-за его неоднородности и также сопровождается его разрушением.
определяет возможность теплового или токового пробоя р – n перехода. При тепловом пробое происходит разогрев перехода и он разрушается.Токовый пробой характеризуется локализацией тока на ограниченном участке перехода из-за его неоднородности и также сопровождается его разрушением.
Максимально допустимое обратное напряжение  определяет возможность пробоя перехода, сопровождающегося выделением большого количества тепла на участке пробоя и разрушением ДС.
определяет возможность пробоя перехода, сопровождающегося выделением большого количества тепла на участке пробоя и разрушением ДС.
Максимально допустимая мощность, рассеиваемя ДС,  определяется разогревом р – n перехода протекающим через него током, выделяющим такое количество тепла, при котором температура перехода превышает максимально допустимую и приводит к тепловому пробою и разрушению перехода и ДС.
определяется разогревом р – n перехода протекающим через него током, выделяющим такое количество тепла, при котором температура перехода превышает максимально допустимую и приводит к тепловому пробою и разрушению перехода и ДС.
Климатические параметры. К климатическим параметрам относятся: максимально допустимая температура окружающей среды и минимальная температура окружающей среды; допустимые относительная влажность и давление воздуха.
Максимально допустимая температура окружающей среды  - температура, при превышении которой ДС может выйти из строя вследствие теплового пробоя. Кремниевые переходы сохраняют свои свойства до температуры, примерно равной 443 К (170оС), а германиевые – до 373 К (100оС). Однако во время работы температура р – n перехода всегда выше температуры корпуса ДС и окружающей среды. Поэтому температура
- температура, при превышении которой ДС может выйти из строя вследствие теплового пробоя. Кремниевые переходы сохраняют свои свойства до температуры, примерно равной 443 К (170оС), а германиевые – до 373 К (100оС). Однако во время работы температура р – n перехода всегда выше температуры корпуса ДС и окружающей среды. Поэтому температура  для кремниевых и германиевых ДС обычно составляет 393 К (120оС) и 343 К (70оС) соответственно.
для кремниевых и германиевых ДС обычно составляет 393 К (120оС) и 343 К (70оС) соответственно.
Температура окружающей среды  и температура перехода
и температура перехода  связаны соотношением
связаны соотношением
 -
-  =
= 
 , (13)
, (13)
где  - внутреннее тепловое сопротивление ДС;
- внутреннее тепловое сопротивление ДС;  - мощность, рассеиваемая ДС.
- мощность, рассеиваемая ДС.
Минимальная температура окружающей среды  связана с ухудшением электрических и механических свойств полупроводниковых материалов и элементов конструкции ДС при низких температурах. Для большинства ДС эта температура составляет 203 – 213 К (-70…-60оС).
связана с ухудшением электрических и механических свойств полупроводниковых материалов и элементов конструкции ДС при низких температурах. Для большинства ДС эта температура составляет 203 – 213 К (-70…-60оС).
Допустимая относительная влажность воздуха для ДС достигает 98%, если температура окружающей среды не превышает 313 К (40оС).
Давление окружающего воздуха лежит в пределах 0,5 – 300 кПа во всем диапазоне рабочих температур.
Механические параметры ДС определяются сохранением её конструкции и работоспособности при воздействии на нее различных вибрационных и ударных нагрузок. ДС должна выдерживать вибрационные нагрузки в диапазоне частот 5 – 2000Гц с ускорением до 15g, многократные удары с ускорением до 150g и одиночные удары с ускорением 500g.
5. Эквивалентная схема и частотные свойства диодной структуры
 Эквивалентная схема ДС. По переменному току ДС с р – n переходом может быть представлена эквивалентной схемой, показанной на рис. 11. Схема включает параллельно соединенные сопротивление
Эквивалентная схема ДС. По переменному току ДС с р – n переходом может быть представлена эквивалентной схемой, показанной на рис. 11. Схема включает параллельно соединенные сопротивление  и емкости
и емкости  , сопротивление объема полупроводника и электрических
, сопротивление объема полупроводника и электрических
|
контактов  , емкостей корпуса
, емкостей корпуса  (между выводами ДС), индуктивность выводов
(между выводами ДС), индуктивность выводов  . В зависимости от диапазона частот и режима включения р – n
. В зависимости от диапазона частот и режима включения р – n
перехода эквивалентная схема ДС может быть упрощена.
Частотные свойства ДС. Под частотными свойствами диодной структуры понимается зависимость свойств р – n перехода, количественно характеризуемых соответствующими параметрами, от частоты действующего в структуре переменного тока (напряжения).
На постоянном токе связь между током и напряжением ДС описывается ВАХ. На переменном токе, когда напряжение на переходе изменяется во времени, начинают проявляться в зависимости от частоты в той или иной степени рассмотренные выше эффекты, связанные с зарядом и перезарядом барьерной емкости, с накоплением и рассасыванием носителей заряда, характеризуемые диффузионной емкостью. Эквивалентная схема ДС (см. рис.11) учитывает эти емкости. Из схемы следует, что с ростом частоты переменного тока сопротивление перехода становится комплексным, приобретая емкостной характер.
При прохождении через ДС, включенную в прямом направлении, например, синусоидального переменного тока с ростом частоты снижается напряжение на переходе, повышается потенциальный барьер и соответственно снижается величина переменного тока. С другой стороны, с ростом частоты возрастает обратный ток перехода, так как в силу инерционности процесса диффузии, например, дырки, инжектированные в n – базу ДС при прямом включении перехода, если время их жизни  сравнимо с периодом переменного напряжения, не успевают полностью рекомбинировать в базе за положительный полупериод напряжения. В течение отрицательного полупериода часть накопившихся дырок рекомбинирует, а часть уходит в р - область в виде обратного тока перехода. Таким образом, вентильные свойства ДС с ростом частоты ухудшаются.
сравнимо с периодом переменного напряжения, не успевают полностью рекомбинировать в базе за положительный полупериод напряжения. В течение отрицательного полупериода часть накопившихся дырок рекомбинирует, а часть уходит в р - область в виде обратного тока перехода. Таким образом, вентильные свойства ДС с ростом частоты ухудшаются.
Если период переменного напряжения  <<
<<  , то инжектированный в базу за положительный полупериод заряд дырок полностью экстрагируется обратно в р – область и ДС теряет вентильной свойство.
, то инжектированный в базу за положительный полупериод заряд дырок полностью экстрагируется обратно в р – область и ДС теряет вентильной свойство.
Частотные свойства ДС обычно оцениваются так называемой максимальной частотой  . На частотах выше максимальной ДС в зависимости от ее назначения использовать не рекомендуется.
. На частотах выше максимальной ДС в зависимости от ее назначения использовать не рекомендуется.
Необходимо отметить, что с частотными свойствами тесно связаны временные свойства ДС, которые определяют действие в структуре несинусоидального тока (напряжения), например, импульсного. В этом случае используются более удобные для таких случаев специальные (временные) параметры и характеристики (передаточные).
| <== предыдущая лекция | | | следующая лекция ==> |
| Физические процессы при контакте твердых тел | | | Классификация полупроводниковых диодов. Условное буквенное обозначение |
Дата добавления: 2015-12-16; просмотров: 2150;
