Транзистор с барьером Шоттки.
На рисунке 4.11а показана структура интегрального транзистора Шоттки (ТШ). Здесь очень изящно решена задача сочетания транзистора с диодом Шоттки: алюминиевая металлизация, обеспечивающая омический контакт со слоем базы, продлена в сторону коллекторного n-слоя. На первый взгляд, коллекторный слой оказался закороченным со слоем базы. На самом же деле алюминиевая полоска образует с р-слоем базы невыпрямляющий, омический контакт, а с n-слоем коллектора выпрямляющий контакт Шоттки. 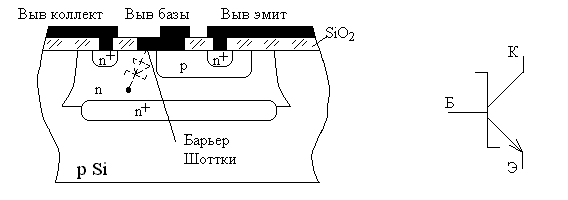
| а) | б) |
Рисунок 4.11
Разумеется, структурное решение, показанное на рисунке 4.11а, можно использовать не только в простейшем транзисторе, но и в МЭТ. В обоих случаях отсутствуют накопление и рассасывание избыточных зарядов, и получается существенный (в 1,5-2 раза) выигрыш во времени переключения транзисторов из открытого в запертое состояние.
Условное графическое обозначение (ТШ) приведено на рисунке 4.11б.
Транзисторы р-n-р
Получение р-n-р транзисторов с такими же высокими параметрами, как и n-р-n транзисторы, в едином технологическом цикле остается до сих пор нерешенной задачей. Поэтому все существующие варианты интегральных р-n-р транзисторов существенно уступают n-p-n транзисторам по коэффициенту усиления и предельной частоте.
Как известно, при прочих равных условиях кремниевые р-n-p транзисторы уступают n-p-n транзисторам по предельной частоте примерно в 3 раза из-за меньшей подвижности дырок по сравнению с электронами. Поэтому в данном случае, говоря о меньшей предельной частоте p-n-p транзисторов, мы имеем в виду, что не удается обеспечить те «равные условия», при которых различие было бы только в три раза.
В настоящее время основным структурным вариантом является горизо- нтальный p-n-p транзистор (рисунок 4.12). Эмиттерный и коллекторный слои

Рисунок 4.12
получаются на этапе базовой диффузии n-р-n транзистора, причем коллек- торный слой охватывает эмиттер со всех сторон. Это позволяет собирать инжектированные дырки со всех боковых частей эмиттерного слоя. Припо- верхностные боковые участки р-слоевхарактерны повышенной концентрацией примеси, что способствует увеличению коэффициента инжекции. Поскольку базовая диффузия сравнительно мелкая (2-3 мкм), ширину базы (т. е. рассто- яние между р-слоями) удается сделать порядка 3-4 мкм. В результате пре- дельная частота может составлять до 20-40 МГц, а коэффициент усиления до 50.
Из рисунка 4.12 видно, что горизонтальный p-n-p транзистор (как и паразитный) является бездрейфовым, так как его база однородная- эпитаксиальный n-слой. Этот фактор вместе с меньшей подвижностью дырок предопределяет примерно на порядок худшие частотные и переходные свойства p-n-p транзистора даже при той же ширине базы, что и у дрейфового n-p-n транзистора. Из рисунка также видно, что для увеличения коэффициента передачи эмиттерного тока желательно, чтобы площадь донной части эмиттерного слоя была мала по сравнению с площадью боковых частей. Значит, эмиттерный слой нужно делать как можно более узким (ширина окна под диффузию этого слоя составляет 3-5 мкм).
Заметим, что горизонтальному p-n-p транзистору свойственна электрофизическая симметрия, так как слои эмиттера и коллектора однотипные. В частности, это означает, что пробивные напряжения эмиттерного и коллекторного переходов одинаковы (обычно 30-50 В).
Недостатки горизонтального p-n-p транзистора можно устранить в верти- кальной структуре, но ценой дополнительных технологических операций.
Интегральные диоды
Отдельно диодные структуры в ППИМС не формируются, а в качестве диода используются любой из двух p-n переходов транзистора: эмиттерный или коллекторный. Можно также использовать их комбинации. Поэтому по существуинтегральный диод представляет собой диодное включение интегрального транзистора.
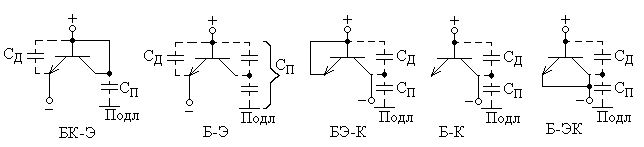
| а) | б) | в) | г) | д) |
Рисунок 4.13
Пять возможных вариантов диодного включения транзистора показаны на рисунке 4.13. В таблице 4.1 приведены типичные параметры этих вариантов. Для них приняты следующие обозначения: до черточки стоит обозначение анода, после черточки - катода; если два слоя соединены, их обозначения пишутся слитно. Из таблицы видно, что варианты различаются как по статическим, так и по динамическим параметрам.
Пробивные напряженияUПР зависят от используемого перехода: они меньше у тех вариантов, в которых используется эмиттерный переход (см. таблицу 4.1).
Обратные токи IОБР (без учета токов утечки) - это токи термогенерации в переходах. Они зависят от объема перехода и, следовательно, меньше у тех вариантов, у которых используется только эмиттерный переход, имеющий наименьшую площадь.
Емкость диодаСд (т. е. емкость между анодом и катодом) зависит от площади используемых переходов; поэтому она максимальна при их параллельном соединении (вариант Б- ЭК). Паразитная емкость на подложкуСП шунтирует на «землю» анод или катод диода (считается, что подложка заземлена). Емкость СП, как правило, совпадает с емкостью СКП, с которой мы встретились при рассмотрении n-p-n транзистора (рисунок 4.7). Однако у варианта Б - Э емкости СКП и СК оказываются включенными последовательно и результирующая емкость СП минимальна.
Таблица 4.1
| Параметр | Тип диодов | ||||
| БК-Э | Б-Э | БЭ-К | Б-К | Б-ЭК | |
| UПР, В | 7-8 | 7-8 | 40-50 | 40-50 | 7-8 |
| IОБР, нА | 0,5-1 | 0,5-1 | 15-30 | 15-30 | 20-40 |
| СД, пФ | 0,5 | 0,5 | 0,7 | 0,7 | 1,2 |
| СП, пФ | 1,2 | ||||
| tВ, нс |
Время восстановленияобратного тока tВ(т. е. время переключения диода из открытого в закрытое состояние) минимально у варианта БК-Э; у этого варианта заряд накапливается только в базовом слое (так как коллекторный переход закорочен). У других вариантов заряд накапливается не только в базе, но и в коллекторе, так что для рассасывания заряда требуется большее время.
Сравнивая отдельные варианты, приходим к выводу, что в целом оптимальными вариантами являютсяБК-Э и Б-Э.Малые пробивные напряжения этих вариантов не играют существенной роли в низковольтных ИМС. Чаще всего используется вариант БК-Э.
Помимо собственно диодов, в ИМС часто используются интегральные стабилитроны. Они также осуществляются в нескольких вариантах, в зависимости от необходимого напряжения стабилизации и температурного коэффициента.
Если необходимы напряжения 5-10 В, то используют обратное включение диода Б-Э в режиме электрического пробоя, при этом температурная нестабильность составляет + (2-5) мВ/° С.
Широкое распространение имеют стабилитроны, рассчитанные на на-
пряжения, равные или кратные напряжению на открытом переходе U*»0,7 В. В таких случаях используют один или несколько последовательно включенных диодов БК-Э, работающих в прямом направлении. Температурная нестабильность в этом случае составляет -(1,5-2) мВ/° С.
Если в базовом слое осуществить два p-n перехода,то при подаче напряжения между n+-слоями один из переходов работает в режиме лавинного пробоя, а второй - в режиме прямого смещения. Такой вариант привлекателен малой температурной нестабильностью (±1 мВ/°С и менее), так как температурные нестабильности при лавинном пробое и при прямом смещении имеют разные знаки.
Дата добавления: 2015-12-16; просмотров: 2066;
