Химическое осаждение
Осуществляется из газовой среды, когда осаждение осуществляется в процессе химической реакции на поверхности самой подложки или вблизи от нее. Аппаратура в этом способе состоит из реактора, представляющего собой открытую проточенную систему.
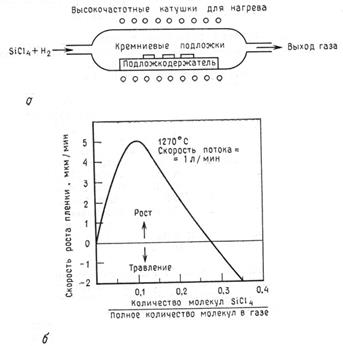
Рисунок 42. Газовая эпитаксия:
а – схема процесса, б – зависимость скорости роста пленки от концентрации SiCl4 в газе.
Температура в зоне кристаллизации должна быть стабильна. При подаче реакционноспособных газов в этой зоне могут протекать следующие химические реакции.
· реакция разложения : SiH4, GeH4 при температуре 800°C -1200°C
SiH4= Si +2Н2
· Реакция восстановления: при температуре 1100°C
SiCl4+2Н2= Si + 4HCl
· газотранспортная реакция
2AICl3+3CO2+3H2=Al2O3+3CO+6HCl
Процесс определяется температурой кристаллизации, концентрацией газов, скоростью роста. Если будут отклонения, то состав и оптические свойства пленки могут отличаться.
Преимущества: низкие температуры, простая аппаратура, отсутствует тигель, кроме пленок можно получать объемные кристаллы.
Недостатки: ограничения по размерам.
Дата добавления: 2015-01-13; просмотров: 1040;
