Структуры интегральных МОП – транзисторов
Структуры полевых транзисторов для ИС
МДП – транзисторы являются наиболее распространёнными элементами интегральных схем. По сравнению с биполярными они занимают значительно меньшую площадь на кристалле, а также обладают рядом схемотехнических преимуществ: обратимостью, возможностью использования в качестве резисторов, бесконечным выходным сопротивлением и широким набором различных типов на одном кристалле со встроенными и индуцированными n- и р- каналами и различными пороговыми напряжениями. МДП–транзистор с небольшим усложнением его структуры превращается в элемент цифровой памяти. Всё это даёт возможность создавать сверхбольшие ИС с оптимальными параметрами, по степени интеграции намного превышающие ИС на биполярных транзисторах. Совместное изготовление МДП - и биполярных транзисторов на одном кристалле, в едином технологическом цикле возможно, но является специальным случаем. Как правило, биполярные и МДП - транзисторные ИС разрабатываются и изготавливаются отдельно и предназначены либо для решения разных функциональных задач, либо для решения одной и той же задачи, но с использованием преимуществ соответствующего класса транзисторов. Главную роль в современной микроэлектронике играют МДП – транзисторы, в которых диэлектриком является SiO2, т.е. МОП-транзисторы.
По технологии изготовления МОП – транзистор существенно проще биполярного. Имея малую площадь и, обладая высоким входным сопротивлением, МОП-транзисторы потребляют малую мощность от источника сигнала. Это уменьшение потребляемой мощности ИС на МДП-транзисторах особенно существенно для создания логических ИС. Технологическая простота обеспечивает меньший брак и меньшую стоимость.
Структуры интегральных МОП – транзисторов
Так как интегральные МОП-транзисторы не нуждаются в изоляции, их структура внешне не отличается от структуры дискретных вариантов. На рис.3.21 показана структура интегрального МОП-транзистора с индуцированным n-каналом.

Рис. 3.21. Интегральный МОП-транзистор ( с перекрытием затвора)
Отсутствие изолирующих карманов способствует лучшему использованию площади кристалла, однако, с другой стороны, отсутствие изоляции делает подложку общим электродом для всех транзисторов. Так, если на подложку подать постоянный потенциал, а истоки транзисторов будут находиться под разными потенциалами (что свойственно многим схемам), то будут разными и напряжения между подложкой и истоками. Это равносильно различию пороговых напряжений МОП-транзисторов.
Главным фактором, лимитирующим быстродействие МДП- транзисторов, обычно являются паразитные ёмкости. Металлическая разводка, используемая в ИС, гораздо компактнее проволочного монтажа, свойственного узлам и блокам, выполненным на дискретных компонентах. Поэтому паразитные ёмкости интегрального МОП-транзистора меньше, чем дискретного, а его быстродействие в несколько раз выше.
Барьерные ёмкости переходов истока и стока при размерах n+-слоёв 20×40мкм лежат в пределах 0,04-0,10пФ.
Ёмкость металлизации при полосках длиной 50-100мкм составляет
0,05-0,09пФ.
Ёмкость контактных площадок при площади 100×100мкм2 - 0,6пФ
Ёмкости перекрытия не поддаются точному расчёту, так как площадь перекрытия характерна большим разбросом из-за неровности краёв металлизации затвора и границ диффузионных слоёв. Порядок величин можно оценить, полагая толщину тонкого окисла d = 0,12мкм . При ширине истока и стока 40мкм и перекрытии 2мкм их средние значения составляют 0,03пФ.
Повышение быстродействия МОП-транзисторов связано прежде всего с уменьшением ёмкостей перекрытия. Уменьшение ёмкостей перекрытия ~ на порядок достигается при использовании технологии самосовмещённых затворов.
МОП-транзистор с самосовмещённым затвором с использованием метода ионной имплантации
Общая идея такой технологии состоит в том, что слои истока и стока создаются не до, а после формирования затвора. При этом затвор используется в качестве маски при получении слоёв истока и стока, а следовательно, края затвора и этих слоёв будут совпадать и перекрытие будет отсутствовать. Для формирования структуры сначала проводится диффузия n+-слоёв, причём расстояние между ними делается заведомо больше желательной длины канала. Затем проводится тонкое окисление на участке между n+-слоями частично над ними. Далее на тонкий окисел напыляется алюминиевый электрод затвора, причём его ширина меньше расстояния между n+-слоями. Через маску, образуемую алюминиевым затвором и толстым защитным окислом проводится ионное легирование (имплантация атомов фосфора). Атомы фосфора проникают в кремний через тонкий окисел и «продлевают» n+-cлои до края алюминиевой полоски так,
что края затвора практически совпадают с краями истока и стока. Имплантированные слои легированы несколько слабее, чем диффузионные; поэтому для них использовано обозначение n вместо n+ . Глубина имплантации также несколько меньше, чем глубина диффузии, и составляет 0,1-0,2мкм.
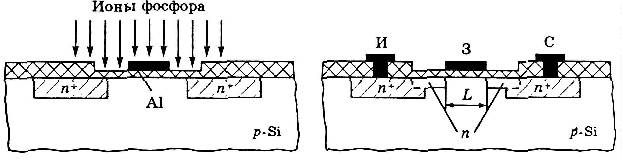
Рис.3.22. МОП – транзистор с самосовмещённым затвором,
полученный методом ионной имплантации
Использование n-канальных транзисторов (по сравнению с р-канальными) повышает быстродействие, что обусловлено увеличением подвижности носителей заряда.
Для повышения быстродействия идут по пути уменьшения длины канала.
Для снижения порогового напряженияиспользуют несколько способов:
- заменяют тонкий окисел SiO2 тонким напылённым слоем нитрида кремния Si3N4, у которого диэлектрическая проницаемость (ε ≈ 7) примерно в полтора раза больше, чем у двуокиси кремния( ε ≈ 4,5 ). Это приводит к увеличению удельной ёмкости Со , а значит к уменьшению соответствующих слагаемых порогового напряжения. Нитрид кремния в качестве подзатворного диэлектрика обеспечивает также дополнительные преимущества: меньшие шумы, большую временную стабильность ВАХ и повышенную радиационную стойкость МДП-транзисторов;
- вместо пластин кремния с традиционной кристаллографической ориентацией (111) используют пластины с ориентацией (100). При этом увеличивается плотность поверхностных состояний (рис.3.25), а вместе с ней и заряд захватываемых ими электронов, пороговое напряжение уменьшается;
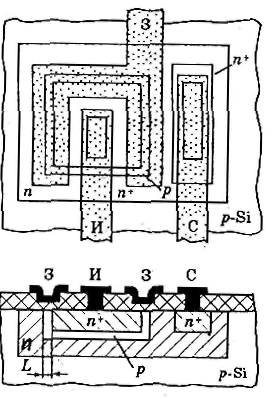
Рис.3.24. МОП-транзистор, полученный методом двойной диффузии
-47-
- в тонкий окисел методом ионной имплантации вводят акцепторную примесь, которая захватывает из приповерхностного слоя кремния часть электронов, образованных донорными примесями, которые всегда присутствуют в окисле. Заряд в диэлектрике уменьшается.

Рис.3.25. Нарушение ковалентных связей на поверхности кристалла:
а- в плоскости (100); б- в плоскости (111)
Сочетая перечисленные методы, можно обеспечить пороговые напряжения практически любой сколь угодно малой величины. Однако слишком малые пороговые напряжения (0,5-1 В и менее) в большинстве случаев неприемлемы по схемотехническим соображениям.
МНОП-транзистор (рис3.26) занимает особое место среди МОП-транзисторов. Диэлектрик имеет структуру «сэндвича», состоящего из слоёв нитрида и окисла кремния (рис.3.26,а). Слой окисла получается путём термического окисления и имеет толщину 2-5 нм, а слой нитрида – путём реактивного напыления и имеет толщину 0,05-1мкм, достаточную для того, чтобы пробивное напряжение превышало 50-70В. Главная особенность МНОП-транзистора состоит в том, что его пороговое напряжение можно менять, подавая на затвор короткие ( 100мкс ) импульсы напряжения разной полярности с большой амплитудой (30-50 В). Так, при подаче импульса +30В устанавливается пороговое напряжение Uo = - 4В (рис.3.26 б). Это значение сохраняется при дальнейшем использовании транзистора в режиме малых сигналов (Uз ≤ ± 10 В); в таком режиме МНОП- транзистор ведёт себя как обычный МДП -транзистор с индуцированным р-каналом. Если подать импульс -30 В, то пороговое напряжение сделается равным
Uо = -20В и, следовательно, сигналы Uз ≤ ± 10 В не смогут вывести транзистор из запертого состояния. Благодаря такой гистерезисной зависимости Uo( Uз ) МНОП –транзистор можно с помощью больших управляющих импульсов переводить из рабочего в запертое состояние и обратно. Эта возможность используется в интегральных запоминающих устройствах.
-48-

Рис.3.26. МНОП-транзистор с индуцированным каналом: а – структура;
б - зависимость порогового напряжения от напряжения затвора
В основе работы МНОП -транзистора лежит накопление заряда на границе нитридного и оксидного слоёв, что есть результат неодинаковых токов проводимости в слоях. Процесс накопления описывается элементарным выражением
dQ/dt = ISiO2 – ISi3N4 ,
где оба тока зависят от напряжения на затворе и меняются в процессе накопления заряда.
При большом отрицательном напряжении Uз на границе накапливается положительный заряд, что равносильно введению доноров в диэлектрик и сопровождается увеличением отрицательного порогового напряжения.
При большом положительном напряжении Uз на границе накапливается отрицательный заряд, что приводит к уменьшению отрицательного порогового напряжения.
При малых напряжениях Uз токи в диэлектрических слоях уменьшаются на 10-15 порядков, так что накопленный заряд сохраняется в течение тысяч часов. Вместе с ним сохраняется и пороговое напряжение.
Комплементарные МОП-транзисторы (КМОП) предполагают изготовление на одном и том же кристалле кремния транзисторов обоих типов: с n-каналом и с p – каналом. При этом один из типов транзисторов нужно размещать в специальном кармане. Если в качестве подложки используется p-кремний (рис.3.27), то n-канальный транзистор можно осуществить непосредственно в подложке, а для p-канального транзистора потребуется карман с электронной проводимостью. Получение такого кармана несложно, но связано с дополнительными технологическими операциями. Трудности могут быть также с созданием низкоомных p+-слоёв в верхней сильно легированной части n-кармана.
-49-
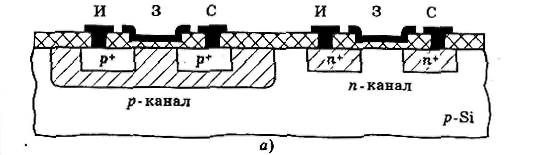
Рис3.27.Комплементарные МОП-транзисторы с использованием изолирующего n-кармана
| <== предыдущая лекция | | | следующая лекция ==> |
| Интегральные стабилитроны | | | Полупроводниковые конденсаторы |
Дата добавления: 2016-04-02; просмотров: 5737;
