Биполярные полупроводниковые структуры
Активные элементы интегральных микросхем
В качестве активных элементов интегральных микросхем используют обычно различные транзисторные структуры, сформированные в кристаллах кремния методами планарной технологии.
Биполярные полупроводниковые структуры
Биполярный транзистор является наиболее распространённым активным элементом в современных интегральных микросхемах. Структура биполярного транзистора в интегральных микросхемах (интегрального транзистора) отличается от структуры дискретного транзистора изоляцией от подложки. Число известных структур интегральных биполярных транзисторов велико, многие из них, особенно созданные в последнее время, очень сложны и их рассмотрение выходит за рамки данного пособия.
Рассмотрим некоторые разновидности биполярных интегральных транзисторов.
Основу биполярных интегральных микросхем составляют транзисторы n-p-n-типа, что вызвано удобствами формирования именно n-p-n- структур и несколько лучшими параметрами интегральных n-p-n-транзисторов по сравнению с параметрами интегральных транзисторов p-n-p-типа.
Простейшая структура эпитаксиально-планарного транзистора с изоляцией pn-переходами показана на рис.3.1. (а - поперечный разрез, б – вид сверху или топологический чертёж). Сравним её с дискретным эпитаксиально-планарным транзистором (рис.3.2.).
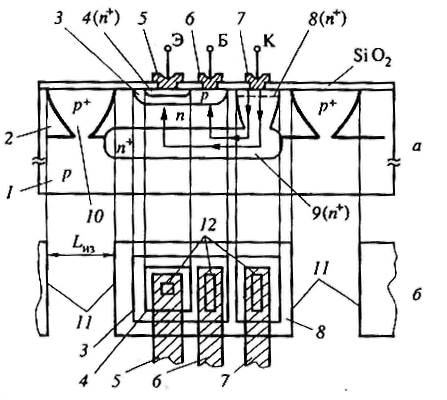
Рис.3.1.Структура интегрального транзистора с изоляцией pn-переходами
-22-
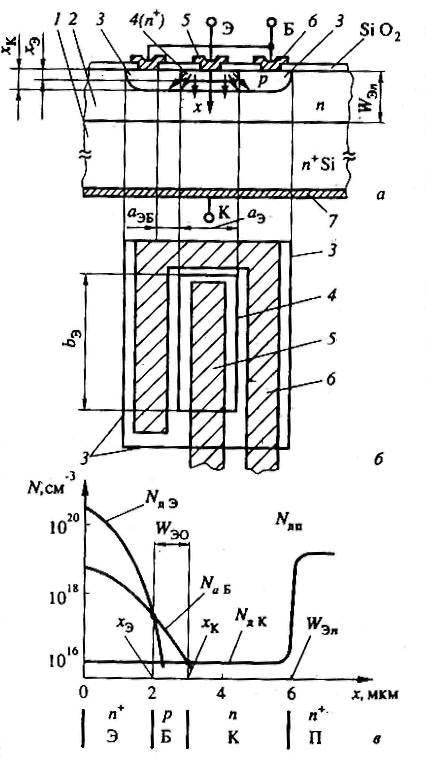
Рис.3.2. Структура дискретного эпитаксиально-планарного транзистора
и распределение концентрации примесей в областях дискретного транзистора
Подложка 1 ИС имеет проводимость p-, а не n+-типа, что необходимо для создания изолирующих pn-переходов. На подложке сформирован эпитаксиальный слой 2 n-типа толщиной в несколько мкм, а в нём с помощью легирования – базовая область 3 и эмиттерная область 4 с выводами 5 и 6. Распределение концентраций примесей аналогично рис.3.2.в.
-23-
Вывод коллектора 7 располагается сбоку от базы. Однако контакт металла со слаболегированной областью коллектора получается выпрямляющим, что недопустимо. Для получения невыпрямляющего (омического) контакта создают специальную область 8 n+ - типа (область коллекторного контакта). Чтобы обеспечить малое сопротивление коллектора на границе эпитаксиального слоя с подложкой формируют «скрытый» слой 9 n+- типа. Название отражает расположение слоя 9 в глубине структуры. На рис.3.1.а стрелками показано протекание тока от коллекторного контакта к коллекторному переходу. Основная доля тока течёт по низкоомному пути- через область 8 и скрытый слой 9. Создавая разделительные области 10 p+ - типа, формируют изолирующий pn- переход 11 с боковых сторон. Изолирующий переход снизу образуется между подложкой и скрытым слоем, а также участками эпитаксиального слоя. Переход 11 (выделен жирной линией) окружает транзисторную структуру со всех сторон, образуя изолированный «карман». На переход 11 подают обратное напряжение, для чего от подложки делается вывод, подключаемый к минусу источника питания. Для создания такой структуры необходимы следующие важнейшие операции: эпитаксия, пять легирований и нанесение металлической плёнки на поверхность. Формирование каждого слоя, а также контактных отверстий в слое SiO2, покрывающего поверхность и рисунка проводников требует специальных масок, формируемых с помощью фотолитографии. Всего требуется 7 фотолитографий, что вместе с числом указанных выше операций характеризует сложность технологического процесса. На более ранних этапах контактную область коллектора 8 формировали с помощью того же легирования, что и эмиттер, тогда её нижняя граница (показана штриховой линией на рис.3.1.а.) не достигала скрытого слоя. Это позволяло снизить на единицу число легирований и фотолитографий, но вело к росту сопротивления коллекторной области. Структура рис.3.1 является простейшей, для создания сложных современных структур требуется до 15 фотолитографий.
Площадь, занимаемая транзистором, много больше площади его эмиттера, где протекают основные физические процессы. Это обусловлено расположением выводов в одной плоскости, а также разделительными слоями 10. Отметим потери площади, возникающие из-за зазоров между краями: эмиттера и базы, базы и слоёв 10, контактной области коллектора 8 и разделительной области 10. Области 8 и 10 нельзя расположить «вплотную», так как возникает переход типа n+ - p+ с низким напряжением пробоя. Ширина областей 10 весьма велика из-за боковой диффузии акцепторов.
Рассмотренная структура типична для транзисторов, рассчитанных на малые токи эмиттера (не более нескольких mA), поэтому размеры эмиттера определяются не рабочим током, а разрешающей способностью фотолитографии. При этом эмиттер выполняется квадратным (рис3.1.б). Если же транзистор рассчитан на большие токи, то его эмиттер делается полосковым, как и в дискретном транзисторе ), базовый контакт
-24-
выполняется с обеих сторон от эмиттера, а область коллекторного контакта охватывает базу с боковых сторон. Последнее необходимо для снижения коллекторного сопротивления. (рис.!!! Стр.338 Пасынков)
Из сравнения с дискретным транзистором (рис.3.2) видно, что интегральный имеет большее коллекторное сопротивление (десятки Ом). Изолирующий pn-переход вносит паразитную ёмкость между коллектором транзистора и подложкой, что влияет на быстродействие схем. Однако не следует думать, что быстродействие интегрального транзистора хуже, чем дискретного, так как последний имеет паразитную ёмкость выводов, превышающую ёмкость изолирующего pn- перехода в интегральном транзисторе.
В структуре интегрального транзистора присутствует паразитный p-n-p- транзистор. Его эмиттером служит область базы, базой – область коллектора со скрытым слоем, коллектором подложка. Активному режиму основного транзистора соответствует режим отсечки паразитного, режиму насыщения основного - активный режим паразитного. Коэффициент передачи p-n-p- транзистора мал, так как в его базе находится n-n+ - переход с внутренним электрическим полем, тормозящем дырки, инжектированные из эмиттера в базу. Ток утечки в подложку, создаваемый p-n-p-транзистором, существенен при высоких температурах.

Рис.3.3. Распределение концентрации примесей в структуре интегрального
npn-транзистора и распределение эффективных концентраций
-25-
На рис.3.3 показано распределение примесей в слоях n-p-n- интегрального транзистора со скрытым n+- слоем. Из распределения эффективной концентрации акцепторов в базовом слое следует немонотонное распределение дырок. Справа от точки максимума градиент концентрации дырок отрицательный и внутреннее поле (по отношению к инжектированным электронам) является ускоряющим. Это характерно для всех дрейфовых транзисторов. Однако слева от точки максимума градиент концентрации положительный, а, значит, поле является тормозящим. Наличие участка с тормозящим полем приводит к некоторому увеличению результирующего времени пролёта носителей через базу. Но как показывают расчёты, это увеличение составляет всего 20-30% и для приближённых оценок может не учитываться.
В таблицах 3.1, 3.2 приведены относительные размеры слоёв интегрального n-p-n-транзистора для минимального литографического разрешения, равного 10мкм.
Таблица 3.1. Типичные параметры слоёв интегрального npn-транзистора
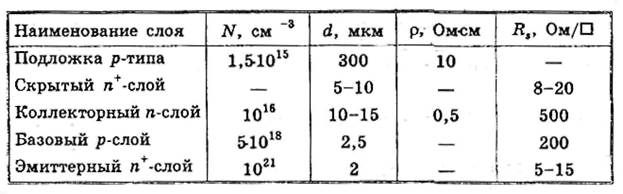
RS- удельное сопротивление слоя квадратной конфигурации. Чтобы подчеркнуть последнюю оговорку вместо истинной размерности «Ом» пишут «Ом/□» (читается: «Ом на квадрат»). Зная величину RS, легко рассчитать сопротивление слоя или плёнки прямоугольной конфигурации по известным значениям a и b.
Таблица3.2. Типичные параметры интегральных npn-транзисторов

-26-
Видно, что пробивное напряжение эмиттерного перехода в 5-7 раз меньше, чем коллекторного. Эта особенность, свойственная всем дрейфовым транзисторам, связана с тем, что эмиттерный переход образован более низкоомными слоями, чем коллекторный.
Дата добавления: 2016-04-02; просмотров: 4531;
