2 страница. В n+ области, теряющей часть отрицательных зарядов, возникает обеднение и образуется положительный заряд нескомпенсированных ионов донорной примеси
В n+ области, теряющей часть отрицательных зарядов, возникает обеднение и образуется положительный заряд нескомпенсированных ионов донорной примеси (обозначены, в отличие от подвижных зарядов, квадратами). В n области, в результате обогащения возникает избыточный отрицательный заряд. Поэтому появляется собственное электрическое поле с контактной разностью потенциалов φк. Это поле заставляет часть свободных электронов пересекать контакт в обратном направлении, т.е. порождает встречный дрейфовый ток Iдр. Устанавливается равновесное состояние:
Iдф = Iдр (15)
Токи равны и противоположны, поэтому тока во внешней цепи нет.
Нарушение равновесия в отсутствие внешнего напряжения невозможно. Например, при возникновении преобладания Iдф из-за усиления диффузии увеличатся положительный и отрицательный заряд приграничных областей, усилится электрическое поле и возрастёт встречный Iдр. Равновесие восстановится.
Наличие и равенство Iдф и Iдр наблюдается в любых контактах, в которых есть подвижные носители заряда и собственное электрическое поле.
2.4 Электроёмкость контактов
Электроёмкостью, или просто ёмкостью, называется способность различных объектов накапливать и сохранять электрические заряды.
Барьерной ёмкостью называют ёмкость таких объектов, в которых подвижные заряды сохраняются из-за отсутствия пути для их движения, т.е. для тока разряда, т.к. существует препятствие для этого тока. Таким препятствием является, например, диэлектрический слой конденсатора или диэлектрический слой между металлом и полупроводником МДП-структуры. Подобное препятствие образует также обеднённый слой полупроводника. Концентрация подвижных носителей заряда в обеднённом полупроводнике может быть настолько малой, что он, как и диэлектрик, почти не проводит ток.
Величина барьерной ёмкости контакта зависит от его площади S, толщины диэлектрического или обеднённого слоя w и его диэлектрической проницаемости εε0:
Сб = εε0S/w (16)
Диффузионной ёмкостью обладают объекты, в которых подвижные носители заряда диффундируют в некоторую полупроводниковую область и создают здесь диффузионный заряд. Диффузионный заряд и диффузионная ёмкость пропорциональны диффузионному току Iдф этих носителей и их среднему времени жизни τ:
Cдф = τIдф/φт , (17)
где φт = kT/q - термический потенциал.
В среднем, спустя время 2…3τ* носители заряда погибают в результате рекомбинации с зарядами области, в которую они проникли. Поэтому диффузионный заряд и диффузионная ёмкость существуют пока происходит приток новых носителей, т.е. при Iдф ≠ 0.
* спустя время τ, концентрация пересекших границу контакта в некоторый момент времени носителей уменьшается в e раз, спустя время 2…3τ почти все они рекомбинируют с основными носителями.
Наличие емкости контакта, требующей времени на заряд и разряд, определяет его быстродействие, т.е. способность быстро переходить из закрытого состояния в открытое и наоборот.
2.5 Электрический и тепловой пробой в контактах
Пробоем называется резкое возрастание тока в диэлектрике или обеднённом полупроводнике при достижении напряжения на таких слоях
значения напряжения пробоя Uпр. В допробойном состоянии, при U < Uпр, ток ничтожен, так как создаётся движением ничтожного количества подвижных носителей.
Электрический пробой диэлектрического или обеднённого слоя возникает при превышении в нём напряжённости поля некоторой критической напряжённости Екр. При этом напряжение не обязательно большое, так как напряженность поля Е ≈ U/w будет большой и при малых напряжениях, если мала толщина слоя w.
Типичным электрическим пробоем является лавинный пробой. При таком пробое сильное электрическое поле разгоняет свободные электроны до столь значительной скорости, что их кинетической энергии при соударениях с атомами диэлектрика или обеднённого полупроводника хватает для превращения валентных электронов атомов в свободные. Появляются новые свободные электроны, которые также разгоняются электрическим полем и соударяются с атомами. Концентрация свободных электронов и ток резко возрастают.
Лавинный пробой считается обратимым, так как он исчезает при уменьшении напряжения на обеднённом слое.
Тепловой пробой возникает, как правило, вслед за лавинным. Возросший при лавинном пробое ток увеличивает количество выделяющегося тепла, температура слоя возрастает. В результате усиливается термогенерация подвижных носителей, растёт их концентрация, ток становится ещё больше, температура ещё выше и т.д. Перегрев слоя приводит к его разрушению, поэтому тепловой пробой считается необратимым.
При лавинном пробое исчезает главное полезное свойство диэлектрического или обеднённого слоёв – низкая электропроводность, при тепловом эти слои вообще разрушаются.
3. КОНТАКТ МЕТАЛЛ – ПОЛУПРОВОДНИК. ДИОДЫ ШОТКИ
3.1. Основные свойства металло-полупроводниковых контактов
Контакт металл-полупроводник (m-n или m-p переход), относится к наиболее распространенным в электронике типам контактов. Чаще всего это обычный, омический контакт. Его сопротивление невелико, не зависит от знака и величины приложенного напряжения. Ток в омическом контакте подчиняется закону Ома. Такие контакты совершенно необходимы для электрического соединения элементов или их частей друг с другом.
Однако некоторые металлы и полупроводники образуют так называемые контакты Шотки, обладающие односторонней проводимостью. При прямом напряжении Uпр они хорошо пропускают ток (открытое состояние), при обратном напряжении Uобр тока почти нет (закрытое состояние). Такие контакты используются в диодах Шотки и некоторых типах транзисторов.
Характер контакта металл–полупроводник зависит от соотношения работ выхода контактирующего металла qjм и полупроводника qjп. Если, например, qjм<qjп, будет преобладать поток свободных электронов из металла в полупроводник. При этом в m-n переходе в приграничной области полупроводника образуется избыток свободных электронов, т.е. обогащенный слой, рис. 13,а. В таком виде в контакте свободные электроны имеются во всех его частях, и поэтому он обладает очень маленьким электрическим сопротивлением, т.е. является омическим контактом.
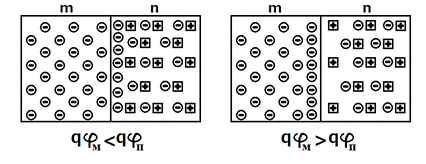
а) б)
Рис. 13
ВАХ омического контакта линейна. Его главным параметром является сопротивление R, которое должно быть минимальным. Оно определяется, главным образом, параметрами полупроводниковой области, сопротивление которой намного больше. Сопротивление этой области и контакта в целом зависит от длины области L, площади её поперечного сечения S и удельного сопротивления ρ. Удельное сопротивление, в свою очередь, зависит от концентрации носителей n и их подвижности µn:
R = ρL/S = L/ µnnS (18)
3.2. Диоды Шотки
Если qjм > qjп, в m-n переходе преобладает поток электронов из полупроводника в металл, рис. 13,б. В n-области образуется обеднённый слой.
Уменьшение концентрации свободных электронов в обеднённом слое приводит к появлению здесь положительного заряда нескомпенсированных ионов донорной примеси. Заряды в приграничных областях создают собственное электрическое поле с контактной разностью потенциалов
jк0 = jm – jп (19)
где jк0 – контактная разность потенциалов в равновесном состоянии, т.е. в отсутствие внешнего напряжения.
Чтобы получить открытое состояние, необходимо подать на контакт прямое напряжение, плюс к m – области, минус к n – области. Свободные электроны n – области начнут заполнять обеднённый слой, контактная разность потенциалов уменьшится, потенциальный барьер понизится:
jк = jк0 – Uпр (20)
Распределение свободных электронов примет вид рис. 13,а. Высокая концентрация свободных электронов во всех частях контакта обусловит протекание большого дрейфового тока, прямого тока Iпр.
При обратном напряжении
jк = jк0 + Uобр , (21)
т.е. контактная разность потенциалов и потенциальный барьер возрастут. В обеднённом слое концентрация свободных электронов станет ещё меньше, сам слой расширится. Обратный ток Iобр будет ничтожным.
Поэтому при qjм > qjп m-n переход обладает односторонней проводимостью, т.е. является контактом Шотки.
Аналогичная картина наблюдается в менее распространённом m-p контакте. При qjм < qjp это контакт Шотки, при qjм > qjp – омический контакт.
Вольт-амперные характеристики (ВАХ)омического контакта и контакта Шотки изображены на рис. 14,а и рис. 14,б:
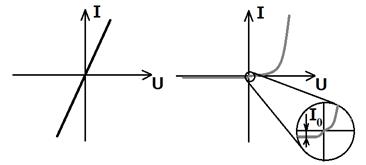
а) б)
ВАХ контакта Шотки описывается формулой Шокли:
I = I0(eU/jT – 1), (22)
Термический потенциал jT при комнатной температуре составляет 0,025 В, а прямые напряжения составляют десятые доли В. Потому при прямых (положительных) напряжениях единицей в скобках в формуле (22) можно пренебречь. Ток насыщения, или тепловой ток I0 при неизменной температуре – константа, определяющаяся конструкцией контакта. Поэтому ВАХ в области прямых напряжений, так называемая прямая ветвь - экспоненциальная.
При обратных напряжениях протекает незначительный ток I0, а при обратных напряжениях, превышающих напряжение пробоя Uпр, возникает электрический пробой и ток резко возрастает.
Важнейшими достоинствами диодов Шотки являются:
- наименьшие по сравнению с другими диодами напряжения открытого состояния, в пределах 0,2…0,5 В. Это означает, что в диодах Шотки, по сравнению с другими диодами, при одинаковом прямом токе рассеиваемая мощность Pрасс = UпрIпр меньше. Поэтому диоды Шотки отличаются меньшими тепловыми потерями;
- в открытом состоянии ток в них дрейфовый, т.к. его диффузионная составляющая ничтожна. Поэтому у диодов Шотки нет диффузионной ёмкости, емкость чисто барьерная и небольшая, они отличаются высоким быстродействием.
4. КОНТАКТ ПОЛУПРОВОДНИКОВ Р- И N- ТИПА
4.1. Основные свойства p-n перехода
Контакт p и n полупроводников, или p-n переход, как и m-n переход, является одним из распространенных видов контактов, используемых в электронике. Его главным свойством является односторонняя проводимость, т.е. способность хорошо проводить ток только при одной полярности приложенного напряжения (прямое напряжение). При обратном напряжении ток на несколько порядков меньше.
Как правило, одна из областей p-n перехода имеет намного более высокую концентрацию донорной примеси Nд или акцепторной примеси Nа. Область с большей концентрацией примесей называют также сильнолегированной областью, с меньшей – слаболегированной. Такие переходы называют асимметричными, их сильнолегированную область – эмиттером, слаболегированную – базой. Сильнолегированную область обозначают n+ или p+ , рис. 15:
Nд>>Nа Nа>>Nд
база эмиттер эмиттер база

p n+ p+ n
Рис. 15
На границе p и n областей существуют значительные градиенты концентрации свободных электронов и дырок dn/dxи dp/dx. Поэтому в p-n переходе даже в отсутствие внешнего напряжения происходит диффузия основных носителей в смежную область, т.е. наблюдается диффузионный ток основных носителей Iдф. При этом в p-n+ переходе dn/dx » dp/dx и поэтому будет преобладать электронная составляющая диффузионного тока Iдф.n . В p+-n переходе dn/dx « dp/dx и поэтому будет преобладать дырочная составляющая Iдф.p.
Диффузия основных носителей в смежную область, где они становятся неосновными, приводит к рекомбинации с основными носителями смежной области. В результате рекомбинации в приграничных областях концентрация свободных электронов и дырок очень низкая, образуется обедненный слой. В этом слое атомы примесей превращаются в нескомпенсированные ионы. Из-за очень низкой концентрации подвижных носителей заряд нескомпенсированных ионов примесей будет здесь главным типом электрических зарядов. В приграничных областях возникают два слоя таких зарядов: отрицательный заряд в р – области, положительный заряд в n – области, рис. 15. Эти заряды создают собственное электрическое поле p-n перехода с контактной разностью потенциалов φк0.
Собственное электрическое поле p-n перехода – тормозящее для диффундирующих основных носителей (образует потенциальный барьер). Это ограничивает диффузию основных носителей. Это же поле – ускоряющее для неосновных носителей, что вызывает встречный дрейф неосновных носителей, т.е. встречный дрейфовый ток Iдр = Iдф.p + Iдф.n. Чем интенсивнее диффузия, тем сильнее поле перехода и больше дрейфовый ток. Поэтому возникает устойчивое равновесие диффузионного и дрейфового токов, в результате чего тока во внешней цепи нет. Выравнивания концентраций, как это было бы, например, при диффузии газов, не происходит.
Если к переходу приложено внешнее напряжение, сила поля в переходе изменяется. Когда к р – области приложен плюс внешнего источника, т.е. при прямом напряжении, поле в переходе ослабевает (потенциальный барьер понижается):
φк = φк0 - Uпр . (23)
Поэтому усиливается диффузия основных носителей, и ослабевает дрейф неосновных. Возникает большой прямой ток Iпр – большой диффузионный ток основных носителей. Когда к р – области приложен минус, т.е. при обратном напряжении, поле в переходе усиливается (потенциальный барьер возрастает):
φк = φк0 + Uобр . (24)
Диффузия основных носителей при этом ослабевает. Возникает преобладание дрейфового тока неосновных носителей, т.е. обратный ток Iобр. Так как концентрация неосновных носителей очень мала, обратный ток намного, на несколько порядков, меньше. Этим и объясняется главное свойство p–n перехода: высокая проводимость при прямом напряжении, очень низкая – при обратном напряжении.
4.2. Основные числовые характеристики p-n перехода.
Контактную разность потенциалов в отсутствие внешнего напряжения jk0 можно найти по формуле:
NANД
jk0 = jT ln –––––-- , (25)
ni2
Подставив сюда значение термического потенциала при комнатной температуре jT = 0.025 В, типичные значения концентрации примесей асимметричного p-n перехода для базы 1016, для эмиттера 1018 см-3 и собственную концентрацию кремния при комнатной температуре ni ≈ 1010 см-3, получим типичную величину:
jk0 ≈ 0,84 В (26)
Примерно такое прямое напряжение надо подать на кремниевый p-n переход, чтобы предельно понизить потенциальный барьер и обеспечить полностью открытое состояние.
Другим важнейшим параметром p-n перехода является его толщина, или ширина, w. За w принимается протяженность приграничных областей с нескомпенсированными ионами примесей, или, что то же самое, толщина обеднённого слоя:
 , (26)
, (26)
Для кремниевого p-n перехода при указанных выше исходных данных w ≈ 1 мкм, что также является типичной величиной.
При подаче прямого напряжения переход сужается, а при подаче обратного напряжения расширяется. В этих случаях его толщину можно рассчитать, подставляя вместо φk0 в (26) φk из (23) или (24).
От толщины перехода зависят его барьерная ёмкость (16), напряжение лавинного пробоя и другие важные параметры. В p-n переходе напряжённость электрического поля при условии его однородности составит величину
E = Uобр/w (27)
и может достигать сотен кВ/см.
4.3 Вольт-амперная характеристика p-n перехода
Вольт-амперная характеристика (ВАХ) p-n перехода, в основной своей части, как и ВАХ m-n контакта Шотки, описывается формулой Шокли (22). Подчиняющуюся этой закономерности ВАХ называют идеальной, или теоретической ВАХ, рис. 16:
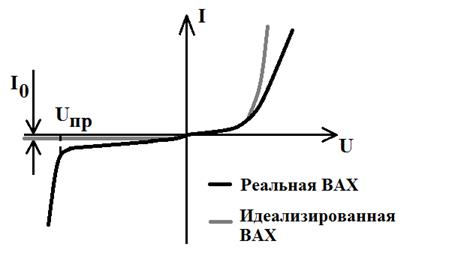
Рис. 16
ВАХ реальных p-n и m-n диодов сильно отклоняются от идеальной ВАХ в области больших обратных напряжений, когда возникает пробой (участок пробоя).
В области больших прямых токов отклонение обусловлено тем, что сопротивление заполненного носителями обеднённого слоя очень мало. При этом сопротивление перехода в целом определяется, в основном, сопротивлением прилегающих к переходу областей, в первую очередь, сопротивлением базы rб. У диодов Шотки отклонение реальной ВАХ от экспоненты при больших токах проявляется слабее, т.к. для них слабое легирование полупроводниковой области нехарактерно.
Значительное расхождение наблюдается также в допробойной части обратной ветви ВАХ. Согласно формуле Шокли при обратных напряжениях обратный ток неизменен и равен току насыщения I0. Однако в реальности на этот ток накладываются ещё несколько токов, растущих с увеличением Uобр.
Одной из составляющих обратного тока является ток утечки Iут, который обусловлен движением носителей не в самом контакте, а по его поверхности. Поверхность полупроводника взаимодействует с окружающей средой и, обладая сводными валентными связями, способна захватывать посторонние атомы. Их валентность, вероятнее всего, будет отличаться от валентности самого полупроводника, т.е. эти атомы будут для полупроводника донорными или акцепторными примесями. В результате поверхность окажется сильнолегированной и будет обладать повышенной электропроводностью. Ток утечки растёт с увеличением Uобр и, складываясь с I0, создаёт наклон допробойной части ВАХ.
5. ДИОДЫ НА ОСНОВЕ M-N, P-N ПЕРЕХОДОВ
И P-I-N СТРУКТУРЫ
5.1 Мощный выпрямительный диод
К мощным относят высоковольтные и сильноточные диоды, переход которых способен выдерживать большие обратные напряжения (до нескольких кВ) и большие прямые токи (до нескольких кА).
Согласно (27), при заданном обратном напряжении Uобр < Uпр напряжённость поля в p-n переходе можно понижать, уменьшая толщину его обеднённого слоя w. Тем самым достигается увеличение напряжения пробоя Uпр. Уменьшение w, согласно (26), достигается уменьшением концентрации примесей. Поэтому одну из областей, базу высоковольтного p-n диода делают слаболегированной. В m-n переходах Uпр намного меньше и в качестве высоковольтных диодов они не используются.
Толщина p-n перехода будет ещё больше, если сделать слаболегированной и вторую область. Однако в этом случае уменьшатся градиенты концентрации обоих видов носителей и поэтому окажется небольшим диффузионный прямой ток. Поэтому вторую область перехода, эмиттер, делают сильнолегированной. Это позволяет сделать достаточно большой электронную или дырочную составляющую диффузионного тока. Тем самым обеспечивается необходимое значение прямого тока.
Увеличение допустимого прямого тока достигается также за счёт увеличения площади p-n и m-n переходов. При этом снижается плотность прямого тока Jпр = Iпр/S, которая не должна превышать критического значения. Кроме того, при увеличении S уменьшается сопротивление открытого состояния, что уменьшает тепловые потери при больших токах. Особенно большой прямой ток достигается в диодах Шотки, так как их напряжение открытого состояния и тепловые потери в 2…3 раза меньше, чем у p-n диодов.
Поскольку в ассиметричных p-n переходах (с эмиттером и базой) одновременно максимизируется обратное напряжение и прямой ток, именно такие, ассиметричные переходы наиболее распространены.
Мощные выпрямительные диоды применяются в выпрямителях – преобразователях переменного тока в постоянный.
5.2. Импульсные и высокочастотные диоды
Импульсные диоды должны обладать минимальным временем переключения из закрытого состояния в открытое и наоборот. В высокочастотных диодах минимальны паразитные реактивные составляющие токов. То и другое обеспечивается, в основном, минимизацией барьерной и диффузионной ёмкости диодов.
Уменьшение барьерной ёмкости m-n и p-n переходов, согласно (16), достигается уменьшением площади контакта S. На сегодня, благодаря интегральной технологии, она может составлять всего несколько десятков нм2. Однако уменьшение S находится в противоречии с необходимость обеспечить необходимый прямой ток. Поэтому выбор S и других величин в (16) всегда компромиссен. Известны также попытки перехода от кремния к полупроводникам с меньшей величиной εε0.
Диффузионная ёмкость отсутствует в диодах Шотки, что делает их основным типом для указанных применений.
В диодах с p-n переходом диффузионную ёмкость удаётся уменьшить за счёт уменьшения толщины базы. На рис. 17 изображены p-n+ диоды с обычной (а) и тонкой базой (б):
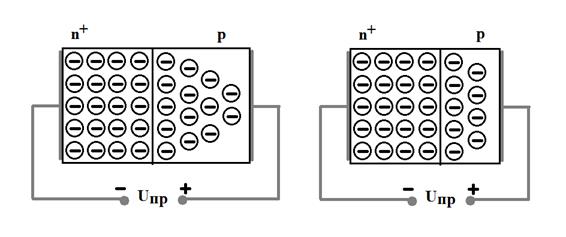
Рис. 17.а Рис. 17.б
Т.к. у этих диодов эмиттером является сильнолегированная n-область, при прямом напряжении будет наблюдаться преимущественно электронный диффузионный ток. Рис. 17 демонстрирует распределение свободных электронов в обоих диодах. Очевидно, что в диоде с тонкой базой пространство, где существует диффузионный заряд, а также сам этот заряд, намного меньше. Поэтому здесь намного меньше и диффузионная ёмкость.
Согласно (17), диффузионную емкость p-n диода можно также уменьшить, уменьшив среднее время жизни неосновных носителей в базе τ.
Для этого, например, можно несколько увеличить концентрацию примеси в базе, что вызовет более интенсивную рекомбинацию и уменьшение τ.
Всё сказанное в равной степени относится к m-n и p-n переходам в интегральных схемах, где они используются не только в качестве диодов, но и в составе других элементов.
5.3. Стабилитрон
Стабилитрон – диод, предназначенный для стабилизации напряжения в режиме электрического пробоя. Почти всегда в таком диоде используется кремниевый p-n переход, отличающийся способностью работать при температурах до 1250 С и малой склонностью к возникновению теплового пробоя.
Схема включения стабилитрона представлена на рис. 18:
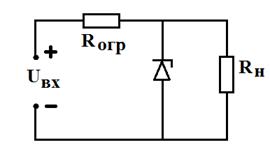
Рис. 18
Здесь Uвх – нестабильное напряжение источника питания – батареи, аккумулятора, солнечной батареи и т.п. На стабилитрон подано обратное напряжение, достаточное для возникновения электрического пробоя. Rогр не позволяет току в стабилитроне превысить предельно допустимое значение Iобр.макс. Тем самым исключается переход электрического пробоя в тепловой. Сопротивление нагрузки Rн включено параллельно стабилитрону. Поэтому напряжения на них равны и близки к напряжению пробоя Uпр. Напряжение на нагрузке, в зависимости от крутизны участка пробоя, остаётся более или менее стабильным.
5.4. ВАРИКАП
Варикап – диод, предназначенный для работы в режиме управляемой барьерной ёмкости Cб.
При обратном напряжении на p-n переходе ток в нём очень небольшой и, если есть переменная составляющая Nд, существует ёмкостная составляющая обратного тока Iобр. Ёмкостный обратный ток тем больше, чем больше Cб и выше частота переменной составляющей. Его величина может намного превосходить активную составляющую обратного тока. Поэтому p-n
переход при обратном напряжении можно использовать, как ёмкостный элемент. При прямом напряжении это невозможно, т.к. в этом случае появляется на несколько порядков больший активный прямой ток.
Подставив (26) в (16) с учётом того, что при обратном напряжении jк = jк0 + Uобр, получим:
Cб = [2εε0(jк0 + Uобр)(Nа + Nд)/qNаNд]½ (28)
Из (28) следует, что барьерной емкостью можно управлять, изменяя обратное напряжение на p-n переходе. Таким образом, p-n диод при Uобр является элементом с ёмкостью Cб, которую можно изменять.
При изготовлении варикапа полупроводник, тип примесей и закон их распределения в областях выбираются так, чтобы зависимость Cб(Uобр) была более сильной. В общем случае эта зависимость описывается выражением
Cб = [2εε0(jк0 + Uобр)(Nа + Nд)/qNаNд]m (29)
где m = 0,3…1.
Схема включения варикапа приведена на рис. 19. Здесь варикап
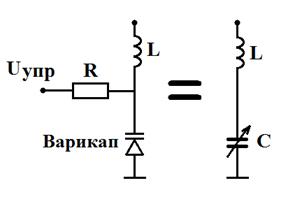
Рис. 19
включён как ёмкость последовательного колебательного контура. На него подаётся управляющее обратное напряжение Uупр. Изменяя это напряжение можно настраивать колебательный контур на необходимую резонансную частоту ω0 = (1/√LC).
5.5. Диоды на основе p-i-n структуры
Значительно улучшить импульсные, частотные и другие свойства диодов позволяет использование p-i-n структуры. В такой структуре между p и n областями располагается i-область собственного полупроводника, рис. 20.
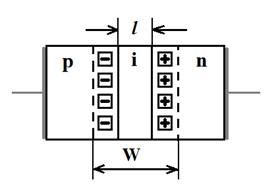
Рис. 20
Собственный полупроводник обладает на несколько порядков более низкой концентрацией свободных электронов и дырок по сравнению с p и n областями. Поскольку в таком полупроводнике примесей нет, эта область как бы «отодвигает» друг от друга слои с нескомпенсированными ионами примесей. В результате многократно возрастают w и сопротивление закрытого состояния, а также многократно уменьшается барьерная ёмкость.
Чтобы сохранить высокие значения градиентов концентрации ≈ dn/dw и ≈ dp/dw и, тем самым, сохранить большим диффузионный прямой ток, толщину i-области l делают не слишком большой:
l < L, (30)
где L – диффузионная длина – среднее расстояние, на котором концентрация диффундирующих в i-область носителей уменьшается в e раз из-за рекомбинации.
P-i-n диоды являются на сегодня одними из наиболее совершенных электронных ключей. Их обратный ток, барьерная ёмкость и сопротивление открытого состояния минимальны (у идеального ключа все эти параметры равны нулю).
5.6. Свето- и фото-диоды. Солнечные батареи
Устройство свето- и фото-диодов в целом одинаково, рис. 21. Одна из
областей их p-n перехода очень тонкая, что позволяет возникающему в переходе свету излучаться в окружающее пространство (светодиод) или позволяет внешнему свету проникать в переход (фотодиод).
Дата добавления: 2016-03-05; просмотров: 1453;
