Конструкция МДП–транзисторов в микросхемах с алюминиевой металлизацией.
 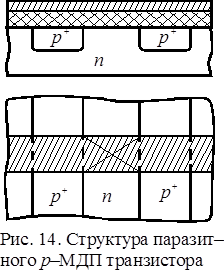
|
Вариант конструкции активного транзистора с прямоугольным каналом и со средним значением крутизны сток–затворной характеристики представлен на рис. 13. Под алюминиевым затвором находится тонкий слой термически выращенного окисла кремния (0,05 – 0.10 мкм). За приделом области канала толщина окисла составляет 1 мкм. Это сравнительно толстый слой окисла выполняет функцию защитного диэлектрика, позволяет существенно снизить значение паразитных емкостей сигнальных шин и повысить пороговое напряжение паразитных МДП–транзисторов (рис. 14) в местах прохождения алюминиевых проводников над диффузионными шинами питания.
В нагрузочных транзисторах значение крутизны сток–затворной характеристики может быть небольшим, и соответственно отношение длины канала к его ширине выбирается таким, чтобы при заданной крутизне нагрузочный транзистор занимал минимальную площадь (рис. 15). В том случае, когда для обеспечения высоких значений крутизны характеристик активного транзистора отношении bk/lk должно быть больше или равно 20, с целью экономии площади транзистора рекомендуется П–образная форма канала (рис. 16).
Для повышения степени интеграции в микросхемах, требующих последовательного и параллельного соединения транзисторов, области истоков или стоков МДП–транзисторов могут быть объединены (рис. 17).
 
|

|
В настоящее время p–канальные МДП–транзисторы с индуцированным каналом и алюминиевым затвором имеет следующие характеристики: минимальная длина канала 5 – 10 мкм, глубина залегания p–n переходов 1,5 – 2 мкм, толщина подзатворного диэлектрика 0,1 – 0,15 мкм, напряжение питания 5–12 В, пороговое напряжение – 4 В, удельное поверхностное сопротивление диффузионных областей истока и стока и диффузионных шин 50 … 100 Ом/, пробивное напряжение p–n переходов областей истока и стока выше 15 В, пороговое напряжение паразитных транзисторов выше 40 В, подвижность дырок в канале около 200 см2/(В×с), плотность поверхностных состояний 1011…1012 см–2. На таких структурах созданы первые логические интегральные МДП–транзисторы. Хорошо отработанная технология и низкая стоимость производства способствует использования этих микросхем до настоящего времени, несмотря на худшие характеристики. Усовершенствование технологических операций направленное на снижение встроенного окисле заряда и плотности поверхностных состояний, привело к созданию интегральных n–канальных МДП– транзисторов. Преимуществом микросхем на таких транзисторах является повышенное (2…3 раза) быстродействие, совместимость по знаку и уровню питающего напряжения с ТТЛ–микросхемами.
Применение кремневых подложек с рабочей поверхностью с рабочей поверхностью, ориентированной по кристаллографической плоскости (100), приводит к уменьшению плотности поверхностных состояний до 1011 см–2 и к еще большему снижению пороговых напряжений.
Возможность управления пороговым напряжением расширяется, если использовать многослойный подзатворный диэлектрик. В этом случае появляются дополнительные заряды на границе диэлектриков, объемный встроенный заряд дополнительного диэлектрика и заряд, обусловленный поляризацией диэлектриков.
МНОП–транзисторы.
Одним из вариантов МДП–транзистора с многослойным диэлектриком является структура метал–нитрид кремния–окисел кремния–полупроводник (МНОП). Пленка нитрида кремния обладает высокой пассивирующей способностью и обладает высокой диэлектрической проницаемостью. Это позволило снизить пороговое напряжение до 1 … 1,5 В и повысить удельную крутизну.
Однако использование только одного нитрида кремния в качестве подзатворного диэлектрика невозможно, так–как появляется заряд на границе раздела кремний–нитрид кремния, зависящий от напряжения на затворе. Это приводит к непостоянству порогового напряжения и его гистерезису.
Использование МНОП–структуры позволило получить приборы, в которых эквивалентная толщина диэлектрика меньше примерно в полтора раза, а пороговое напряжение меньше в среднем на 1 В. Эту структуру при толщине пленки SiO2 0,005 мкм можно использовать в качестве элемента памяти в ППЗУ с электрическим стиранием и записью информации.
МОАП–транзисторы
Использование Al2O3 в качестве второго подзатворного диэлектрика связано с его способностью, создавать на границе с SiO2 встроенный отрицательный заряд. Это позволяет создавать n–канальные приборы с индуцированным каналом, работающие в режиме обогащения при пороговом напряжении, примерно равном +1 В.
Дата добавления: 2016-01-07; просмотров: 1690;
