Термическое окисление
Окисление кремния - один из самых характерных процессов в технологии современных ППИМС. Получаемая при этом пленка двуокиси кремния SiO2 (рисунок 3.2б) выполняет несколько важных функций, в том числе:
- функцию защиты - пассивацииповерхности и, в частности, защиты вертикальных участков p-n переходов, выходящих на поверхность;
- функцию маски, через окна в которой вводятся необходимые примеси методом диффузии (рисунок 3.4б);
- функцию тонкого диэлектрика под затвором МОП-транзистора или конденсатора (рисунки 4.15 и 4.18в);
- диэлектрическое основание для соединения металлической пленкой элементов ПП ИМС (рисунок 4.1).
Поверхность кремния всегда покрыта «собственной» окисной пленкой, получающейся в результате «естественного» окисления при самых низких температурах. Однако эта пленка имеет слишком малую толщину (около 5 нм), чтобы выполнять какую-либо из перечисленных функций. Поэтому при производстве полупроводниковых ИМС более толстые пленки SiO2 получают искусственным путем.
Искусственное окисление кремния осуществляется обычно при высокой температуре (1000-1200° С). Такое термическое окисление можно проводить в атмосфере кислорода (сухое окисление),в смеси кислорода с парами воды (влажное окисление) или просто в парах воды.
Во всех случаях процесс проводится в окислительных печах. Основу таких печей составляет, как и при эпитаксии, кварцевая труба, в которой размещается «лодочка» с пластинами кремния, нагреваемая либо токами высокой частоты, либо иным путем. Через трубу пропускается поток кислорода (сухого или увлажненного) или пары воды, которые реагируют с кремнием в высокотемпературной зоне. Получаемая таким образом пленка SiO2 имеет аморфную структуру (рисунок 3.2б).
Очевидно, что скорость роста окисла со временем должна убывать, так как новым атомам кислорода приходится диффундировать через все более толстый слой окисла. Полуэмпирическая формула, связывающая толщину окисной пленки со временем термического окисления, имеет вид:
d»k  ,
,
где k — параметр, зависящий от температуры и влажности кислорода.
Сухое окисление идет в десятки раз медленнее влажного. Например, для выращивания пленки SiO2 толщиной 0,5 мкм в сухом кислороде при 1000° С требуется около 5 ч, а во влажном - всего 20 мин. Однако, качество пленок, полученных во влажном кислороде, ниже. С уменьшением температуры на каждые 100° С время окисления возрастает в 2-3 раза.
В технологии ИМС различают «толстые» и «тонкие» окислы SiO2. Толстые окислы (d= 0,7-1,0 мкм) выполняют функции защиты и маскировки, а тонкие (d=0,1-0,2 мкм) - функции подзатворного диэлектрика в МОП-транзисторах и конденсаторах.
Одной из важных проблем при выращивании пленки SiO2 является обеспечение её однородности. В зависимости от качества поверхности пластины, от чистоты реагентов и режима выращивания в пленке возникают те или иные дефекты.Распространенным типом дефектов являются микро- и макропоры, вплоть до сквозных отверстий (особенно в тонком окисле).
Качество окисной пленки повышается с уменьшением температуры ее выращивания, а также при использовании сухого кислорода. Поэтому тонкий подзатворный окисел, от качества которого зависит стабильность параметров МОП-транзистора, получают сухим окислением. При выращивании толстого окисла чередуют сухое и влажное окисление: первое обеспечивает отсутствие дефектов, а второе позволяет сократить время процесса.
Другие методы получения пленки SiO2 рассмотрены в [5].
Литография
В технологии полупроводниковых приборов важное место занимают маски: они обеспечивают локальный характер напыления, легирования, травления, а в некоторых случаях и эпитаксии. Всякая маска содержит совокупность заранее спроектированных отверстий – окон. Изготовление таких окон есть задача литографии(гравировки). Ведущее место в технологии изготовления масок сохраняют фотолитография и электронолитография.
3.4.1. Фотолитография. В основе фотолитографии лежит исполь- зование материалов, которые называют фоторезистами.Это разновидность фотоэмуль- сий, известных в обычной фотографии. Фоторезисты чувствительны к ультрафиолетовому свету, поэтому их можно обрабатывать в не очень затемненном помещении.
Фоторезисты бывают негативные и позитивные. Негативные фоторе- зисты под действием света полимеризуются и становятся устойчивыми к травителям (кислотным или щелочным). Значит, после локальной засветки будут вытравливаться не засвеченные участки (как в обычном фото- негативе). В позитивных фоторезистах свет, наоборот, разрушает полимерные цепочки и, значит, будут вытравливаться засвеченные участки.
Рисунок будущей маски изготавливается в виде так называемого фотошаблона. Фотошаблон представляет собой толстую стеклянную пластину, на одной из сторон которой нанесена тонкая непрозрачная пленка с необходимым рисункомв виде прозрачных отверстий. Размеры этих отверстий (элементов рисунка) в масштабе 1 : 1 соответствуют размерам будущих элементов ИС, т. е. могут составлять 20—50 мкм и менее (до 2—3 мкм). Поскольку ИС изготавливаются групповым методом, на фотошаблоне по «строкам» и «столбцам» размещается множество однотипных рисунков. Размер каждого рисунка соответствует размеру будущего кристалла ИС.
Процесс фотолитографии для получения окон в окисной маске SiO2, покрывающей поверхность кремниевой пластины, состоит в следующем (рисунок 3.3). На окисленную поверхность пластины наносится, например, негативный фоторезист (ФР). На пластину, покрытую фоторезистом, накладывают фотошаблон ФШ (рисунком к фоторезисту) и экспонируют его в ультрафиолетовых (УФ) лучах кварцевой лампы (рисунок 3.3а). После этого фотошаблон снимают, а фоторезист проявляют и закрепляют.
Если используется позитивный фоторезист, то после проявления и закрепления (которое состоит в задубливании и термообработке фоторезиста) в нем получаются окна на тех местах, которые соответствуют прозрачным участкам на фотошаблоне.
Как говорят, рисунок перенеслис фотошаблона на фоторезист. Теперь слой фоторезиста представляет собой маску, плотно прилегающую к окисному слою (рисунок 3.3б).
Через фоторезистивную маску производится травление окисного слоя вплоть до кремния (на кремний данный травитель не действует). В качестве травителя используется плавиковая кислота и её соли. В результате рисунок с фоторезиста переносится на окисел. После удаления (стравливания) фоторе -зистивной маски конечным итогом фотолитографии оказывается кремниевая пластина покрытая окисной маской с окнами (рисунок 3.3в). Через окна можно осуществлять диффузию, ионную имплантацию, травление и т. п.
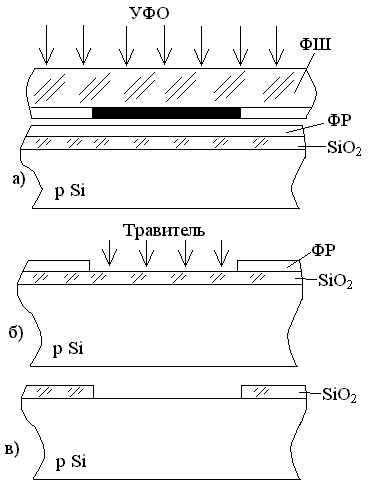
Рисунок 3.3
В технологических циклах изготовления элементов ИМС процесс фотолитографии используется многократно (отдельно для получения базовых слоев, эмиттеров, омических контактов и т. д.). При этом возникает так называемая проблема совмещения фотошаблонов. При многократном использовании фото- литографии (в технологии ППИМС до 5-7 раз) допуск на совмещение доходит до долей микрона. Техника совмещения состоит в том, что на фотошаблонах делают специальные «отметки» (например, крестики или квадраты), которые переходят в рисунок на окисле и просвечивают сквозь тонкую пленку фоторе-зиста. Накладывая очередной фотошаблон, аккуратнейшим образом (под микроскопом) совмещают отметки на окисле с аналогичными отметками на фотошаблоне.
Рассмотренный процесс фотолитографии характерен для получения окисных масок на кремниевых пластинах с целью последующей локальной диффузии. В этом случае фоторезистивная маска является промежуточной, вспомогательной, так как она не выдерживает высокой температуры, при которой проводится диффузия. Однако в некоторых случаях, когда процесс идет при низкой температуре, фоторезистивные маски могут быть основными -рабочими. Примером может служить процесс создания металлической разводки в полупроводниковых ИМС.
При использовании фотошаблона его эмульсионный слой изнашивается (стирается) уже после 15—20 наложений. Срок службы фотошаблонов можно увеличить на два порядка и более путем металлизации: заменяя пленку фотоэмульсии на пленку износостойкого металла, обычно хрома.
Фотошаблоны изготавливаются комплектами по числу операций фотолитографии в технологическом цикле. В пределах комплекта фотошаблоны согласованы, т. е. обеспечивают совмещение рисунков при совмещении соответствующих отметок.
3.4.2 Электронолитография. Описанные методы долгое время составляли одну из основ микроэлектронной технологии. Они и до сих пор не потеряли своего значения. Однако по мере повышения степени интеграции и уменьшения размеров элементов ИС возник ряд проблем, которые частично уже решены, а частично находятся в стадии изучения.
Одно из принципиальных ограничений касается разрешающей способ- ности,т. е. минимальных размеров в создаваемом рисунке маски. Дело в том, что длины волн ультрафиолетового света составляют 0,3-0,4 мкм. Следова- тельно, каким бы малым не было отверстие в рисунке фотошаблона, размеры изображения этого отверстия в фоторезисте не могут достигать указанных значений (из-за дифракции). Поэтому, минимальная ширина элементов составляет около 2 мкм, а при глубоком ультрафиолете (длина волны 0,2-0,3 мкм) – около 1 мкм. Между тем размеры порядка 1—2 мкм уже оказываются недостаточно малыми при создании больших и сверхбольших ИМС.
Наиболее очевидный путь для повышения разрешающей способности лито- графии - использование при экспозиции более коротковолновых излучений.
За последние годы разработаны методы электронной литографии.Их сущность состоит в том, что сфокусированный пучок электронов сканируют(т. е. перемещают «построчно») по поверхности пластины, покрытой электронорезистом, и управляют интенсивностью пучка в соответствии с заданной программой. В тех точках, которые должны быть «засвечены», ток пучка максимален, а в тех, которые должны быть «затемнены», — равен нулю. Диаметр пучка электронов находится в прямой зависимости от тока в пучке: чем меньше диаметр, тем меньше ток. Однако с уменьшением тока растет время экспозиции. Поэтому повышение разрешающей способности (уменьшение диаметра пучка) сопровождается увеличением длительности процесса. Например, при диаметре пучка 0,2—0,5 мкм время сканирования пластины, в зависимости от типа электронорезиста и размеров пластины, может лежать в пределах от десятков минут до нескольких часов.
Одна из разновидностей электронной литографии основана на отказе от электронорезистивных масок и предусматривает воздействие электронного пучка непосредственно на окисный слой SiO2. Оказывается, что в местах «засветки» этот слой в дальнейшем травится в несколько раз быстрее, чем в «затемненных» участках.
Минимальные размеры при электронолитографии составляют 0,2 мкм, хотя предельно достижимы – 0,1 мкм.
В стадии исследования находятся другие методы литографии, например, мягкое рентгеновское излучение (с длинами волн 1—2 нм) позволяет получить минимальные размеры 0,1 мкм, а ионно-лучевая литография 0,03 мкм.
Легирование
Внедрение примесей в исходную пластину (или в эпитаксиальный слой) путем диффузии при высокой температуре является исходным и до сих пор основным способом легирования полупроводников с целью создания транзисторных структур и на их основе других элементов. Однако за последнее время широкое распространение получил и другой способ легирования - ионная имплантация.
3.5.1 Способы диффузии. Диффузия может быть общей и локальной. В первом случае она осуществляется по всей поверхности пластины (рисунок 3.4а), а во втором - на определенных участках пластины через окна в маске, например, в толстом слое SiO2 (рисунок 3.4б).
Общая диффузия приводит к образованию в пластине тонкого диффузионного слоя, который отличается от эпитаксиального неоднородным (по глубине) распределением примеси (см. кривые N(x)на рисунках 3.6а и б).
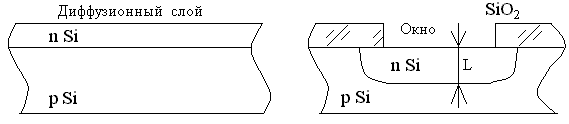
| а) | б) |
Рисунок 3.4
В случае локальной диффузии (рисунок 3.4б) примесь распространяется не только в глубь пластины, но и во всех перпендикулярных направлениях, т. е. под маску. В результате этой так называемой боковой диффузииучасток р-n перехода, выходящий на поверхность, оказывается «автоматически» защищенным окислом. Соотношение между глубинами боковой и основной -
«вертикальной» диффузии зависит от ряда факторов, в том числе от глубины диффузионного слоя. Типичным для глубины боковой диффузии можно считать значение 0,8×L.
Диффузию можно проводить однократно и многократно. Например, в исходную пластину n-типа можно во время 1-й диффузии внедрить акцеп- торную примесь и получить р-слой, а затем во время 2-й диффузии внедрить в полученный р-слой (на меньшую глубину) донорную примесь и тем самым обеспечить трехслойную структуру. Соответственно различают двойную и тройную диффузию (см раздел 4.2).
При проведении многократной диффузии следует иметь в виду, что концентрация каждой новой вводимой примеси должна превышать концен- трацию предыдущей, в противном случае тип проводимости не изменится, а значит, не образуется р-n переход. Между тем концентрация примеси в кремнии (или другом исходном материале) не может быть сколь-угодно большой: она ограничена особым параметром - предельнойрастворимостью примеси NS.Предельная растворимость зависит от температуры. При некоторой температуре она достигает максимального значения, а затем снова уменьшается. Максимальные предельные растворимости вместе с соответствующими температурами приведены в таблице 3.1.
Таблица 3.1
| Примесь | As | Р | В | Sb |
| NS, см-3 | 20×1020 | 13×1020 | 5×1020 | 0,6×1020 |
| Т0, С |
Следовательно, если проводится многократная диффузия, то для последней диффузии нужно выбирать материал с максимальной предельной растворимостью. Поскольку ассортимент примесных материалов ограничен,
не удается обеспечить более 3-х последовательных диффузий.
Примеси, вводимые путем диффузии, называют диффузантами(бор, фосфор и др.). Источниками диффузантов являются их химические соединения. Это могут быть жидкости (ВВr3, РОСl), твердые тела (В2О3, P2O5) или газы (В2Н6, РН3).
Внедрение примесей обычно осуществляется с помощью газотран- спортных реакций - так же, как при эпитаксии и окислении. Для этого используются либо однозонные, либо двухзонные диффузионные печи.
Двухзонные печи используются в случае твердых диффузантов. В таких печах (рисунок 3.5) имеются две высокотемпературные зоны, одна - для испарения источника диффузанта, вторая - собственно для диффузии.

Рисунок 3.5
Пары источника диффузанта, полученные в 1-й зоне, примешиваются к по- току нейтрального газа-носителя (например, аргона) и вместе с ним доходят до 2-й зоны, где расположены пластины кремния. Температура во 2-й зоне выше, чем в 1-й. Здесь атомы диффузанта внедряются в пластины, а другие составляющие химического соединения уносятся газом-носителем из зоны.
В случае жидких и газообразных источников диффузанта нет необходи- мости в их высокотемпературном испарении. Поэтому используются однозон- ные печи, как при эпитаксии, в которые источник диффузанта поступает уже в газообразном состоянии.
При использовании жидких источников диффузанта диффузию проводят в окислительной среде, добавляя к газу-носителю кислород. Кислород окисляет поверхность кремния, образуя окисел SiO2, т. е. в сущности - стекло. В присут- ствии диффузанта (бора или фосфора) образуется боросиликатное или фосфорносиликатное стекло. При температуре выше 1000оС эти стекла находятся в жидком состоянии, покрывая поверхность кремния тонкой пленкой,так что диффузия примеси идет, строго говоря, из жидкой фазы. После застывания стекло защищает поверхность кремния в местах диффузии,
т. е. в окнах окисной маски. При использовании твердых источников диффузанта - окислов - образование стекол происходит в процессе диффузии без специально вводимого кислорода.
Различают два случая распределения примеси в диффузионном слое.
1 Случай неограниченного источника примеси.В этом случае диф-фузант непрерывно поступает к пластине, так что в её приповерхностном слое концентрация примеси поддерживается постоянной равной NS. С увеличением времени диффузии увеличивается глубина диффузионного слоя (рисунок 3.6а).
2 Случай ограниченного источника примеси.В этом случае сначала в тонкий приповерхностный слой пластины вводят некоторое количество атомов диффузанта (время t1), а затем источник диффузанта отключают и атомы примеси перераспределяются по глубине пластины при неизменном их общем количестве (рисунок 3.6б). При этом концентрация примеси на поверхности снижается, а глубина диффузионного слоя увеличивается (кривые t2 и t3). Первую стадию процесса называют ²загонкой², вторую - ²разгонкой² примеси.
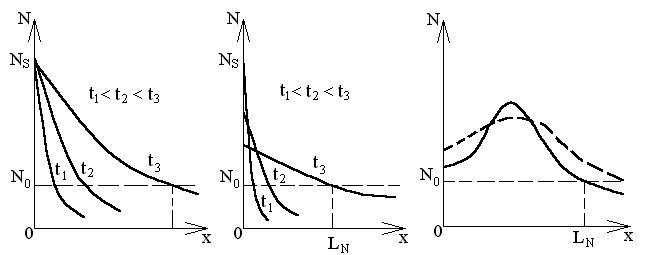
| а) | б) | в) |
Рисунок 3.6
Ионная имплантация.
Ионной имплантацией называют метод легирования пластины (или эпитаксиального слоя) путем бомбардировки ионами примеси, ускоренными до энергии, достаточной для их внедрения в глубь твердого тела.
Ионизация атомов примеси, ускорение ионов и фокусировка ионного пучка осуществляются в специальных установках типа ускорителей частиц в ядерной физике. В качестве примесей используются те же материалы, что и при диффузии.
Глубина внедрения ионов зависит от их энергии и массы. Чем больше энергия, тем больше получается толщина имплантированного слоя. Однако с ростом энергии возрастает и количество радиационных дефектовв кристалле, т. е. ухудшаются его электрофизические параметры. Поэтому энергию ионов ограничивают величиной 100-150 кэВ. Нижний уровень составляет 5-10 кэВ. При таком диапазоне энергии глубина слоев лежит в пределах 0,1 - 0,4 мкм, т.е. она значительно меньше типичной глубины диффузионных слоев.
Концентрация примеси в имплантированном слое зависит от плотности тока в ионном пучке и времени процесса или, как говорят, от времени экспо-зиции.В зависимости от плотности тока и желаемой концентрации время экспозиции составляет от нескольких секунд до 3-5 мин и более (иногда до
1-2 ч). Разумеется, чем больше время экспозиции, тем опять же больше количество радиационных дефектов.
Типичное распределение примеси при ионной имплантации показано на рисунке 3.6в сплошной кривой. Как видим, это распределение существенно отличается от диффузионного наличием максимума на определенной глубине.
Поскольку площадь ионного пучка (1-2 мм2) меньше площади пластины (а иногда и кристалла), приходится сканироватьпучок, т. е. плавно или «шага- ми» перемещать его (с помощью специальных отклоняющих систем) пооче- редно по всем «строкам» пластины, на которых расположены отдельные ИМС.
По завершении процесса легирования пластину обязательно подвергают отжигупри температуре 800-1100° С для того, чтобы упорядочить кристал- лическую решетку кремния и устранить (хотя бы частично) неизбежные радиа-ционные дефекты. При температуре отжига процессы диффузии несколько меняют профиль распределения (см. штриховую кривую на рисунке 3.6в).
Ионная имплантация проводится через маски, в которых длина пробега ионов должна быть значительно меньше, чем в кремнии. Материалом для масок могут служить распространенные в ИМС двуокись кремния или алюминий. При этом важным достоинством ионной имплантации является то, что ионы, двигаясь по прямой линии, внедряются только в глубь пластины, а аналогия боковой диффузии (под маску) практически отсутствует.
В принципе ионную имплантацию, как и диффузию, можно проводить многократно, «встраивая» один слой в другой. Однако сочетание энергий, времен экспозиции и режимов отжига необходимое для многократной имплантации, оказывается затруднительным. Поэтому ионная имплантация получила главное распространение при создании тонких одинарных слоев.
Дата добавления: 2015-12-16; просмотров: 2701;
