Биполярные транзисторные структуры.
В.1 Виды и устройства БПТС.
В.2 Принцип действия.

Перестройка кристаллической структуры в отдельной области кристалла- это п/п структура.
|
В транз. структуре используется н/з обоих знаков
По числу р-n-переходов подразделяется:
- однопереходные
- двухпереходные
- многопереходные
Наиболее распр. двухпереходные
Основу составляет две диодные п/п структуры ē електро-дырочным переходом имеющую общую бозовую область.
|

| ||
| ||
|
Для реализации усилит свойств необходимо:
- Чтобы инжектированные н/з в базу попадали в колект. обл. без потерь., это становится возможным если толщина базы будет min или меньше диффузионной длинны н/з кроме того концентрация примесей в эмиттере должна быть больше чем в коллекторе больше примеси в базовой области
NЭ > NК >NБ
- S коллект. перехода была большой для эффективного сбора н/з.
В зависимости от примесей:
- без дрейфовые (движение н/з под действием grad концентрации)
- дрейфовые (появляются внутренние эл.поля)
В.2
В зависимости от включения переходов в транз. структуре и величин действия на них напряжения различных следствий режимы работы:
- отсечки
- насыщения
- активно-нормальный
- активно-инверстный
- ловинное размножение н/з

| ЭП | КП | Режим | ||
| Vэб < 0 | Vкб < 0 | обр | обр | отсечки |
| Vэб > 0 | Vкб > 0 | Пр | Пр | насыщ |
| Vэб > 0 | Vкб < 0 | Пр | Обр | акт-норм |
| Vэб > 0 | Vкб < 0 | Пр | Обр | лавинно размнож |
| Vэб < 0 | Vкб > 0 | обр | Пр | акт-инвер |
В режиме лавиноразмножения н/з но в отличие от обычного нормального режима величина напряжения его электрического пробоя, что приводит к росту тока в коллекторе.
Из всех самый лучший = активно-нормальный
В.3
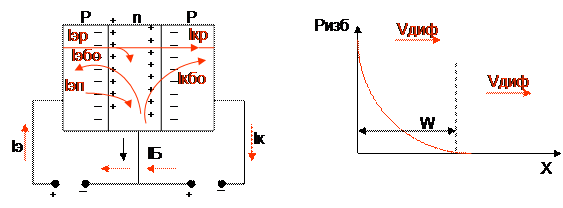
Принцип действия рассмотрен на активно-нормальном режиме бездрейфовой структуры
«р-n-р»-типа перехода
Процесс в эмитере:
При смещении Эл.-дырочного перехода в прямом направлении дырки из эмиттера инжектируются в базовую область образуя в Э дырочный состав.
Процесс в базе:
Дырки попав в обл. базы оказывается там неосн. н/з под действием grad концентрации диффундируют к коллекторному переходу. Дырки в Б приводят ее к электрической нейтральности. Для ее восстановления от исп. VЭБ в Б поступает такое же количество ē. Дырки дифунт. через базу частично в ней рекомбинируются с ē, образуя рекомбинирующую составляющую тока базы.
Процессы в коллекторе:
Дырки дошедшие до КП истрогируются в коллектор обл. образуя там дырочную сост. коллекторного тока.
Лекция № 12. Внутриние параметры транз. структуры.
В.1 Коэффициент передачи Iэ
В.2 Коэффициент передачи IБ
Эл. свойства транз. структуры опред. протек. в структуре токами знач. которое зависит от режима вкл. «р-n»-переходов.
Коэф. передачи Iэ
Токи транз. структур. связаны параметрами:
- статические
- диффенциальные
Статический, связ. между собой Iк и Iэ
| |||
|
Эффективность эмиттера или коэф. инжекции:
| |||
|
б0- коэф. переноса
Наиболее употреб. явл. диффузиальный параметр
|
|
статический коэффициент
|
при VК = const
|
Лекция № 13 Статические характеристики транзисторов
В.1 Схемы выключения
В.2 Соотношение Мола-Эберса
В.3 Статические характеристики транз. с общей базой
В.4 Стат. хар-ки транз. с общ. эмиттером.

Недостатки: худшие по сравнению со схемой с общей базой, плохие частотные и температурные свойства.
Особенность схемы с общим коллектором это то, что Vвын полностью передается обратно на вход. (т.е. сильная О.С.)
Коэффициент усиления близок к 1.
Эти схемы называются эмитерными повторителями.
Схема с общ. Б.- это меньшее искажение чем в схеме с общ. Э., хорошее t0, и частотные свойства, но слишком маленькое Rвх.

| Параметры | СхОЭ | ОБ | ОК |
| рис. 1.2 | рис. 1.1 | рис. 1.3 | |
| коэф. усил К1 = IК / IБ | 10 ~ 100 | < 1 | 10 ~ 100 |
| коэф. поглащ. К4 = Vвых / Vвх. | 10 ~ 100 | 10 ~ 100 | < 1 |
| Коэф. усил. по мощ. Кр= Рвых / Рвх. | 100 ~ 1000 | 10 ~ 100 | 10 ~ 100 |
| Коэф. Rвх Rвх = Vвх / Iвх | 1000 ~ 1к0м | 1 ~ 100м | 10 ~ 100кОм |
| R вых = Vвых / Iвых | 1 ~ 100кОм | 100кОм ~ 1Мах | 100 Ом ~ 1 кОм |
| Сдвиг фаз. м/у Vвых Vвх | 1800 | 00 | 00 |
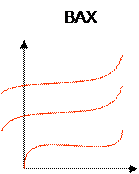
| 
| 
|
В.2 Схема соотношения Мяла- Эберса
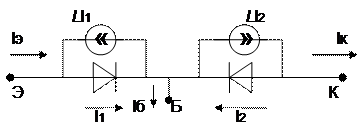
Тредистор представленв виде двух включенных встречно р-n- перехода, а их взаимодействие
отображается генераторами тока. Модель достаточно хорошо отражает обратимость структуры при нормальном анвертном включении и позволяет получить уравнения ВАХ близким к реальным.
Iэ = I ЭБК ( eхр VЭБ / VT – 1) – α IКБК (ехр VКБ / VТ -1)
IК = α IКБК (eхр VЭБ / VT – 1)- IКБК (ехр VКБ / VТ -1)
IБ = Iэ - IК
В.3
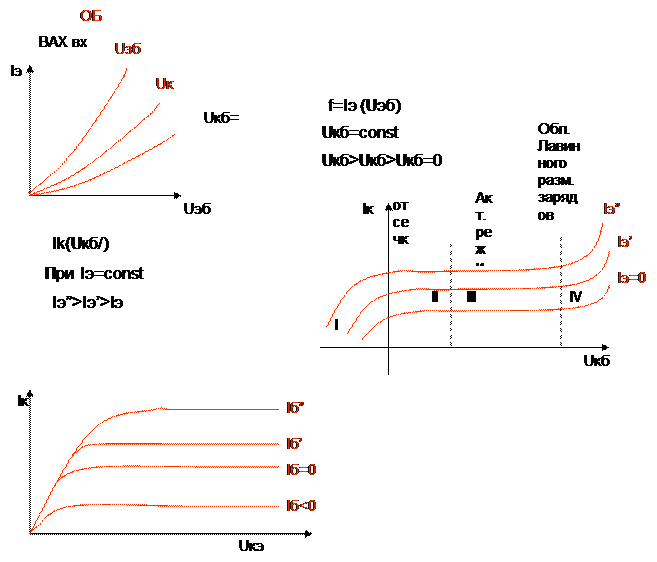
Лекция № 14. «Параметры транзисторов»
В.1 Виды параметров
В.2 Параметры малого и большого сигнала
В.3 Параметры по постоянному току
- собственные (первичные) (RЭ, Rб, RК, коэффициент усил. потоку)
- вторичные
К собственным относятся параметры которые характеризуют сам транзистор не зависимо от схемы включения.
К вторичным относятся параметры, которые зависят от схем включения.
Все сист. вторичные основываются на том, что транзистор является 4-х полюсник., то есть 2 входа и 2 выхода.
Вторичные параметры связывают вх. и вых. перемен. токи и напряжения, и справедливы только для маленьких амплитуд (малосигнальные, или низкочастотные параметры)
В настоящее время считаются смешенные (гибридные) основными.
Обозн.: h- и У- параметрами.
Среди них имеются 2 коэфициента (сопротивление и проводимость)
h- их удобно измерять
В.2

Система параметров, которая образуется при выборе функциональной связи носит название
У-параметров.
I1 (V1, V2)
I2 (V1, V2)
А параметры:
V1 (I1, V2)
I2 (I1, V2) h- параметры

1. Y11 = {входная проводимость}= б I0 /б V0 = d I1 / d V1
dV2 = 0, V2 = const
Вход. проводимость max при короткозамкнутой цепи.
Y11 опред. при ХЗ выхода и является обратной величиной
Rвх (h11) Y11 = 1 / h11 – вх. сопротивление
2. Проводимость обратной передачи (Y12)
Y12 = б I1 / б V2 = d I1 / d V2
dV1 = 0, V1 = const
Показано какое изменение IВХ получится за счет ОС при изменении VВЫХ на 1 В.
3. Прав-ть прямой передачи.
Y21 = б I2 / б V1 = d I2 / d V1
dV2 = 0, V2 = const
Характеризует управляющее действие VВХ на IВЫХ и показывает изменение IВЫХ при VВХ
изм. на 1В (от 10 / 100)
4. Выходная проводимость
Y22 = б I2 / б V2 = d I2 / d V2
dV1 = 0, V1 = const
Статический коэффициент усиливается μ = б V2 / б V1
Y22 = h21 / h11; μ = Y21 / Y22
I1 = Y11 V1 + Y12 V2
I2 = Y21 V1 + Y22 V2
Система h- параметров

1.Входное сопротивление h11
h11 = б V1 / б I1 = d V1 / d I1
dV2 = 0, V2 = const
h11 представляет собой сопротивление транзистора переменного IВХ при К3 на выходе и RH = 0
2. Коэффициент ОС по напряжению h12
h11 = б V1 / б V2 = d V1 / d V2
d I1 = 0 (I1 = const)
КОС показывает какая доля VВЫХ передается на вх. в следствии ОС при условии, что цепь разомкнута.
3. Коэффициент усиления по току h21 (коэффициент передачи тока)
h21 = б I 2 / б I 1 = d I 2 / d I 1
V2 = 0, V2 = const
Показывает усиление параметров тока транзистора в режиме работы без нагрузки.
4. Выходная проводимость h22
h22 = б I 2 / б V 2 = d I 2 / d V 2
d I1 = 0 (I1 = const)
Внутренняя поверхность для ~ I м/у выходными зонами транзистора, измеряется в Сименсах и RВЫХ = 1 / h22

τЭ ~ 10 Ом
τб ~ 100 Ом.
τК ~ 100 кОм – 1 1 МОм
| Параметры | ОЭ | ОБ |
| h11 | 100~1 кОм | 1 ~ 10 Ом |
| h12 | 10-3 ~ 10-4 | 10-3 ~ 10-4 |
| h21 | 10 ~ 100 | 0,95 ~ 0,998 |
| h22 | 1 ~ 10 кОм | 100 кОм ~ 1 МОм |
Параметры большого сигнала
Параметры БС характеризуют свойства транзистора в режиме когда в процессе изменения напряжения или тока параметры МС изменяются в широких пределах
- Статический коэффициент передачи тока
h21 Э = В = β0 = IК / Iб
- Крутизна (коэффициент прямой передачи)
Y21 Э = S = IК / VБЭ
В.3
Параметры по постоянному току определяют неуправляемость тока транзистора
(IКбК │ VЭБ = 0, IЭбК │ VКб = 0, IКбО │ IЭ = 0, IЭбО │ IК = 0, IКЭО │ Iб = 0, IЭКО │ Iб = 0)
Лекция 15. Тема Эквивалентная схема транзистора.
Делятся: - схемы замещения
- моделирующие (физические)
- смешанные (гибридные)
Смешанные схемы получаются как схемные отображения уравнений 4-х полюсника, каждая из которых содержит по 4 элемента, по числу параметров, 4-х полюсника. По своей природе является точными, параметры зависят от режима тр-ра и частоты сигнала затруднителен. Эти трудности удается избежать в схемах модулированных либо смешанных. Параметры определяются с помощью физической теории или экспериментальным исследованием. Они более просты и удобны для анализа. Чаще используются упрощенные физические схемы при которых учитываются лишь основные свойства транзистора и ограничением режима работы.
Возм. отображение тех или иных свойств транзистора имеет важное значение в конкретном случае применяют гибридные схемы (характ. совместным использованием параметров эквив. 4-х полюсника и параметры физических схем)
В.2 схема замещения

V транзистор может быть представлен схемой замещения с двумя генераторами.
Он опис. системой Y- параметров.
I1 =Y11 V1 + Y12 V2
I2 =Y21 V1 + Y22 V2
Более удобной схемой замещения является схема с одним зависимым генератором:
|

Схемы замещения с одним генератором могут быть –А- и -Т- образные и различными параметрами и способами включения. При использовании Y-параметров наиболее целесообразно использовать –П- образные схемы. В ней все параметры- это параметры эквивалентные 4-х полюсника.
Рассмотренная схема обычно используется при включении транзистора с ОЭ.
В.3
Эквивалентные схемы состоят на основе учета физических свойств транзистора или представлены в виде различных моделей так же могут иметь –П-Т- образную конфигурацию
Наиболее хорошо и полно отображаются физические свойства транзистора –Т- образная ЭВС схема, в которой используются физические параметры.

Активными элементами изобр.: сопротивление переходников
Влияние Vвх и Vвых определяется генератором тока.
Б- внутренняя база (отдельная от внешнего вывода базы сопротивление Rб)
Параметры представляются формулами:
τЭ = d V ЭБ / d I Э при V КБ = const (V К = 0)
τК = d V КБ / d I К при I Э = const (I Э = 0)
При включении транзистора с ОЭ часто используется следующая схема:

τЭ = d V БЭ / d I Б при V Б = const
τК = d V КЭ / d I К при I Б = const (I Б = 0)
Зав. от частоты т.к. в их выраж. входит частотнозависимый коэффициент передачи тока. с ростом частоты схемы усложняются, вводят новые элементы и т.д.
В.4
В практике расчет схем большое распространение получило смешанное –П- образная эквивалентная схема имеет несложную структуру и удовлетворяет описывающая свойства транзистора в высоких пределах частот (микрокомдиапазоне частот) в Этд схему включения ОЭ.
Смешанная –П- образная схема составляет:
в начале представляет собой 4-х полюсник, затем своершает переход к –П- образной схеме замещая 4-х полюсника и определяет параметры элементов этой схемы. Эта схема доп-ся еще барьерной емк. коллекторного перехода (диф. емкости не учитывается)

Знание эквивалентных схем транзисторов позволит мне в дальнейшем успешно освоить методы расчета функциональных узлов электронной точности.
Лекция № 16. Тема Частотные и шумовые свойства транзисторов.
В.1 Факторы ограничивающие использование транзисторов на ВЧ
В.2 Временные характеристики и параметры
В.3 Шумовые свойства и параметры транзисторов
При работе в схемах напряжение и токи транзистора изменяются во времени, что сказывается на физических процессах в них и на их свойствах и параметрах
С ростом частоты в биполярном транзисторе все параметры приобретают комплексные свойства, и это сказывается на усилении транзистора. (эффективность управления выходным током)
Основные факторы влияния:
- конечное время перемещения н/з в базе
- распределение емкости, индуктивности электрических выводов транзистора
- потери в диэлектриках
- поверхностный эффект
- потери на излучениях
В.2 Главные причины:
Эквивалентная схема с учетом емкостных переходов

- В следствии влияния емкости на К α и β- уменьшаются.
- Отставание по фазе ~ Iк от ~ Iэ оно вызвано инерционностью процесса перемещения н/з через базу от ЭП к КП, а так же инерционного процесса накопления и рассасывания н/з в базе. Их удобно рассматривать с помощью векторной диаграммы.

При повышении б коэффициент β уменьшается значит быстрее чем α. Коэффициент α уменьшается от влияния емкости на КП, а на β влияет еще и фазовый сдвиг между Iк и Iэ за счет времени пробега н/з. Ясно что схема с ОЭ- хуже чем с ОБ на высоких частотах.

Частота на которой │ β │ становится = 1 получила название граничная частота ƒгр. при ней транзистор перестает усиливать ток.
В.3 Работа транзисторов в импульсном режиме иначе называется ключевым или режимом переключения.
Пост. времени восстановления:
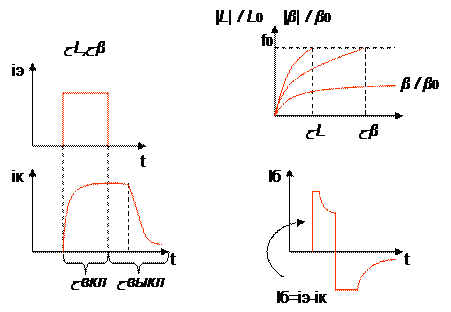
В транзисторе замедления процессы вкл. и выкл. коллекторной цепи, повышается время в течении которого эта цепь находится в замкнутом состоянии. За счет инерционных процессов накопления и рассасывания н/з а базе, транзистор не может осуществлять достаточно быстрое вкл. и выкл., не может обеспечить быстродействие в ключевом режиме. Специальные транзисторы должны иметь малые емкости и тонкую базу (это маломощные, дрейфовые транзисторы)
В примесь добавляют золото.
Шумовые свойства.
Основные источники шумов те же, что и в п/п транзисторах + шум I распределения.
- тепловые шумы
- дрововые шумы
- шумы I распределения
- рекомбинационные
|
Коэффициент шума он определяется через 4-х полюсник 2 ~ 10 дБл.
Он почти независим от схемы вкл., но зависит от частоты так же как в диодах.
Лекция № 17. Основы эксплуатации и применения транзисторов. Теристоры.
В.1 Максимально допустимые параметры, область безопасной работы
В.2 Усиливающий и ключевой режим работы
В.3 Влияние t0 и других факторов на работу транзисторов.
В.4 Теристоры
Параметры эл. режима- это: токи, V,P,опред. состояние эл/дырочного состава транзистора:
- максимально допустимый постоянный ток коллектора (Iк мах) он ограничивается максимально допустимой температурой коллекторного перехода
- максимально допустимый импульсный ток коллектора
- максимально допустимый VЭБ, он независим от схемы вкл. и определяется Эл. пробоем эмитерного перехода
- максимально допустимый VКБ, в схеме с ОБ определяется напряжением пробоя коллекторного перехода (5 ~ 500 В)
- максимально допустимый VКЭ в схемах с ОЭ опред. пробоем коллекторного перехода
- максимально допустимый Rк рассеивающая, зависит от температуры, она может быть повышена за счет теплоотвода.
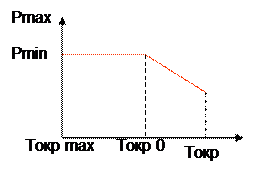
|
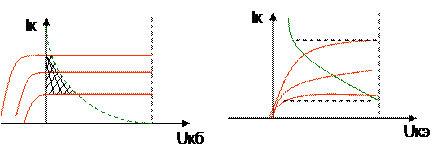
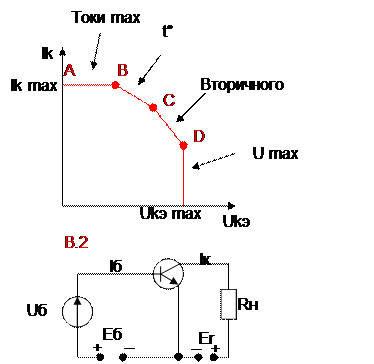
Принцип работы можно пояснить с помощью выходных характеристик.
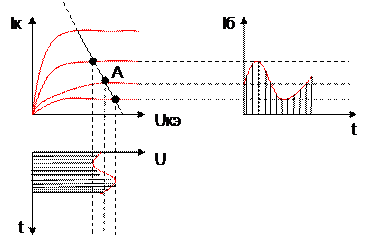
Ключевой режим- это режим в котором транзистор исп. для переключения эл. цепей
При работе РТ либо в области отсечки, либо в области носителя.

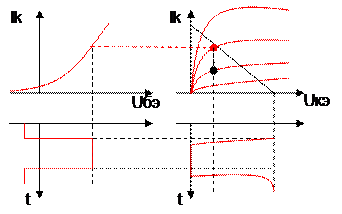
С целью обеспечения крутых фронтов имп. и малого времени задержки и рассасывания, транзисторы предназначенные для работы в ключевом режиме конструируются так же, как ВЧ транзисторы, то есть малая емкость перехода, малая ширина базы, малые размеры пассивных частей БО.
В.3 Влияние температуры и поврежденных факторов.
В.4 Тиристоры.
Это два транзистора объединенных вместе. Его основу составляет п/п структура с двумя уст. основаниями им. 3 и более «р-n»-перехода, который может переключить из закрытого состояния в открытое и наоборот (4-х слойные приборы с двумя выводами- диодные тиристоры или динисторы и с 3 выводами- триодные тиристоры или тринисторы)
Они находят применение в эл. ключах в запоминающем устройстве, генераторах, модуляторах, выпрямителях, и преобразователей тока различной формы.

То есть тринистр можно рассматривать как две встречно включенные структуры р-n-р и n-р-n
ВАХ показана на рис.

Тема № 6. Полевые транзисторы.
Лекция № 18 Полевые транзисторные структуры. Транзисторы с управляемым р-n- переходом.
В.1 Виды структур и дискретных транзисторов
В.2 Устройство и принцип действия транзистора с р-n- переходом.
В.3 Статические характеристики и параметры
В.4 Эквивалентные схемы.
|
Изгот. на основе полевых инт. м.схем и дискрет полевых тр-ов, они являются униполярными.
В качестве проводникового канала выступает слой п/п-ка сопротивление которого регулируется по средствам эл. поля которое создается с помощью расположенного над каналами электрич. изолир. от него Ме электрода называется затвором.

- изол. затвора осуществляется с упр. переходом (объед. слой перехода)
- с Ме- проводниковым затвором (МЕП-тр-ры, или тр-ры шотки) слой Ме- п/п
- с изолирующим затвором у которого канал изолируется слоем диэлектрика (МДП)
- Ме – диэлектрик- проводник
Различие ( в зависимости от типа проводника) р- и- n – каналы.
- Структуры бывают норм.-открытыми и норм.-закрытыми
В.2
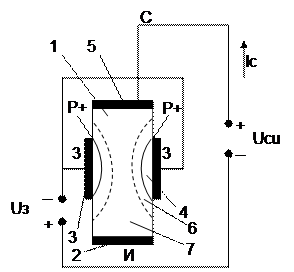
1. Основа транзистора (пластина из п/п- материала)
2. Исток-электрод
3. Затвор
4. Слой п/п-ка с проводимостью р-типа
5. Сток
6. Обл. простр. заряда
7. Проводящий канал (мах толщина 10 доли мкм)
Упр. электрод предназначен для регулирования 5-поперечными соч. канала наз затвором.
Электрод в который втекают осн. н/з наз. стоком [С]
Электрод из которого вытекают наз.истоком [И]
Физические процессы происходят следующим образом:
При изменении Vвх изм. Vобр. на р-n-переходе и от этого изм. ширина запирающего слоя соответственно этому меняется поп. сеч. области через которую проходит поток осн. н/з меняется Sпоп. сеч. то есть Iвых эта обл. наз. каналом.
Если повышается V на затворе, то запирающий слой становится толще и S уменьшается, тогда Сопр увеличивается и Iстоки уменьшается. при опред. Vзапир. Sсеч. = 0 и Iстока будет мал., тр-р заперт., а при Vзапир. = 0, Sсеч. = мах и Iстока = мах. то в П.тр. структуре им. возм. упр. Iстока, а значит существует возможность усиления по мощности.
Рассмотренная структура является норм.-открытой так как существует проводящий канал при Vзатворе = 0.
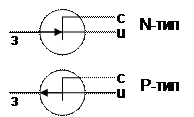
В.3 П. тр-ры могут подключаться 6-ю разными способами:
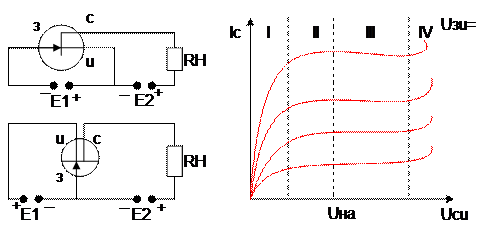
Характеристики прямой передачи.

I- амический режим
II- перекрытие канала
III- режим насыщения
IV- режим пробоя.
Параметры для оценки исп. следующие:
У-и Н- параметры
У- параметры- хорошо измеряются
1. Крутизна проводимости прямой передачи
У21 = S = d Ic / dVзи, при Vси = соnst
У22 = S = d Ic / dVcн, при Vзи = соnst
В режиме насыщ. проводимость равна 0
2. Статический коэффициент усиления по напряжению
μ = dVcн / dVзи при Ic = соnst
μ = SR = У21 / У22
3. Диф. Rвход
τ11 = dVзи / d Iз при Vси = соnst
У12 = d Iз / dVзи при Vси = соnst
Усил. совйства тр-ой структуры реализуются при работе в режиме насыщения, в амическом режиме значение всех параметров существенно уменьшаются.
В.4
Могут быть представлены:

Особенности:
- гранич частота выше и им. порядки 100МГц (отсутствие перезаряда диф. емкости)
- отсутствие токов выходной цепи
- повышенная температурная устойчивость (созд. токи обусл. одним видом н/з)
- лучшие шумовые свойства ( в виду отсутствия рекомбинации н/з)
- повышенная радиационная стойкость
- универсальность применения
2П103А- полевой кремниевый тр-р
Рмах= 120 мВт
крутизна= 2 млА/В
2П302А- тр-р, кремневый с каналом n-типа, нач. сток. 24 млА

Лекция № 19 «Полевые транзисторные структуры и транзисторы с изолированным затвором»
В.1 Основные виды структуры
В.2 Назначение, устройство и принцип действия тр-ра с изолирующим затвором
В.3 Статич ВАХ полевых тр-ров
В.4 Параметры и эквивалентная схема тр-ра. Транзистор со встроенным каналом.
В.5 Особенности эксплуатации.
|

Изоляция затвора осуществляется по средствам изоляционного слоя (их еще наз. МДП- тр-ры)
Если в качестве диэл/слоя выступает какой нибудь оксид, они наз. МОП (Ме- оксид/п-п)
В зависимости от способа формирования проводящего канала они подразделяются на:
тр-ры с ингуированными каналами и со встроенными каналами, они бывают –n- и –р- типа. МДП относятся к обогащенному типу.
Транзисторы МДП стр. со встроенным каналом работают в режиме объединения н/з.
Канал n-типа
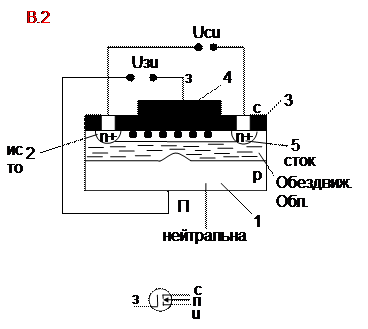
1- пластина примесного п/п-ка р-типа (там осн. н/з-дырка) П-подложка
2,5- две сильно лигированные области с проводимостью n+-типа
3- слой диэлектрика (от 0,2 мкм)
4- пленка Ме (затвор)
Подложку еще называют нижним затвором
Принцип действия МДП тр-ра с инд. каналом основан на эффекте поля- изменение концентрации подвижных н/з в п/п-ке под действием магнитного поля
Проводящий канал образуется при поверхностной обл. подложки, под затвором подвижного н/з
Принцип работы: Если нет V опред. полярности на затворе- канала нет. Если подать «+» напряжение на затвор, тогда под действием поля затвора ē проводимости будут перемещаться к затвору. Когда Vбудет > Vпор., тогда концентрация ē повысится и будет больше концентрации ниток, то произойдет инверсия эл./пров., то есть образуется тонкий канал n-типа и тр-р начнет проводить ток, чем больше «+» V на затворе тем выше проводимость канала и выше Iстока
То тр-р может работать только в режиме обогащения
Эфф. мод. длины канала, при этом наст. насыщ Iu
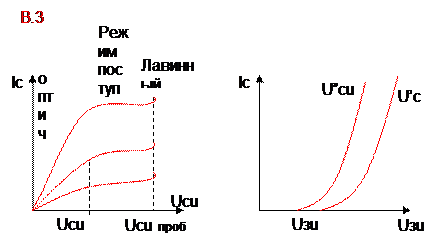
Для оценки усил. св-ва МДП тр-ров и при расчете схем (У-параметры):
крутизна
диф. исчисл.
вых. пров.
Эквивалентная схема:

В.4 ПТ со встр. каналом может работать в режиме насыщ. и др. С этой целью между V и S созд. тонкий пов-тнский канал.
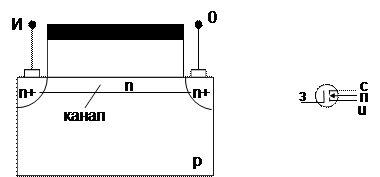
Подведение «-» V к затвору приводит к объединению канала при полож. Io велич. Ic можно управлять как в помх и др. Ic им можно упр.
Если при нулевом напр. на затворе проложить м/у стоком и истоком, тогда через канал потечет ток, а через кристалл нет. Т.к. один из р-n- переход будет находиться под обратным напряжением.
|
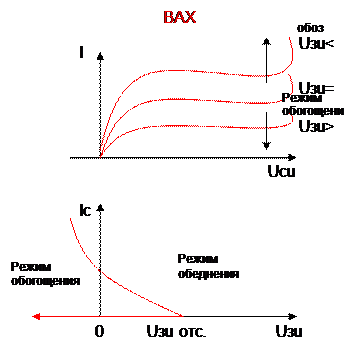
Лекция № 20 Основы эксплуатации и применения ПТ.
В.1 Максимально допустимые параметры полевых тр-ров. Обл. безопасных реж. работы
В.2 Усил. режим работы
В.3 Влияние температуры и поврежд. факторов на работу ПТ.
Макс. допустимая Iстока, огранич. макс доп. температурой структуры, Макс. доп. V характеризуется макс. доп. V ст. истока.
В ПТ с упр. ē- дырочным перех. указ. Vопред. Vэл.пробоя
В МДП – лавинным пробоем
Рмах явл. важным энергетическим показателем опред. температуру состояния тр-ра и характеризует температурным разогревом структуры и не должна превышать макс. доп. уровня. Мощный тр-р исп. теплоотводы.
Следовательно температура окружающей среды хар-ся отводом тепла.
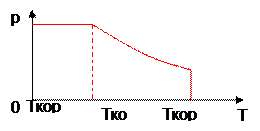
В.2
В ПТ с упр. переходом обл. безоп.. работы (ОБР) огран. сверху Ic насыщ.

Пи переходе МДП в имп. режим ОБР расширяется. С уменьш. длит. имп. ОБР так же расширяется.
Усилит. режим работы тр-ра

Осн. параметры:
-Крутизна S= d Ic / dVзи
- Динамический коэф. усил. Кd = dVR / d Vзи Rн = const
- Pн = 0,5 d Ic * d V RH = 0,5 d Ic * d VCH
В.3 У ПТ с упр. структ. переходом изм. температуры приводит к изм. Конт. разности потенциалов.
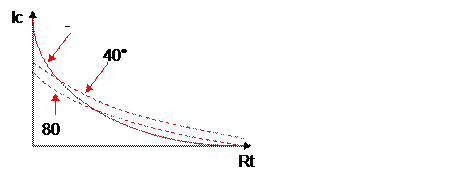
При опред. усл. действие этих факторов может взаимно компенсироваться, I не зав. от температуры, её назв. термостабильной точкой.
Тема № 7 Транзисторы интегральных схем.
В.1 Виды инт. схем
В.2 Биполярные тр-рные элементы интегральных схем
В.3 Полевые тр-рные эл-ты инт. схем.
Все созд. на основе микроэлектроники- это инт. схемы или микросхемы.
Инт. они наз. т.к., вас. эл-ты или части их и соединения м/у ними нераздельно связаны и схема рассм, как единое целое.
Основные типы:
- пленочные ( в кот. эл-ты выполн. в виде различных пленок) на подложке из диэлектрика
- п/п-ые ( эл-ты выпол. внутри и на пов-ти п/п-ой подложки)
- гибридные (эл-ты) дискретные диоды, тр-ры, они наз. компонентами) подразд. по числу ком-ов и степени интеграции:
- простые
- средние 10 ~ 100
- большие (БИС) 100 ~ 1000
- сверхбольшие 1000 ~ …..
Подраздел. по характеру выполнения функций:
- цифровые (триггеры, шафраторы) работают в имп. режиме
- аналоговые (раб. в таких режимах, когда изм. I или V)
В.2
В п/п-ых инт. схемах все элементы выполнены внутри и на поверхности подложки
Им. наиболее большое число элементов в ед. V и высокую надежность
Более плохое качество пассивных элементов невозможно создать катушки индуктивности
Изоляция
Прим. несколько способов изоляции:
1. С помощью р-n-перехода, метод диффузии

2. Изол. диэлектрическим слоем (м/у карманом и кристаллом им. тонкий слой диэлектроика)
3. Изол. кремний на саперире
4. Комбинированный (изопленарная технология) SiO2
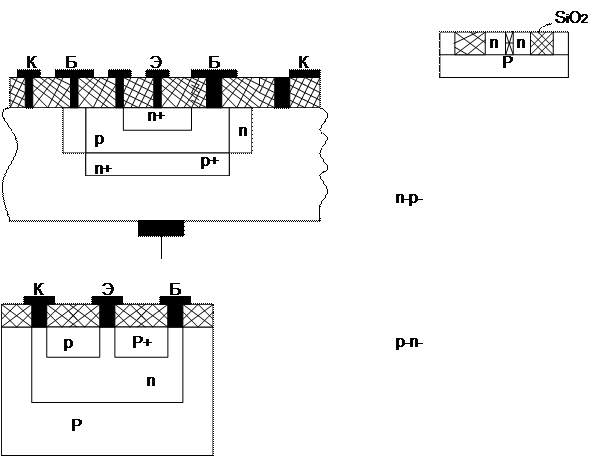
Пара Дайрлингтона.

Тр-ры с барьером Шотки.


Б-Э исп. для стабилизации напряжения
Б-ЭК время переключения до 100 мс.
т.е. мы знаем, что тр-ры можно исп. в роли стабилитронов и т.д.
В.3 На одгом кристалле могут исп. вместе с биполяр и полевые тр-ры
В инт. микросхемах прим. комплементарные тр-ры. Отличаются малым потреблением тока и высоким быстродействием. Примером исп. КМОП слкжит инвертор прим. в различных цифровых логических устройствах. Стоки соед. вместе и явл. выходом (схема может находится в одном из уст. состояний)
Диффузные рез-ры.
ПШНЧ- рез-ры на основе МОП.
Создание индуктивности

Тема Активные компоненты инт. схем
В.1 Общие сведения (стр. 150-157)
В.2 Элементы памяти на МДП тр-ых элементах (стр. 164-165)
В.3 Приборы с зарядной связью (стр. 165-172)
В.1 Виды ИС.
Интегральные микросхемы – это микроэл-ые изделия выполняющие опред. функции преобразования, обработки сигнала и (или) накопление информации и имеющие высокую плотность упаковки электрических соедин. элементов, которые с точки зрения требований к испытаниям, приемке и эксплуатации рассматриваются как целое.
По конструктивно- технологическому признаку: интегральные микросхемы могут быть полупроводниковыми, пленочными, гибридными и совмещенными.
Полупроводниковых ИС. изгот. на одной полупровод. подложке путем применения методов локальной диффузии легарующих примесей в монокристаллический п/п-к. Они содерж. м/у собой неотделимые друг от друга активные и пассивные эл-ты, выпол. на основе панарных тр-ных структур внутри и на пов-ти подложки.
В пленочном ИС все эл-ты и их соединения выполнены только в виде пленок, нанес путем вакуумного напыления через спец. теневые маски и др. методов. Их недостатком явл. значительная нестабильность параметров акт/элементов.
К гибридным ИС относятся ИС, содержащие так же еще и сложные компоненты (кристаллы п/п ИС) . Устройства на их основе вследствии высокого качества акт. и пассив. эл-тов имеют лучшие характеристики по сравнению с аналогичными устройствами на п/п-ых ИС.
Делятся по характеру выполнения функций:
- цифровые
- аналоговые
По роду и виду выполняемых функций
- усилители (УНИ, УВЧ)
- преобразователи (фазы и др)
- и т.д.
В.2
Среди полевых ТЭ особое место занимают МОП-структуры, исп. в микросхемах ПЗУ. в частности в устройствах Флеш-памяти. На их основе выполняются запоминающие элементы с длительно ( до 10 лет неразрушаемой энергозависимой памятью, которых в соответствии с записанным в них информации. зарядом имеют малое или большое сопротивление при подаче на управ-ий затвор одинакового напряжения.
К ним в первую очередь относятся МНОП ТЭ(Ме-нитрид-оксел-п/п-к)
и МОПТЭ с плавающим затвором
МНОПТЭ в качестве подзатворного диэл. исп. двухслойное покрытие сост. изх тонкого (< 5 нм) SiG2 и толстого (≈ 100 нм) слоя нитрида кремния SiNi4
В основном их работы лежат процессы накопления носителей заряда в слое SiNi4
В. 3
Структура и принцип действия.
ПЗС- п/п-ый прибор, в котором осущ. накопление неосновных носителей заряда в виде пакетов под электродами затворов МДП-структур и направленных перемещ. этих пакетов от одного электрода к другому. ПЗС относ. к приборам функциональной электроники.
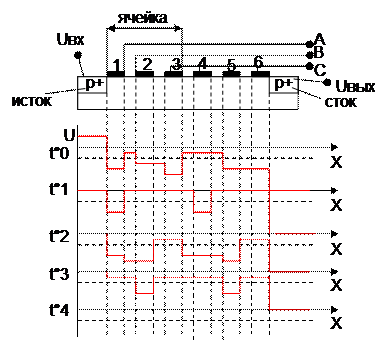
Устройство ввода зарядовых пакетов состоит из истоковой обл. с проводимостью р-+ типа, образ с подложкой р-n переход Оно вкл. в себя p-n- переход располож в стоковой обл. прибора.
Принцип действия основан на создании с помощью МДП- структур потенциального рельефа у поверхности подложки, введении в образовавшийся под затвором потенциал ямы зарядовых пакетов и направл. перемещ-ки зарядовых пакетов вдоль поверхности подложки путем последовательного перемещения потенциальных ям.
Зарядовая связь МДП – структур обеспеч общностью п/п-ой подложки и сравнительно малый рост м/у структурами
В процессе работы МДП-структур подвод. импульсы «-» управ-его напряж. при котором осн./н/з (ē) дрейфуя вглубь подложки, образует в припов-ом слое под затвором обслед. обл.
| <== предыдущая лекция | | | следующая лекция ==> |
| Электропроводность полупроводников с позиции зонной теории твердого тела. | | | Виды и сроки осмотра и ремонта вагонов |
Дата добавления: 2015-12-16; просмотров: 1639;
