Частотные свойства биполярных транзисторов
3.8.1. Особенности работы транзисторов на высоких частотах
С увеличением частоты усилительные свойства транзисторов ухудшаются. Причины, которые приводят к этому, следующие:
1. Влияние конечного времени пролета носителей через область базы от эмиттерного перехода к коллекторному.
2. Влияние емкостей эммитерного и коллекторного переходов.
3. Влияние объемного сопротивления базы, связанное с ее геометрическими размерами.
На высоких частотах среднее время перемещения неосновных носителей в базе становится сравнительным с периодом усиливаемого сигнала. Инжектированные в область базы носители не успевают дойти до коллекторного перехода, как полярность входного напряжения изменяется на противоположную. Часть носителей тормозится и рекомбинирует в базе, другая часть – уменьшает свою скорость и доходит до коллекторного перехода с некоторым запаздыванием относительно входного сигнала, в результате чего коэффициент усиления по току падает. Это явление получило название дисперсии скоростей носителей. Таким образом, уменьшается не только коэффициент усиления транзистора, но изменяется форма выходного сигнала. Коэффициент передачи по току становится комплексной величиной и определяется выражениями:
 (3.37)
(3.37)
 , (3.38)
, (3.38)
где − fα и fβ − предельные частоты усиления, по току в схеме с общей базой и общим эмиттером соответственно.
Предельной частотой усиления транзистора называется частота, на которой модуль коэффициента передачи по току уменьшается в  раз или на
раз или на
3 дБ по сравнению с его величиной на низкой частоте.
Фазовые сдвиги между токами в транзисторе можно пояснить с помощью временной диаграммы (рис. 3.10).

Рис. 3.10


 (3.39)
(3.39)
Токи в транзисторе определяются векторной суммой
 (3.40)
(3.40)
Так как  , предельная частота для схемы включения транзистора с общей базой намного выше, чем в схеме с общим эмиттером.
, предельная частота для схемы включения транзистора с общей базой намного выше, чем в схеме с общим эмиттером.
Связь между предельными частотами для схем с ОБ и ОЭ определяется следующим выражением:
 ,
,
где m = (1,1…2) .
На рис. 3.11 показана зависимость частотных параметров для транзистора с fα = 1 МГц.


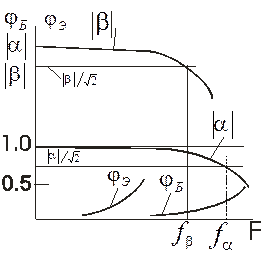
Рис. 3.11
В некоторых случаях при проведении расчетов пользуются граничной частотой fгр, на которой коэффициент передачи по току в схеме с общим эммитером становится равным единице  .
.
Наиболее важным обобщающим частотным параметром является максимальная частота генерирования, или максимальная частота усиления по мощности, т.е. частота на которой коэффициент усиления по мощности становится равным единице (Кр = 1)

 (3.41)
(3.41)
где  – объемное сопротивление базы;
– объемное сопротивление базы;
 – Емкость коллекторного перехода.
– Емкость коллекторного перехода.
Влияние емкости эмиттерного перехода можно пояснить с помощью схемы входной цепи рис. 3.12.

Рис. 3.12

 (3.42)
(3.42)

 – диффузионное сопротивление базы, связанное с воздействием коллекторного напряжения.
– диффузионное сопротивление базы, связанное с воздействием коллекторного напряжения.
С ростом частоты шунтирующее действие емкости эммитерного перехода возрастает, что приводит к уменьшению управляющего напряжения и снижению инжекции носителей из эмиттера, т.е. к падению коэффициента передачи по току.
Для расчетов на высоких частотах можно пользоваться эквивалентной схемой Джиаколетто с генератором тока (рис. 3.13):

Рис. 3.13
В данной схеме  ,
, 
 ,
,
 ,
,  .
.
Эта схема дает удовлетворительные результаты до частот около 0,5fα.
Для схемы включения с общей базой можно пренебречь рядом паразитных параметров, и эквивалентная схема будет иметь вид рис. 3.14.
Она называется T- образная эквивалентная схема замещения транзистора.

Рис. 3.14
В этой схеме отсутствует емкость эмиттерного перехода, так как в большинстве случаев на частотных свойствах раньше сказывается влияние емкости коллекторного перехода.
Таким образом, для улучшения частотных свойств транзисторов необходимо уменьшать толщину базы и ее сопротивление, снижать емкость эмиттерного и коллекторного переходов, а также применять специальные технологические методы при их изготовлении.
3.8.2. Разновидности биполярных транзисторов
Наиболее простым способом изготовления транзисторов является метод вплавления примесей. Для их получения берется исходный полупроводниковый материал p- или n- типа и с обеих сторон вплавляются донорные или акцепторные навески. Например, для изготовления p-n-p транзистора можно взять исходную полупроводниковую пластину германия n-типа и вплавить индиевые навески, после чего получаются две р-области: эмиттерная и коллекторная и соответствующие им электронно- дырочные переходы
(рис. 3.15).

Рис. 3.15
Однако при током способе переходы получаются нерезкими и неровными, а толщина базы на многих участках значительно отличается от средней. Такие транзисторы предназначены для работы на низких и не очень высоких частотах.
Дрейфовые транзисторы
Для работы на высоких частотах используются другие технологические принципы, позволяющие получить неравномерный профиль легирования базовой области: концентрация примесей уменьшается в направлении от эмиттерного перехода к коллекторному. Примерное распределение примесей в структуре такого транзистора приведено на рис. 3.16.

Рис. 3.16
Неравномерность распределения концентрации носителей в базе приводит к появлению внутреннего поля. Поэтому наряду с диффузионным движением носителей, инжектируемых в базу, наблюдается и дрейфовое под воздействием этого поля, что значительно увеличивает их скорость. Таким образом, частотные свойства этих транзисторов значительно улучшаются. Такие транзисторы получили название дрейфовых, имеется множество технологических способов их изготовления.
Диффузионно-сплавные транзисторы сочетают сплавление основного материала полупроводника с легирующими веществами и их диффузию с жидкой или газообразной фазы.
Для изготовления данных транзисторов основой служит пластина p-германия, которая используется как коллектор. В исходной пластине делается углубление, в которое происходит наплавление сурьмы, диффундирующей вглубь германия и образующей тонкий слой n-германия. После этого этот слой стравливается по всей поверхности, кроме углубления, и осуществляется вплавление двух навесок – базовой и эмиттерной (рис. 3.17).

Рис. 3.17
Базовая навеска представляет собой сплав сурьмы и свинца, эмиттерная – сплав Au-Ga-Sb-In. Поскольку скорость диффузии сурьмы наибольшая, то ее атомы проникают глубже, и толщина базы делается равной нескольким микронам, а концентрация носителей у эмиттерного перехода увеличивается. При вплавлении эмиттерной навески сплав Au-Ga-In образует эмиттерную область p-типа. На нижнюю часть исходной пластины наносят контактный слой из свинца, меди и индия.
Еще одной разновидностью дрейфовых транзисторов являются конверсионные. Они используют метод изготовления, описанный выше, только здесь диффузия происходит из исходной пластины германия, содержащей примеси n - и p -типа (рис. 3.18).

Рис. 3.18
Примесью p-типа является медь, которая характеризуется очень высоким коэффициентом диффузии в германий. При вплавлении медь диффундирует в эмиттерную навеску, образуя область эмиттера p-типа, а сурьма – из эмиттерной навески в область базы. Таким образом, получается база n-типа с неравномерным профилем легирования. Обеднение исходной пластины примесями одного типа и образования слоя другого типа проводимости в результате диффузии называют конверсией.
Особенностью меза-транзисторов является уменьшение площади коллекторного перехода и его емкости, а также уменьшение объема области базы. Основные этапы изготовления таких транзисторов показаны на рис. 3.19, а, б, в.
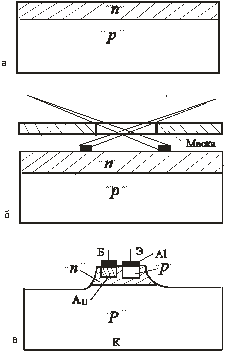
Рис. 3.19
Например, в пластину p-типа, служащую в дальнейшем областью коллектора, диффузионным путем вносят примесь n- типа, являющеюся базовой областью. Затем через одно и то же отверстие маски, но под разными углами напыляются контактные площадки. После этого материал площадок вплавляется, образуется омический контакт с областью базы и p-слой эмиттера. Активные части области базы покрываются защитным слоем, а пассивные стравливаются, что приводит к уменьшению площади коллекторного перехода. Меза-транзистор обладает хорошим теплоотводом и может быть мощным, а рабочая частота достигает диапазона сверхвысоких частот.
Еще одной разновидностью дрейфовых транзисторов являются планарные, название которых связано с расположением внешних границ p-n-переходов в одной плоскости. Исходная полупроводниковая пластина n-кремния покрывается окисью SiO2. Затем на этот окисел наносится светочувствительный слой – фоторезист, который засвечивается через маску. Затем осуществляется процесс травления: засвеченные участки не протравливаются, и под ними остается слой окисла, а незасвеченные удаляются. Таким образом, на пластине можно получить участок, служащий для внедрения примесей. На свободный участок методом диффузии вносят базовый слой p-типа. После этого описанные выше технологические приемы повторяют и получают эмиттер n-типа. В результате внешние границы p-n-переходов и областей транзистора оказываются защищенными окисью кремния, а база имеет неравномерный профиль легирования. Структура такого транзистора изображена на рис. 3.20.

Рис. 3.20
Эпитаксиальная технология позволяет также получить высокочастотный транзистор (рис. 3.21).

Рис. 3.21
Из паровой фазы выращивается тонкий слой монокристалла полупроводника между коллекторной и базовой областью. Это приводит к уменьшению вероятности пробоя транзистора, увеличению его рабочих напряжений и уменьшению емкости коллекторного перехода. У эпитаксиальных транзисторов предельная рабочая частота может достигать тысячи мегагерц.
Дата добавления: 2015-05-13; просмотров: 6787;
