Транзисторы с барьером Шоттки.
Биполярный транзистор в цифровых ИС обычно выполняет функцию ключа и всё время работает либо в режиме насыщения, либо в режиме отсечки. В режиме насыщения происходит накопление неосновных носителей заряда в базе транзистора, а также в коллекторной области. Процессы накопления неосновных носителей и их последующего рассасывания при переводе транзистора в режим отсечки или в выключенное состояние связаны с относительно медленным процессом диффузии неосновных носителей заряда. Инерционность этих процессов определяет скорость переключения транзистора из включённого состояния в выключенное и обратно, т.е. скорость срабатывания схемы.
Для ускорения процесса накопления и рассасывания неосновных носителей заряда целесообразно ограничить их накопление. Достичь этого можно путём шунтирования коллекторного перехода транзистора диодом Шоттки, т.е. диодом с выпрямляющим переходом между металлом и полупроводником. Структура такого интегрального транзистора и его эквивалентная схема показаны на рис.3.11.
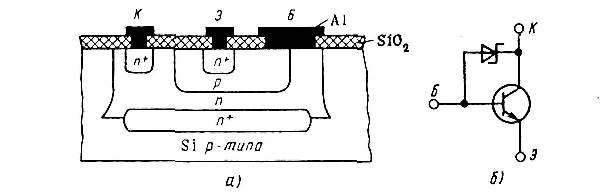
Рис.3.11. Структура транзистора с диодом Шоттки (а) и его эквивалентная схема(б)
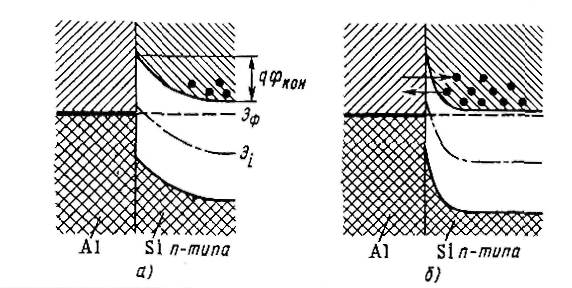
Рис.3.12.Энергетические диаграммы:
а- выпрямляющего перехода между алюминиевым электродом и высокоомной n-областью коллектора; б- омического перехода между алюминиевым электродом и сильнолегированной n+ -областью эмиттера кремниевого транзистора
-33-
Алюминиевый электрод образует с p-областью базы омический контакт, а переход между алюминиевым электродом и относительно высокоомной n-областью получается выпрямляющим. Из-за неравенства работ выхода электронов из алюминия и из кремния с электропроводностью n-типа и в результате химической обработки поверхности кремниевого кристалла на контакте для электронов возникает потенциальный барьер высотой около 0,6эВ (рис.3.12а), что несколько меньше высоты потенциального барьера на коллекторном переходе. Поэтому при прямом смещении коллекторного перехода и соответственно при прямом смещении диода Шоттки основная часть прямого тока коллектора будет проходить через диод Шоттки. Этот ток связан с движением электронов из n-области коллектора в металлический электрод и не сопровождается инжекцией дырок в n- область коллектора. Таким образом, в высокоомной области коллектора практически не происходит накопления неосновных носителей заряда. Кроме того, из-за меньшей высоты потенциального барьера на барьере Шоттки по сравнению с высотой потенциального барьера на коллекторном переходе при тех же прямых токах коллектора на коллекторном переходе будет меньшее прямое напряжение, что соответствует меньшему количеству накопленных неосновных носителей заряда в базе транзистора при режиме насыщения (рис.3.13). В результате время рассасывания в транзисторе с диодом Шоттки оказывается значительно меньшим (несколько наносекунд), чем время рассасывания в транзисторе аналогичной структуры, но без шунтирующего диода Шоттки.

Рис.3.13. Распределение концентрации неосновных носителей заряда в различных областях транзистора при его работе в режиме насыщения:
а - в структуре обычного планарного транзистора;
б - в структуре аналогичного транзистора с диодом Шоттки, включённым параллельно коллекторному переходу
На контакте алюминиевых электродов с сильнолегированными n+ - областями эмиттера и коллектора также могут возникать потенциальные
-34-
барьеры, но их толщина оказывается настолько малой, что сквозь такие узкие потенциальные барьеры электроны могут проходить практически беспрепятственно путём туннелирования (рис.3.12б). Таким образом, на контактах алюминиевых электродов с эмиттерной областью и с сильнолегированной частью коллекторной области получаются омические контакты, а их формирование и формирование выпрямляющего контакта Шоттки осуществляется во время одного процесса металлизации.
Изготовление интегрального транзистора с диодом Шоттки не требует введения дополнительных технологических операций. Необходимо лишь изменить соответствующим образом фотошаблон, применяемый при проведении фотолитографии для снятия диоксида кремния под контакты, и расширить слой напыляемого алюминия за металлургическую границу коллекторного перехода. При снятии диоксида кремния в месте выхода коллекторного перехода на поверхность монокристалла кремния и при обработке этой поверхности перед нанесением алюминиевой металлизации следует предотвратить возможность загрязнения pn-перехода коллектора неконтролируемыми примесями.
Структурное решение, показанное на рис.3.11, можно использовать не только в простейшем транзисторе, но и в МЭТ. В обоих случаях отсутствуют накопление и рассасывание избыточных зарядов и получается существенный (в 1,5-2раза) выигрыш во времени переключения транзисторов из полностью открытого в запертое состояние.
Дата добавления: 2016-04-02; просмотров: 3448;
