Биполярный транзистор. Биполярный транзистор изготавливается по эпитаксиально-планарной технологии, что и определяет его конструкцию и параметры
Биполярный транзистор изготавливается по эпитаксиально-планарной технологии, что и определяет его конструкцию и параметры. Структура биполярного транзистора и распределение примесей в его областях представлены на рис. 112. Транзистор содержит следующие слои: эмиттерный, базовый, коллекторный (эпитаксиальный), а также скрытый высоколегированный. Все эти слои изготавливаются на исходном высокоомном основании полупроводникового материала, обычно кремния. Удельное объемное сопротивление подложки должно быть большим (1 – 10 Ом×см), чтобы обеспечить получение высокого пробивного напряжения перехода коллектор - подложка и малую барьерную емкость. Толщину подложки выбирают достаточно большой (0,25 - 0,4 мм), чтобы она выдержала механические нагрузки в процессе обработки.
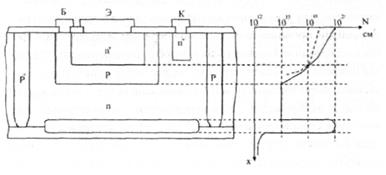
Рисунок 112 – Структура биполярного транзистора
Уровень легирования эпитаксиального п-слоя выбирают исходя из противоречивых требований: для получения высокого пробивного напряжения и малой емкости перехода коллектор - база уровень легирования должен быть низким, а для получения низкого последовательного сопротивления коллекторной области — высоким. В большинстве случаев удельное сопротивление эпитаксиального слоя составляет 0,1 -0,5 Ом×см, а его толщина изменяется в пределах от 2,5 до 10 мкм. Использование тонких эпитаксиальных слоев (до 3 мкм) позволяет существенно уменьшить паразитные емкости и тем самым увеличить плотность размещения элементов и повысить минимальную рабочую частоту ИМС.
Последовательное сопротивление коллекторной области транзистора регулируется путем введения в его структуру скрытого n+-слоя с концентрацией примеси 1021 см-3. В области коллектора, где формируется омический контакт, проводится диффузия донорной примеси для образования n+-области. Этим обеспечивается предотвращение инверсии слаболегированного эпитаксиального слоя, так как алюминий, используемый при выполнении омического контакта, является акцептором. В структуре со скрытым высоколегированным слоем последовательное сопротивление коллекторной области составляет обычно 10-50 Ом.
Уровни легирования эмиттерной и базовой областей также выбирают с учетом нескольких противоречивых требований. В частности, для увеличения коэффициента инжекции эмиттера и повышения пробивного напряжения перехода эмиттер - база уровень легирования базовой области необходимо понижать. Однако это привело бы к недопустимому возрастанию паразитного омического сопротивления между базовым контактом и активной областью базы. Кроме того, если поверхностная концентрация базового слоя становится менее 5×1016см-3, то на поверхности этого слоя возможно образование инверсной n-области, наводимой некомпенсированным положительным неподвижным зарядом, локализованным в покрывающем поверхность слое оксида. В результате между коллекторной и эмиттерной областями по поверхности может возникнуть проводящий слой. Увеличение уровня легирования эмиттера требуется для получения более высокого коэффициента инжекции. Но при очень высоких уровнях легирования, близких к пределу растворимости соответствующей примеси в кремнии (до 1021 см-3), возникают искажения структуры кристаллической решетки, что в свою очередь вызывает уменьшение времени жизни неосновных носителей заряда в эмиттере и, следовательно, уменьшение коэффициента инжекции.
Кроме того, известно, что плотность тока связи транзистора при заданном смешении обратно пропорциональна числу Гуммеля, т.е. полному количеству примеси в базе. Чем меньше встроенный заряд базы, тем больше ток при заданном напряжении смещения. Следовательно, можно сделать вывод, что для транзистора целесообразно делать базовую область с низкой постоянной примесной концентрацией. Основной недостаток такой структуры в том, что даже при небольшом прямом смещении вблизи эмиттерного перехода транзистора нарушается приближение низкого уровня инжекции, что ухудшает его рабочие характеристики. Этого следует избегать, поэтому получить малый заряд базы можно, сделав примесный профиль базы спадающим и расположив максимум примесной концентрации вблизи эмиттерного перехода.
Дата добавления: 2015-06-27; просмотров: 1941;
