Эпитаксия
Эпитаксиейназывают процесс наращивания монокристаллических слоев на подложку, при котором кристаллографическая ориентация наращиваемого слоя повторяет кристаллографическую ориентацию подложки.
В настоящее время эпитаксия обычно используется для получения тонких рабочих слоев до 15 мкм однородного полупроводника на сравнительно толстой подложке, играющей роль несущей конструкции.
Типовой - хлоридный процесс эпитаксии применительно к кремнию состоит в следующем (рисунок 3.1). Монокристаллические кремниевые пластины загружают в тигель «лодочку» и помещают в кварцевую трубу. Через трубу пропускают поток водорода, содержащий небольшую примесь тетрахлорида кремния SiCl4. При высокой температуре (около 1200° С) на поверхности пластин происходит реакция SiCl4 + 2Н2 = Si + 4HC1.
В результате реакции на подложке постепенно осаждается слой чистого
кремния, а пары HCl уносятся потоком водорода. Эпитаксиальный слой осажденного кремния монокристалличен и имеет ту же кристаллографическую ориентацию, что и подложка. Химическая реакция, благодаря подбору температуры, происходит только на поверхности пластины, а не в окружающем пространстве.
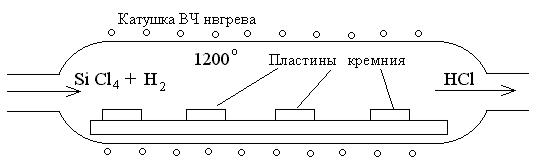
Рисунок 3.1
Процесс, проходящий в потоке газа, называют газотранспортной реакцией,аосновной газ (в данном случае водород), переносящий примесь в зону реакции, - газом-носителем.
Если к парам тетрахлорида кремния добавить пары соединений фосфора (РН3) или бора (В2Н6) , то эпитаксиальный слой будет иметь уже не собственную, а соответственно электронную или дырочную проводимость (рисунок 3.2а), поскольку в ходе реакции в осаждающийся кремний будут внедряться донорные атомы фосфора или акцепторные атомы бора.
Таким образом, эпитаксия позволяет выращивать на подложке монокрис- таллические слои любого типа проводимости и любого удельного сопротив- ления, обладающие любым типом и величиной проводимости, например, на рисунке 3.2а показан слой n, а можно сформировать слой n+ или р+.
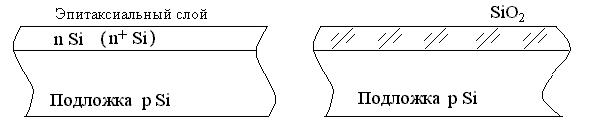
| а) | б) |
Рисунок 3.2
Граница между эпитаксиальным слоем и подложкой не получается идеально резкой, так как примеси в процессе эпитаксии частично диффундируют из одного слоя в другой. Это обстоятельство затрудняет создание сверхтонких (менее 1 мкм) и многослойных эпитаксиальных структур. Основную роль, в настоящее время, играет однослойная эпитаксия. Она существенно пополнила арсенал полупроводниковой технологии; получение таких тонких однородных слоев (1 - 10 мкм), какие обеспечивает эпитаксия, невозможно иными средствами.
На рисунке 3.2а и последующих масштаб по вертикали не соблюдается.
В установке, показанной на рисунке 3.1, предусмотрены некоторые дополнительные операции: продувка трубы азотом и неглубокое травление поверхности кремния в парах НСl (с целью очистки). Эти операции проводятся до начала основных.
Эпитаксиальная пленка может отличаться от подложки по химическому составу. Способ получения таких пленок называют гетероэпитаксией,в отличие от гомоэпитаксии,описанной выше. Конечно, при гетероэпитаксии и материалы пленки и подложки должны по-прежнему иметь одинаковую кристаллическую решетку. Haпример, можно выращивать кремниевую пленку на сапфировой подложке.
В заключение заметим, что помимо описанной газовой эпитаксии, существует жидкостная эпитаксия, при которой наращивание монокристаллического слоя осуществляется из жидкой фазы, т. е. из раствора, содержащего необходимые компоненты.
Дата добавления: 2015-04-21; просмотров: 1569;
