Методы и инструменты исследования и сертификации наноматериалов и наноустройств
Методы и инструменты исследования и сертификации наноматериалов и наноустройств –устройства и приборы, предназначенные для манипулирования с наноразмерными объектами, измерения, контроля свойств и стандартизации производимых и используемых наноматериалов и наноустройств.
С научной точки зрения целесообразно как можно более полное, всестороннее изучение строения и свойств наноматериалов, а именно: исследование термодинамических, механических, тепловых, электромагнитных, оптических, химических свойств; особенностей фазообразования, структуры, строения границ и поверхностей раздела. Эти задачи обуславливают необходимость разработки специальных методов и методик.
В процессе аттестации наноматериалов необходимо подтвердить ряд характеристик материала, которые определяют основные физико–химические свойства продукции и которые важны для потребителя.
В то же время, наноматериалы являются весьма сложными объектами для изучения и аттестации. Это связано с малыми размерами структурных составляющих, спецификой многих физических свойств, большой протяжённостью границ и поверхностей раздела фаз, присутствием разупорядоченных и аморфных составляющих, формированием метастабильных и неизвестных до сих пор фаз, высокой реакционной способностью и т.д. Поэтому многие методы исследования и аттестации крупнокристаллических материалов не применимы для наноматериалов, а ряд способов требуют существенных изменений и доработки.
Важнейшей характеристикой наноматериалов является размер частиц порошка или зёрен массивного материала.
Величина удельной поверхности – одна из важнейших характеристик наноматериала, определяющая активность протекания физико–химических процессов, многие технологические свойства, взаимодействие с окружающей средой и т.д.
Удельной поверхностью называют площадь, которую имеет 1 грамм (или килограмм) того или иного вещества.
Обозначают эту величину как Sуд, её размерность [м2/г] или [м2/кг]. Удельная поверхность таких материалов как цеолиты и активированные угли может достигать значений 400 – 500 м2/г, а традиционные порошковые материалы характеризуются меньшими значениями – 0,05 ¸ 2 м2/г.
Удельная поверхность порошков определяется дисперсностью, формой и состоянием поверхности частиц.
В настоящее время для определения удельной поверхности используются методы измерения газопроницаемости и адсорбции.
Для определения среднего размера частиц или зёрен наноматериалов прямыми и наиболее наглядными являются микроскопические методы.
Электронные микроскопы в настоящее время дают разрешение 1 – 10 нм, а микроскопы новейших конструкций – 0,2 нм. Таким образом, электронная микроскопия является важным методом прямого исследования среднего размера частиц и зёрен наноматериалов.
Электронная микроскопия позволяет надежно установить важнейшие характеристики материала – форму частиц и зёрен; исследовать морфологию образца: форму, размеры, расположение фаз и структурных составляющих; изучить дефекты кристаллической решётки: дислокации, дефекты упаковки. Кроме того, современные микроскопы оснащены рядом приставок для элементного, фазового, структурного анализа, которые превращают микроскопы в чрезвычайно гибкие аналитические инструменты, обеспечивающие различные потребности физико–химического анализа.
Существуют просвечивающие, растровые, зондовые и некоторые другие виды электронных микроскопов.
Просвечивающий электронный микроскоп (ПЭМ) (рис. 16) является вакуумным прибором с электромагнитной оптической системой, позволяющей получить в проходящих электронных лучах изображение исследуемого объекта в светлом и тёмном поле на прямом и дифрагированном лучах, соответственно, а также электронограммы.
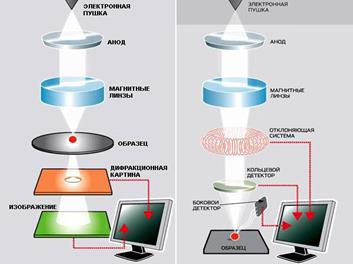
Рис. 16. Просвечивающий электронный микроскоп а – с прямым лучом, б – с дифрагированным лучом.
Изучение размерных характеристик и морфологии наноматериалов эффективно с помощью растровой электронной микроскопии (РЭМ). В растровой электронной микроскопии поверхность исследуемого образца облучается тонко сфокусированным электронным зондом диаметром 1,5 – 5 нм, совершающим возвратно-поступательные движения по линии или развёртывающимся в растр.
Растр – совокупность близко расположенных параллельных линий, вдоль которых зонд обегает выбранный участок на поверхности образца.
В РЭМ возможно различать участки изучаемых объектов размером 5 – 10 нм.
Для РЭМ характерна большая глубина резкости, что позволяет исследовать поверхность и приповерхностную структуру массивных тел, глубоко протравленные образцы, поверхности разломов, дендритные и фрактальные структуры. На РЭМ успешно изучаются порошковые материалы: морфология частиц, компактность, средний размер частиц и, в ряде случаев, их распределение по размерам.
Для изучения наноматериалов в последнее десятилетие активно используются методы сканирующей зондовой микроскопии и, прежде всего, туннельная и атомно–силовая.
Сканирующий туннельный микроскоп– прибор для изучения поверхности твёрдых электропроводящих тел (рис. 17). Принцип его работы в сканировании металлического острия (зонда) над поверхностью образца на расстоянии 0,3 – 1 нм. При перемещении зонда вдоль поверхности образца величина туннельного тока меняется в зависимости от рельефа поверхности.
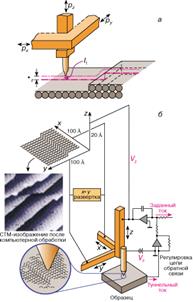
Рис. 17. Устройство туннельного электронного микроскопа.
Сканирующий атомно–силовой микроскоп создан в 1986 году. Это стало большим шагом вперёд, т.к. позволило включить в разряд изучаемых объектов диэлектрические и плохо проводящие материалы.
Устройство атомно–силового микроскопа (рис. 18) во многом аналогично устройству сканирующего туннельного микроскопа. Принципиальным отличием является то, что стабилизируется не ток между остриём и образцом, а деформация чувствительного элемента. Действие микроскопа основано на измерении сил, действующих на микроскопическое алмазное остриё, находящееся на расстоянии 0,3 – 1 нм от поверхности образца. При таких расстояниях сила взаимодействия между двумя ближайшими атомами, расположенными соответственно на кончике острия и на поверхности образца, составляет 10-7 – 10-9 Н. При жёсткости упругого элемента порядка 1 Н/м это приводит к измеримой деформации пружины. Синхронная со сканированием запись сигнала представляет собой фактически запись профиля поверхности образца.

Рис. 18. Устройство атомно-силового микроскопа.
Сегодня большинство выпускаемых сканирующих зондовых микроскопов представляют собой туннельные и атомно–силовые, совмещённые в одном корпусе.
Для измерения среднего размера частиц применяют метод малоуглового рассеяния рентгеновских лучей.
Малоугловое рассеяние – упругое рассеяние электромагнитного излучения или пучка частиц на неоднородностях вещества, размеры которых существенно превышают длину волны излучения; направление рассеянных лучей при этом лишь незначительно (на малые углы) отклоняется от направления падающего луча. В отличие от других дифракционных методов (рентгеновского анализа, нейтронографии, электронографии) с помощью малоуглового рассеяния изучают строение разупорядоченных обьектов. Иногда этот метод является единственным, с помощью которого можно получить информацию о хаотическом распределении неоднородностей.
Исследование наноматериалов с помощью дифракции рентгеновских лучей является в настоящее время весьма распространённым и даёт обширную информацию о строении и свойствах этого класса веществ. Рентгенография не требует для эксперимента большой массы образца, не воздействует на исследуемое вещество, анализ занимает небольшое количество времени. Все эти характеристики рентгеновского метода обладают несомненными достоинствами для исследования наноматериалов.
Метод дифракции нейтронов имеет ряд преимуществ перед более распространенной рентгенографией. Из–за ядерной природы амплитуда когерентного рассеяния нейтронов не зависит от угла.
Распределение частиц по размерам – очень важная характеристика наноматериалов, которая входит в обязательный перечень аттестационных параметров.
Исследование распределения частиц по размерам в случае наноматериалов возможно методами электронной микроскопии, путём расчета по результатам рентгеновским малоуглового рассеяния и рентгеноструктурного анализа.
На рис. 19 представлены возможности различных методов определения размеров наночастиц.
Для определения элементного состава наноматериалов применяются химические и физические методы анализа.
Химические методы основаны на превращении анализируемого вещества в новое соединение, обладающее свойствами, позволяющими установить образование этого соединения или количественно определить его. Для количественного определения применяют гравиметрический (весовой) и титриметрический (объёмный) анализ. Эти методы основаны на измерении количества израсходованного на реакцию реагента.
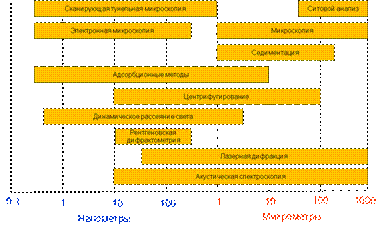
Рис. 19. Методы определения среднего размера частиц.
Физические методы определения элементного состава наноматериалов основаны на измерении зависимостей физическое свойство – состав. Это различные спектральные; атомно–абсорбционный; рентгеноструктурный; масс–спектральный, ионная диагностика и др.
Спектрометрия– область физики, посвящённая исследованию распределения интенсивности электромагнитного излучения по длинам волн или частотам. По типам спектров различают эмиссионную спектроскопию, изучающую спектры испускания, и абсорбционную спектроскопию, изучающую спектры поглощения.
К спектрометрии в широком смысле относят также ядерную спектрометрию, в которую включают a– и b–спектрометрию, а также спектрометрию нейтронов, нейтрино и других элементарных частиц. Распределение атомных частиц по массам и энергиям изучает масс–спектрометрия, интенсивность звука по его частоте – акустическая спектрометрия; электронов по энергиям – фотоэлектронная спектрометрия, рентгеноэлектронная спектрометрия и т.д.
Для определения химического состава наноматериалов так же применяются оптическая и рентгеновская спектроскопия, атомно–эмиссионный и атомно–адсорбционный анализы, масс–спектрометрия.
Атомно–эмиссионный спектральный анализ – метод определения химического состава, основанный на изучении атомных спектров вещества, возбуждаемых в горячих источниках света. Он заключает в себе информацию о качественном и количественном составах анализируемого объекта.
Атомно–адсорбционныйанализ основан на способности свободных атомов, образующихся при испарении исследуемых проб, селективно поглощать излучение определённых для каждого элемента длин волн.
Масс–спектральный анализ основан на ионизации наноразмерной пробы, формировании в вакууме направленного пучка из образовавшихся ионов и в разделении составляющих пучок ионов по массам в магнитном и электрическом полях.
Для определения фазового состава наноматериалов обычно используются методы рентгеновской, электронной и нейтронной дифракции.
Очень чувствительным методом определения фазового состава наноматериалов является мёссбауэровская спектрометрия (g–резонансная спектрометрия) – совокупность основанных на использовании мёссбауэровского эффекта методов исследования физических и химических свойств конденсированных сред (главным образом твёрдых тел), а также микроскопических объектов (ядер, ионов, химических и биологических комплексов).
Эффект Мёссбауэра (ядерный g–резонанс) – испускание или поглощение g–квантов атомными ядрами в твёрдом теле, не сопровождающееся изменением колебательной энергии тела. Применение этого ядерного эффекта для исследования материалов обусловлено его сильной зависимостью от взаимодействия между ядром и электронами на атомных или молекулярных орбиталях.
В каждой из контактирующих сред на некоторое расстояние от поверхности простирается слой, в котором элементный состав, химическое состояние, атомная и электронная структуры и, следовательно, динамические, электронные, магнитные и другие свойства вещества существенно отличаются от его свойств в объёме. Толщина этого слоя зависит от природы соприкасающихся сред и внешних условий и определяется характерной длиной, присущей рассматриваемому физическому явлению.
Поверхность – граница раздела между двумя контактирующими средами.
Межфазные границы обусловливают многие поверхностные явления, которые оказывают значительное влияние на свойства микросистем. Это связано с увеличением поверхности наноматериалов, её искривлением и взаимодействием различных поверхностей друг с другом.
Морфологию поверхности наноматериалов исследуют методами растровой электронной и зондовой микроскопии.
Для изучения состава и структуры поверхности наноматериалов применяются разнообразные методы: просвечивающая электроннная микроскопия, микроскопия высокого разрешения, фотоэлектронная и оже–спектроскопия, масс–спектрометрия, др. (рис. 20).

Рис. 20 Классификация методов анализа поверхности наноматериалов.
Электронная микроскопия высокого разрешения – чрезвычайно мощный метод изучения свойств реальной поверхности наноматериалов. Этим методом возможно прямое изучение дефектов поверхности, топографии распределения фаз на поверхности, определение распределения атомов на поверхности, исследование процессов поверхностной миграции и зародышеобразования, наблюдение динамических явлений на атомном уровне. Фотоэлектронная спектроскопия в настоящее время является одним из популярнейших методов исследования поверхности.
Рентгеновская (РФС) и ультрафиолетовая (УФ) фотоспектроскопии являются взаимно дополняющими методами. Первый даёт возможность проведения качественного и количественного анализа, а второй позволяет получить ценную информацию о валентных электронах. В то же время интерпретация УФ–спектров сложных по составу образцов при отсутствии данных РФС сильно затруднена.
В дополнение к методам ФЭС при исследовании поверхности наноматериалов обычно используются методы дифракции медленных электронов (ДЭМ) испектрометрия характеристических потерь энергии электронов.
Оже–спектроскопия – область электронной спектроскопии, в основе которой лежат измерение энергии и интенсивности токов оже–электронов, а также анализ формы линий спектров оже–электронов, эмитированных атомами, молекулами и твёрдыми телами в результате оже–эффекта.
Оже–эффект –эмиссия электронов из атома, происходящая в результате безызлучательного перехода при наличии в атоме вакансии на внутренней электронной оболочке.
Для распределительного послойного анализа поверхностных слоёв твёрдых наноразмерных тел используется метод масс–спектрометрии вторичных ионов.
В основе способа лежит принцип бомбардировки поверхности пробы сфокусированным пучком ионов с энергиями порядка нескольких кэВ. Вследствие соударений с этими ионами частицы мишени распыляются в виде атомов или ионов. Вторичные ионы попадают в масс–анализатор, где разделяются в соответствии с соотношением их заряда к массе. Информацию о составе и свойствах поверхности даёт исследование массы или энергии вторичных ионов. Чувствительность метода определяется как параметрами проведения процесса исследования, так и особенностями образца: плотностью тока первичных ионов; площадью поверхности, с которой собираются вторичные ионы; распространённостью изотопа определяемого элемента, его атомной массы, природы матрицы и др.
Дата добавления: 2015-02-07; просмотров: 4896;
