ТВЕРДОТЕЛЬНАЯ ЭЛЕКТРОНИКА
ГЛАВА 5
ПОЛУПРОВОДНИКИ - ОСНОВА ТВЕРДОТЕЛЬНОЙ
ЭЛЕКТРОНИКИ
5.1. Структура полупроводников
Полупроводники представляют собой широкий класс материалов с электронным механизмом проводимости, в которых концентрация подвижных носителей заряда ниже концентрации атомов, но может меняться под действием температуры, освещения, примесей.
По значению удельной электропроводимости 103<с< < 10~9 Ом-1 • см-1 полупроводники занимают промежуточное положение между металлами (104 < ст < 106 Ом-1 • см-1) и диэлектриками (а > 10-12 Ом-1 • см-1). Одной из главных отличительных свойств полупроводниковых материалов является возрастание электропроводности с ростом температуры. В широком диапазоне температур электропроводность для полупроводников с собственной проводимостью экспоненциально растет с температурой Т, К, по закону
еа — энергия активации проводимости, которая соответствует энергии связи электронов с атомами; к — постоянная Больцмана.
Собственная проводимость — проводимость, обусловленная возбужденными электронами валентной зоны, переходящими в зону проводимости, а также дырками, образующимися в валентной зоне. Концентрации я, таких зонных электронов и дырок равны.
В полупроводниках наблюдается изменение электропроводности в сильном электрическом поле. Энергия, получаемая носителями заряда от электрического поля, передается кристаллической Ре' шетке с помощью фононов. Квант колебаний атомов кристалличе

ской решетки называют фононом. Термин был введен советским физиком И.Е. Таммом по аналогии с квантом электромагнитного поля — фотоном. Фонон является квазичастицей, представляющей собой квант энергии упругих колебаний кристаллической решетки. Энергия фонона определяется по формуле = йсо, где со — частота колебаний; h — И/2к — постоянная Планка.
В процессе взаимодействия с фононами выделяется джоулево тепло. При определенных условиях носители не успевают передать фононами всю энергию, полученную от поля. Тогда их температура будет существенно выше температуры решетки. В этом случае говорят о горячих электронах. Разогретые носители могут резко изменить свою подвижность.
Полупроводники можно классифицировать по различным признакам, например:
агрегатному состоянию — твердые, твердые растворы; структуре — кристаллические, некристаллические; физическим свойствам — магнитные, сегнетоэлектрические; химическому составу — элементарные, соединения, органические.
В твердотельной электронике и микроэлектронике в основном используют твердотельные кристаллические структуры, состоящие из элементарных полупроводников (Ge, Si) или полупроводниковых соединений типа Ge—Si, А3В5 (GaAs, InSb), А2В6 (CdS), AlxGai_xN, InxGai_xASy и др.
Основное требование к полупроводниковым материалам, используемым в электронике, — это бездефектность или малое количество дефектов. Поэтому основными материалами являются моно- кристаллические полупроводники — твердые тела с регулярной кристаллической структурой.
Кристаллическая структура состоит из множества повторяющихся и примыкающих друг к другу элементарных ячеек определенного размера. В элементарной ячейке частицы занимают строго фиксированные позиции, находясь на определенном расстоянии друг от друга. В результате взаимодействия электронов внешних оболочек атомов в кристалле возникает химическая связь. По типу химических связей различают четыре основные группы кристаллических структур.
В ионных или гетерополярных кристаллах преобладает ионный (электростатический) характер связи между атомами, возникающий вследствие перехода электронов от одного атома к другому.
В ковалентных или гомеополярных кристаллических структурах валентные электроны соседних атомов обобществляются, образуя двойные или тройные связи между атомами. К такому типу кристаллов относят алмаз, кремний, карборунд.
В молекулярных кристаллах атомы в молекуле прочно связаны, в то время как сами молекулы между собой связаны слабо. Такая связь характерна для органических соединений.
Кремний, например, имеет кубическую гранецентрированную структуру типа алмаза с постоянной решетки а — 0,54307 нм (рис. 5.1, а). Для арсенида галлия характерна классическая структура цинковой обманки ZnS (минерала сфалерита). Кристаллическая структура цинковой обманки имеет специфические особенности. При разделении кристалла GaAg по плоскости (111) в верхнем слое располагаются атомы Ga, а в нижнем — атомы As (рис. 5.1, б). Это свойство широко используют в процессах при эпитаксиальном выращивании и травлении.

Структура кристаллической решетки имеет дефекты и дислокации. Различают точечные дефекты в виде пустого узла (вакансия) или междоузельного атома, а также примесные дефекты в виде примеси внедрения или замещения.
Дислокации бывают линейные (краевые) и винтовые (спиральные). Помимо дислокаций и дефектов в полупроводниковых кристаллах могут иметь место микротрещины, поры, пузырьки и т.д. Все эти неоднородности кристаллов приводят к браку при производстве интегральных схем. Поэтому получению бездефектных полупроводниковых структур уделяют большое внимание.
При наличии дефектов на поверхности кристалла у приповерхностных атомов кристалла нарушаются ковалентные связи из-за отсутствия следующих слоев атомов. Нарушение ковалентных связей приводит к нарушению энергетического равновесия на поверхности. Это может привести к захвату чужеродных атомов из окружающей среды — адсорбции или к частичному восстановлению оборванных связей и образованию, например оксидов.
Структура тонкого приповерхностного слоя резко отличается от структуры основного объема кристалла. Граничные слои играют важнейшую роль при создании интегральных схем.
Структуру полупроводникового материала можно изменять искусственно по нужному алгоритму. Изменение структуры при внедрении примесных атомов приводит к целенаправленному изменению проводимости полупроводников. Технологически такое изменение может осуществляться путем высокотемпературной диффузии или ионной имплантации. Целенаправленное локальное изменение проводимости полупроводниковой структуры легло в основу производства интегральных схем.
5.2. Носители заряда в полупроводниках
Электропроводность полупроводников обусловлена двумя типами носителей электрического заряда, которые могут перемещаться под действием градиента концентрации или внешнего электрического поля. Носителями заряда в полупроводниках являются электроны проводимости и дырки.
Электрон проводимости — наименьший носитель отрицательного электрического заряда. Масса электрона в общем случае не постоянна и зависит от скорости электрона. Введем понятие эффективной массы электрона т — pq/vq, где ро и Vo — абсолютные значения импульса и скорости.
Дырка — это квазичастица или незаполненное электронное состояние — вакансия, которая перемещается в направлении, противоположном перемещению электрона. По существу такая вакансия является положительно заряженным атомным состоянием. Подчеркнем, что именно атомное состояние, а не положительно заряженный ион. Введение понятий дырки и дырочной проводимости является лишь удобным описанием электронной системы кристалла. Важно отметить, что эффективная масса электронов и дырок никак не связана с инерционными свойствами электрона.
Дырке приписывают положительный заряд, по значению равный заряду электрона. Эффективная масса дырки обычно больше, чем у электрона. Подвижность дырок при движении в полупроводниковой структуре меньше, чем у электронов проводимости.
С повышением температуры кристалла количество и энергия фононов возрастает. Фононы способны разорвать ковалентные связи между атомами решетки. Это приводит к одновременному возникновению свободных электронов и незаполненных связей — дырок. Процесс образования электронно-дырочных пар под действием фононов называют термогенерацией. Проводимостью собственного полупроводника можно управлять. С этой целью вводят примеси, которые могут локально изменять тип проводимости полупроводника.
Рассмотрим два случая внедрения примеси. Если в кристаллическую решетку кремния, который является четырехвалентным, ввести атом пятивалентного элемента из V группы таблицы Менделеева, то четыре валентных электрона из пяти свяжутся с четырьмя электронами атома кремния. Образуется устойчивая оболочка из восьми электронов, а примесный атом, например фосфора, превратится в положительный ион. Оставшийся свободным электрон добавится к собственным свободным электронам полупроводника. Такие полупроводники называются электронными полупроводниками, или полупроводниками «-типа (рис. 5.1, в).
Во втором случае внедрим в кристаллическую решетку кремния элемент из III группы таблицы Менделеева, например атом бора. В этом случае все три валентных электрона вступят в связь с электронами соседних атомов кремния. Одна связь останется свободной Дополнительный электрон для образования устойчивой восьмиэлектронной оболочки будет заимствован у ближайшего атома кремния- Таким образом, образуется незаполненная связь, или дырка. АтоМ примеси превратится в неподвижный ион с отрицательным зарядов (см. рис. 5.1, б). Дырки примесного происхождения добавятся .К 94
собственным дыркам, а полупроводник станет полупроводником p-типа, или полупроводником с дырочной проводимостью.
Для получения полупроводников электронного типа из кремния используют обычно элементы V группы: фосфор, сурьму, мышьяк. Полупроводники дырочного типа получают внедрением примеси III группы: бора, галлия, алюминия, индия. Примеси в полупроводниках электронного типа называют донорными, а в полупроводниках дырочного типа — акцепторными.
В GaAs донорами являются элементы VI группы — сера и теллур, а акцепторами — элементы II группы — бериллий и цинк. Существуют так называемые амфотерные примеси. Они могут быть как донорной, так и акцепторной примесью, в зависимости от условий внедрения. Кремний, вводимый в GaAs методом ионной имплантации, является донором, а германий, введенный методом жидкостной эпитаксии, — акцептором.
В примесных полупроводниках концентрация электронов и дырок — это количество частиц в объеме кубического сантиметра. Носителей преобладающего типа проводимости называют основными, а другого типа — неосновными. В полупроводнике «-типа проводимости основными носителями являются электроны, в полупроводнике p-типа проводимости — дырки.
Поведение электронов в монокристаллическом полупроводнике определяется не только корпускулярными свойствами электрона, но и его волновыми свойствами — волновой функцией электрона ¥. В соответствии с принципом корпускулярно-волнового дуализма волновая функция электрона является комплексной величиной.
В квантовой теории нельзя точно предсказать события, но можно определить вероятность событий. По вероятностям находятся средние значения физических величин. Пси-функция W и является той величиной, которая позволяет находить вероятности. Обычно говорят о плотности вероятности Р, определяемой как Р — I'Pj = 'F'F*, где VF* — комплексно сопряженная функция.
В этом случае квазиимпульс электрона р определяется как Ш, где ft — постоянная Планка; к — волновой вектор электрона. В свою очередь, энергия электрона Е связана с его массой соотношением Е = h2k2/2m.
В идеальном монокристалле атомы расположены регулярно, причем расстояние между ними равно шагу решетки а (несколько ангстрем). Атомы состоят из положительно заряженных ядер и электронов, обладающих эквивалентным отрицательным зарядом Количество атомов в кристалле близко к значению 1022 см-*
(1028 м“3), причем каждый из них обладает собственной системой энергетических уровней.
Количественный анализ свойств полупроводников базируется на зонной теории твердого тела, в соответствии с которой твердое тело характеризуется совокупностью энергетических зон. Верхнюю зону, разрешенную для заполнения электронами, называют зоной проводимости с границей или дном Ес, а нижнюю зону — валентной зоной с границей или потолком Ev. Между ними находится запрещенная зона Eg, ширина которой зависит от температуры:
Eg ~ Еф — EgT,
где £go — ширина зоны при Т = О К; eg — температурная чувствительность, которая для кремния составляет 3 • 10~4 В/°С. Ширина запрещенной зоны для Si при комнатной температуре равна Eg = 1,12 эВ, а для GaAs — 1,42 эВ.
Увеличение энергии электрона соответствует переходу электрона на внешние энергетические уровни. Напротив, увеличение энергии дырки соответствует снижению на более низкий энергетический уровень. Это явление можно объяснить следующим образом. Допустим, что в валентной зоне недостает несколько электронов для ее заполнения. Электроны всегда стремятся заполнить уровни с наименьшей энергией. Тогда свободными оказываются наивысшие по энергии электронные состояния. Эти уровни расположены вблизи потолка валентной зоны Еу. Незанятые электронные состояния являются дырками, которые стараются занять наивысшие по энергии состояния. Для них, в противоположность электронам, эти состояния вблизи потолка валентной зоны или состояния с наименьшей энергией.
На рис. 5.2 приведены зонные диаграммы с донорной примесью замещения и с акцепторной примесью замещения. Полные концентрации для примесного проводника будут соответствовать: для донорного п = п„ + щ и р — pi, для акцепторного и = и,- и Р ~ Рп + Рь Здесь р — концентрация электронов и дырок, обусловленная возбуждением собственного полупроводника; пп, р„ — концентрация электронов и дырок, образовавшихся вследствие возбуждения донорных и акцепторных примесей. В обычном случае справедливо соотношение пп » п{, рр » р^
В полупроводнике при неизменной температуре произведение концентрации электронов и дырок является постоянной величиной. Существует классическое соотношение, называемое законом действующих масс: «, • pt — п2 и поэтому увеличение, например,
концентрации электронов, приводит к уменьшению концентраций 96


где i — набор квантовых чисел, характеризующих состояние частицы; к — постоянная Больцмана; х — химический потенциал. В общем случае химический потенциал является термодинамической функцией состояния, определяющей изменение термодинамических потенциалов при изменении числа частиц в системе. В полупроводниках это химический потенциал электронного газа. Добавление одного электрона в систему, находящуюся в тепловом равновесии, увеличивает энергию системы на х-
В полупроводниках значение х соответствует энергии в центре запрещенной зоны — электрическому потенциалу ф£. Энергию, соответствующую середине запрещенной зоны невырожденного полупроводника, называют уровнем Ферми EF = - (Ес + Ev). Так как
уровень Ферми зависит от температуры, то не может служить пара-
метром полупроводника. Уровень Ферми определяют как потенциал, вероятность заполнения которого электроном равна 0,5. Для идеального газа фермионов, например электронов, уровень Ферми совпадает с химическим потенциалом при Т = 0 К.
В полупроводнике «-типа проводимости концентрация электронов в зоне проводимости больше, чем у собственного полупроводника, и уровень Ферми будет расположен выше середины запрещенной зоны, ближе к донорному уровню Eg. В полупроводнике p-типа проводимости концентрация дырок в валентной зоне будет выше, чем у собственного полупроводника. Уровень Ферми в таком полупроводнике будет расположен ниже середины запрещенной зоны, т. е. ближе к акцепторному уровню. Распределение носителей в обоих случаях приведены штриховой линией на рис. 5.2. Штриховая линия пересекает уровень Ферми на значении 1/2.
Одним из фундаментальных положений в физике полупроводников является постулат: уровень Ферми одинаков во всех частях равновесной системы, какой бы разнородной она ни была. В этом случае справедливы соотношения: EF = const, grad(Ef) = 0.
5.3. Явления переноса носителей
В полупроводниках существуют два основных механизма переноса носителей: диффузия носителей заряда; дрейф носителей заряда под действием внешнего электрического поля. Диффузия носителей заряда — направленное перемещение носителей в кристалле в сторону уменьшения их концентрации. Процесс диффузии ведет к выравниванию неравномерного распределения неравновесных носителей заряда по объему кристалла. Различают монополяр- ную диффузию (или диффузию носителей одного заряда) и биполярно-совместную диффузию электронов и дырок. Диффузионные потоки электронов и дырок при биполярной диффузии пропорциональны градиентам концентраций соответствующих носителей зарядов. В неоднородно легированных полупроводниках смещение подвижных носителей или их диффузия уравновешивается возникновением встроенного внутреннего электрического поля 2w Обычно дрейф носителей в кристалле имеет хаотический характер.
Дрейф же носителей заряда под действием внешнего электрического поля представляет собой упорядоченное движение. На процесс дрейфа носителей заряда в электрическом поле накладывается тепловое движение, которое не образует макроскопический поток. Однако это сказывается на направленности движения частиц- 98
Электрический ток, обусловленный дрейфом носителей заряда, называют дрейфовым. Плотность дрейфового тока j определяется соотношением j = <зЕ, где а — удельная проводимость; Е — напряженность электрического поля.
Поскольку в полупроводнике имеются два типа носителей, то удельная проводимость имеет две компоненты: а = а„ + ар, где а„ = qn\in — электронная, аор = qn\ip — дырочная составляющие. Здесь \х„ и \хр — подвижности соответствующих носителей заряда; q — заряд носителей; пир — соответствующие концентрации носителей заряда. Заметим, что подвижность электронов в кремнии Hsi= 1200 см2/В • с, германии pGe= 3600 см2/В • с, арсениде галлия PGaAs= 5000 CM2/B • с.
Подвижность носителей заряда характеризует динамические свойства носителей заряда и определяется как отношение средней установившейся скорости в направлении электрического поля к напряженности этого электрического поля. Подвижность представляет собой многократное повторение следующих фаз процесса: ускорение носителей электрическим полем, их рассеяние на дефектах кристалла или на фононах, изменение вектора движения, повторное ускорение и т.д. Поэтому чем меньше масса носителей, тем более высокую подвижность они имеют. Подвижность определяется из соотношения ц = где х — среднее время пробега меж-
т
ду двумя циклами рассеяния; q — заряд электрона; т — эффективная масса заряженной частицы.
Подвижность имеет размерность сантиметр квадратный на вольт-секунду и при напряженности поля Е — 1 В/см значение подвижности численно равно скорости носителя: р = v. Подвижность носителей заряда ограничена процессами их рассеяния на дефектах кристаллической решетки, а также на тепловых колебаниях кристаллической решетки. Поэтому температура является важным фактором, определяющим подвижность носителей заряда. С понижением температуры доминирующим становится процесс рассеяния на дефектах. В сильных электрических полях подвижность существенно зависит от напряженности поля. Как следствие возникают «горячие» электроны. Таким образом, в полупроводнике движение носителей заряда обусловлено диффузией под воздействием градиента концентрации и дрейфом под воздействием градиента электрического поля.
j Ул др У/гдиф Jpnp Jp диф>
где индексы «др» и «диф» относятся к дрейфовым и диффузионным составляющим тока электронов jn и тока дырок jp.
Диффузионные составляющие токов можно записать в виде
dn _ dn . dp _ dp
Лдиф & qD" dx’ У'отф p dx 9 pdx’
где Dn и Dp — коэффициенты диффузии электронов и дырок. Они
кТ
определяются в соответствии с формулой Эйнштейна D =—fa. Ко-
q
эффициент диффузии носителей заряда является отношением плотности потока подвижных носителей заряда одного типа к градиенту их концентрации в отсутствие поля и имеет размерность сантиметр в квадрате на секунду. При комнатной температуре коэффициент диффузии для германия DGe « 90 см2/с и арсенида гал-
О О
лия Dqhas * 220 см /с, кремния Dsi = 38 см /с. Диффузионная длина L представляет собой расстояние, на котором в однородном полупроводнике при одномерной диффузии в отсутствие полей избыточная концентрация неосновных носителей заряда уменьшается вследствие рекомбинации в е раз (е — основание натурального логарифма). Диффузионная длина L связана со временем жизни соотношением L = ~jDx.
Дрейфовые составляющие токов можно записать в виде
; _ /г- dU. • _ 1г_ ди
Jnnp ЯЩ^П Wn а ’ jР др 0Р\Ь рЕ 0Р№ р .
дх дх
В сильных электрических полях происходит разогрев носителей тока. Энергия, получаемая носителями от электрического поля, не успевает рассеяться тепловыми фононами и температура носителей оказывается существенно выше температуры решетки. В этом случае говорят о горячих носителях, например о горячих электронах.
5.4. Барьеры на границах кристалла
В соответствии с законом диффузии оценим время, за которое
/2 ;
электроны могли бы покинуть кристалл /диф * —, где / — характерный размер кристалла, D — коэффициент диффузии носителей зато
ряда. С помощью соотношения Эйнштейна коэффициент диффузии для золота составляет 0,75 см2/с, подвижность носителей —
/ч______________
р, а 30 см /В • с при 7ДИф « 1,3 с. Однако все электроны остаются в кристалле. Это объясняется тем, что на границе раздела твердое тело — вакуум существует потенциальный энергетический барьер, препятствующий выходу электронов в окружающую среду. Чтобы преодолеть потенциальный барьер, электрон должен обладать энергией больше работы выхода электрона из твердого тела. Работа выхода представляет собой энергию, которая затрачивается при возбуждении электронов для их вывода из твердого тела в вакуум, и для различных веществ колеблется в пределах 1...6 эВ. Существуют разные методики ее определения. На работу выхода электронов из полупроводников сильно влияют явления на границе раздела полупроводник—вакуум.
Кристалл полупроводника характеризуется регулярной структурой, которая нарушается ближе к границе раздела. Резко нарушаются и условия связи между валентными электронами, принадлежащими приповерхностным атомам. Обрыв кристаллической решетки способствует появлению дополнительных энергетических уровней — уровней поверхностных состояний. Поверхностные состояния пространственно локализованы на границе раздела полупроводника с какой-либо средой. Поверхностные состояния имеют энергетическое положение в запрещенной зоне полупроводника и меняют свое зарядовое состояние в зависимости от положения уровня Ферми. В реальных условиях поверхность всегда покрыта слоем адсорбированных атомов, оксидов и т.п. На поверхности всегда существуют структурные дефекты: искажения решетки, вакансии и т.д. Совокупность или спектр поверхностных состояний реальной поверхности можно менять, изменяя окружающие условия и (или) способы обработки поверхности.
В зависимости от того, какой тип поверхностных состояний имеет место (донорный или акцепторный), соответствующим образом будет заряжаться и поверхность твердого тела. Если на поверхности полупроводника «-типа проводимости преобладают акцепторные состояния, то поверхность будет захватывать электроны из объема полупроводника, прилегающего к поверхности, и поверхность в этом случае будет заряжена отрицательно. В приповерхностной области образуется слой, обедненный электронами и соответственно заряженный положительно. На поверхности полупроводника возникает двойной заряженный слой. Поле этого слоя будет препятствовать выходу электронов из кристалла. Поле двойного слоя максимально вблизи поверхности раздела и уменьшается
по мере удаления к глубь кристалла, и работа выхода электронов складывается из двух компонентов. Первая связана с объемными свойствами кристалла и определяется электростатическим потенциалом и объеме. При этом уровень Ферми принимают за нуль отсчета. Вторам компонента определяется барьером электростатического диполя. г)та компонента соответствует работе, которую необходимо совершит!, для перемещения электрона через дипольный слой поверхности. Дипольный момент является характеристикой поверхности и меняется от одной поверхности к другой.
5.5. Электронно-дырочные переходы
Па границе /;- и /7-областей создается энергетический барьер, который является основой всех полупроводниковых элементов и компонентов. Полупроводник р-типа проводимости представляет собой отрицательно заряженные акцепторы, неподвижно закрепленные в кристаллической решетке, и положительно заряженные дырки, способные переносить заряды и формировать электрический ток. Полупроводник л-типа проводимости, напротив, содержит положительно ионизированные доноры, неподвижно закрепленные в решетке и отрицательно заряженные свободные электроны проводимости.
Рассмотрим физические процессы, происходящие области перехода полупроводника с электропроводностью р- в полупроводник /7-типа электропроводности. Такой переход называют электронно-дырочным переходом (рис. 5.3). Если легирование донорной и акцепторной примесями осуществляется в одном и том же полупроводнике (например, в кремнии), то говорят о гомопереходе.

ь идет о гетеропереходах. ре Создадим конструкцию, в которой концентрация основных носителей заряда в р-области выше концентрации основных носите- аей заряда в /7-области. В таком электронно-дырочном переходе дьфки из р-области диффундируют в «-область, а электроны из „-области диффундируют в р-область (рис. 5.3, а). Такой процесс встречной диффузии носителей заряда приводит к появлению в „.области нескомпенсированного положительного заряда и соответственно отрицательного заряда в р-области. Донорные и акцепторные атомы жестко связаны с кристаллической решеткой и поэтому формируют у границы р- и /7-областей двойной электрический мой пространственного заряда. Формируется электрическое поле Ет, направленное из /7-области в р-область. Термодинамическое равновесие наступает, когда диффузионные потоки электронов и дырок компенсируются дрейфовыми потоками во внутреннем электрическом поле Евн р-/7-перехода. Возникает диффузионная разность потенциалов, определяемая соотношением
Больцмана; Т — температура полупроводника; — концентрация носителей в собственном полупроводнике; пр, пп — концентрации дырок и электронов в р- и «-областях соответственно. Эта разность потенциалов, возникающая между р- и «-областями сдвигает энергетические уровни в этих областях на величину, равную разности Ферми уровней в этих областях.
Поле пространственного заряда создает потенциальный барьер, препятствующий дальнейшей диффузии носителей заряда через переход. В процессе диффузии зарядов в приконтактной зоне происходит интенсивная рекомбинация носителей заряда, в результате чего эта зона обедняется подвижными носителями заряда. Именно поэтому двойной электрический слой называют обедненным слоем. Когда установилось термодинамическое равновесие, суммарный положительный заряд в слое пространственного заряда строго равен суммарному отрицательному. В условиях термодинамического равновесия и в отсутствие внешнего электрического поля полный ток через р-я-переход равен нулю.
Рассмотрим процессы, происходящие в р-я-переходе при приложении внешнего электрического поля. При подаче положительного потенциала на р-область внешнее поле будет направлено против контактного. В этом случае говорят о прямом смещении. В таком

внешнем поле потенциальный барьер понижается Уар (рис. 5.3, 6). 1
Уменьшается и область /ь«-перехода. С ростом приложенного на- ;
пряжения возрастает количество носителей заряда с энергией, достаточной для преодоления потенциального барьера. В /7-область пе- ,
реходит добавочное количество электронов, а в «-область — дырок.
Такое введение подвижных носителей заряда в область, где они являются неосновными, называется инжекцией носителей заряда. Одновременно через внешние контакты в р- и «-области поступают основные носители зарядов, способствующие нейтрализации инжектированных зарядов. Инжектированные неосновные носители зарядов диффундируют в глубь п- и /7-областей. В результате через переход протекает диффузионный электрический ток. При повышении приложенного напряжения этот ток возрастает приблизительно по экспоненциальному закону / = /0[ехр(^С4рД7) — 1]
(рис. 5.4). Это выражение называют уравнением Эберса — Молла.
При приложении положительного потенциала к «-области внешнее поле совпадает по направлению с контактным (см. рис. 5.3, а).
Такой режим называют обратным смещением и для него характерно возрастание потенциального барьера Уобр (см. рис. 5.3, в). В этом случае ток определяется диффузией неосновных носителей заряда, возникающих в результате тепловой генерации в «- и /7-областях вблизи перехода. Область /ья-перехода увеличивается, в нем также происходит процесс генерации электронно-дырочных пар. Даже при небольших обратных смещениях практически все термически генерированные вблизи />-«-перехода неосновные носители заряда попадают в область, где они являются основными. Уменьшение концентрации неосновных носителей заряда в области р-п-перехода полупроводника называют экстракцией. В процессе экстракции


Процесс диффузии через р-п-переход связан с образованием разности потенциалов ф0, а также ионов доноров и акцепторов, жестко привязанных к решетке. Образовавшийся потенциальный барьер характеризуется барьерной емкостью, которая может быть описана формулой плоского конденсатора: Сп = е£о$/х„, где х„ — ширина /?-/7-перехода; е — относительная диэлектрическая проницаемость; 8о — электрическая постоянная; 5 — площадь ^-«-перехода. Окончательная зависимость барьерной емкости от напряжения примет вид Сб = Сбо(1 - £//<роГ', где Сбо — барьерная емкость /ьл-перехода в равновесном состоянии; и — приложенное напряжение; / = 1/2 — для симметричного перехода. Барьерная емкость составляет от десятков до сотни пикофарад.
При прямом включении /?-«-перехода основным процессом является процесс перемещения диффузионных зарядов, определяемый диффузионной емкостью (СДИф » Сб).
При обратном включении р-я-перехода главную роль играет барьерная емкость, которая отражает перераспределение зарядов в р-л-переходе (Сб » Сдиф).
5.6. Гетеропереходы
Гетеропереходом называют переход, образующийся на границе двух полупроводников с различной шириной запрещенной зоны. Он может быть образован как двумя монокристаллическими (аморфными) полупроводниками, так и монокристаллическим и аморфным полупроводниками.
На границе гетероперехода происходит изменение свойств полупроводника, в частности, меняется структура энергетических зон, ширина запрещенной зоны, подвижности и эффективные массы носителей заряда.
Различают анизотипные и изотипные гетеропереходы. Анизо- типные переходы создаются в результате контакта полупроводников с дырочной и электронной типами проводимости. Изотипные переходы возникают в результате контакта полупроводников одного типа проводимости.
Для построения зонных диаграмм, детального анализа распределения электрического поля и потенциала в области пространственного заряда гетероперехода необходимо учитывать, что различные полупроводники будут иметь разные значения электронного сродства х, ширины запрещенной зоны Ея и диэлектрической проницаемости е*.

Совсем иная картина имеет место для электронов, которые желают преодолеть барьер при переходе из п- в /7-область. Потенциальный барьер для электронов в этом случае достаточно велик и поэтому электронный ток в прямом направлении мал. Электрическое поле на границе раздела имеет разрыв, который обусловлен различием диэлектрических проницаемостей. Энергетические зоны также имеют разрыв на границе раздела, образуя ступени АЕс и АЕу. При подаче прямого внешнего электрического поля барьер для электронов будет меньше, чем барьер для дырок. В этом слое доминирующим будет ток электронов. Помимо приведенных типов гетеропереходов существует также ряд специальных гетеропереходов, которые представляют значительный практический интерес, например квантовый колодец с двумерным электронным газом. Квантовый колодец образуется на пике при условии, что его часть расположена ниже уровня Ферми (зачерненная область на рис. 5.5, а).
Двумерный электронный газ (ДЭГ) представляет собой систему электронов, энергетические уровни которых дискретны и их движение непрерывно. Другими словами, в поперечном направлении потенциальная энергия электронов не позволяет им покинуть потенциальную яму, а соответствующие энергетические уровни дискретны. Таким образом, движение электронов возможно только в плоскости ДЭГ.
Свойства двумерного газа определяются возможностью регулировать и менять в широких пределах плотность электронного газа под действием поперечного электронного поля. Для электронов в области ДЭГ характерна высокая подвижность порядка 9 • 103 см2/В • с и выше. Это близко к объемной подвижности электронов в нелегированном СаАБ.
Если гетеропереход получен из веществ с различной постоянной решетки, то на границе двух полупроводников могут возник-

нуТь механические дефекты, которые будут играть роль ловушек для дырок и электронов. Со стороны я-типа появится подъем зон, в то время как со стороны р-типа возникнет их понижение. В таких гетероструктурах формируются квантовые колодцы для обоих типов носителей заряда. Комбинации различных гетеропереходов образуют гетероструктуры.
Искусство создания полупроводниковых гетероструктур с заданным расположением энергетических зон, с различными перепадами потенциалов и размерами квантовых барьеров и ям называют зонной инженерией. В идеальном случае зонная инженерия позволяет сформировать структуры с заданными электронными свойствами и вольт-амперными характеристиками. Одной из разновидностей гетероструктур являются гетероструктуры с регулярным чередованием слоев, которые получили название сверхрешеток.
5.7. Контакты
Исторически первыми полупроводниковыми приборами стали диоды на основе контакта полупроводник—металл. Различают контакты полупроводник—металл двух типов: омические контакты или невыпрямляющие и выпрямляющие контакты.
Тип контакта определяется взаимным расположением уровней Ферми в обоих веществах, а также типом проводимости полупроводника.
Омическим контактом, или омическим переходом, называют физический контакт, электрическое сопротивление которого мало и не зависит от направления тока в заданном диапазоне значений токов и не имеет в определенных пределах существенных отклонений от закона Ома. В таких контактах отсутствует инжекция неосновных носителей заряда, их удельное сопротивление меньше 105 Ом • см2. Большинство омических переходов создается на основе п+-п- или /?+-р-переходов. Концентрация легирующей примеси в сильно легированном слое должна быть достаточно высокой, чтобы между металлом и я+-полупроводником создать обедненную область. Толщина этой области такова, что переход носителей через потенциальный барьер обеспечивается с помощью механизма туннельного эффекта. Из-за низкой концентрации дырок в выраженном и+-слое их инжекция в слабо легированную «-область будет отсутствовать.
Улучшению свойств омического контакта служит шлифовка полупроводника в месте его контакта перед металлизацией. Возникшие в процессе шлифовки дефекты кристаллической решетки ра-
ботают как центры рекомбинации. В этом случае возникает равновесная концентрация основных и неосновных носителей вблизи поверхности полупроводника. В зависимости от типа электропроводности полупроводника и соотношения работ выхода металла и полупроводника можно создать обедненный, инверсный или обогащенный слои.
Если работа выхода электронов из металла фм меньше, чем из полупроводника срп, то электроны стремятся перейти из металла в полупроводник. Для полупроводника с электронным типом проводимости характерно формирование обогащенного слоя (рис. 5.6, а), а для дырочного типа проводимости — обедненного (рис. 5.6, б). Если работа выхода из металла больше работы выхода из полупроводника, то в электронном типе полупроводника формируется обедненный, или инверсный слой (рис. 5.6, в), а в дырочном —
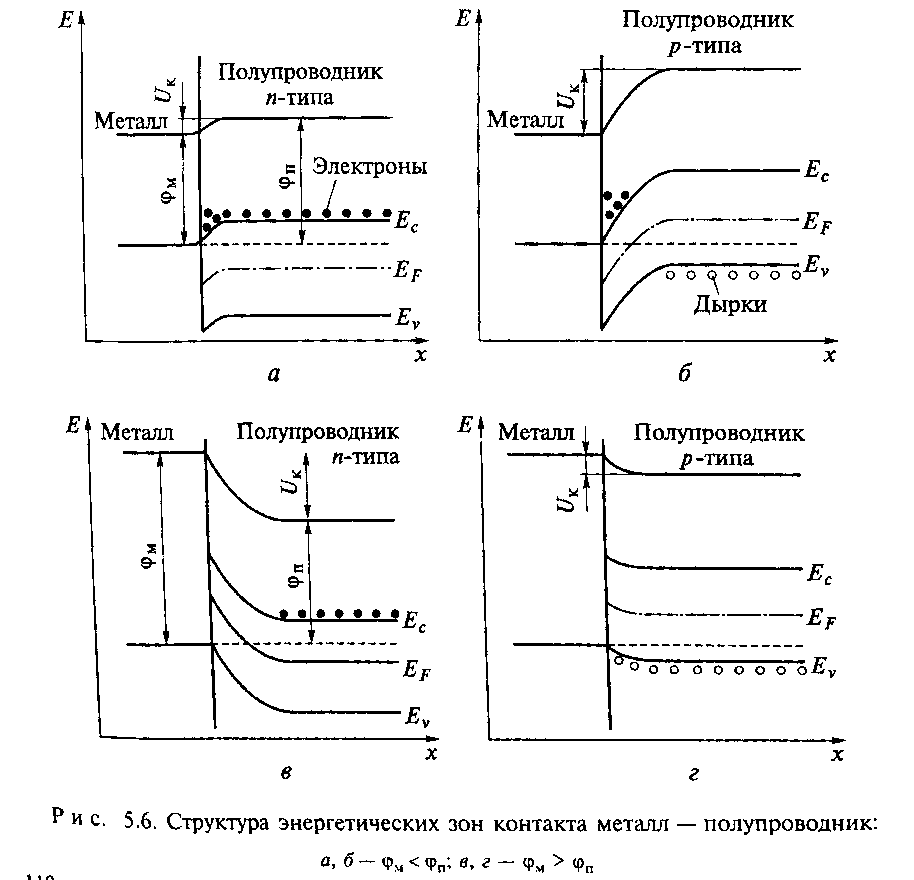
обогащенный (рис. 5.6, г). Контактная разность потенциалов при этом определяется соотношением и = |<рм - срп| /^.
Механизм формирования обедненных слоев заключается в нарушении компенсации зарядов ионизированных примесей основных носителей. Обогащение слоев происходит благодаря накоплению основных носителей. Обогащенный слой обеспечивает малое сопротивление приконтактной области и поэтому не проявляет выпрямляющих свойств. При наличии обедненного слоя или инверсного слоя проявляются выпрямляющие свойства контактов. Такой контакт аналогичен электронно-дырочному переходу. Отличие заключается в том, что в этом случае высота потенциального барьера для электронов и дырок разная.
Приконтактный слой полупроводника характеризуется пониженной удельной проводимостью. Этот слой обогащен неосновными носителями заряда и носит название антизапорного. В этом случае также возникает барьер Шоттки. Такие контакты, как металл-полупроводник, которые обладают выпрямляющими свойствами, называют контактами Шоттки. Для «-Б! барьер Шоттки составляет 0,6...0,8 эВ, для р-$\ — 0,4...0,6 эВ, для я-ваАя примерно
0,8 эВ, а для р-ваАБ примерно 0,6 эВ.
При создании интегральных схем граница раздела полупроводник-диэлектрик играет весьма важную роль. Свойства среды, с которой граничит полупроводник, оказывают определяющее влияние на свойства поверхностного слоя, его кристаллическую структуру, содержание адсорбированных примесей и наличие особых энергетических уровней. Все это влияет на подвижность и время жизни носителей в приповерхностном слое и другие электрофизические параметры.
Главная особенность слоев или пленок диоксида кремния состоит в том, что они всегда содержат примеси донорного типа (натрий, калий, водород), которые имеют тенденцию локализоваться вблизи границы раздела — 5Ю2. В результате на границе с кремнием формируется тонкий слой положительно заряженных донор- ных атомов. Отданные ими электроны переходят в приповерхностный слой кремния. Поверхностная концентрация доноров в двуок- сиде кремния составляет примерно (0,5...2,0) • 10-12 см2. Если пленка 8Ю2 находится на поверхности я-типа Б!, то приповерхностный слой обогащается электронами и у границы раздела образуется я-канал.
Если кремний обладает проводимостью /?-типа, то электроны, диффундировавшие из оксида, могут привести к обеднению приповерхностного слоя вследствие рекомбинации с дырками и обна-
жить отрицательные ионы акцепторов. Возможно образование тон. кого поверхностного я-слоя. Знание структуры границы раздела — 5Ю2 позволяет предотвращать нарушения и дефекты в приборах микроэлектроники.
Контрольные вопросы
1. Что такое полупроводник?
2. Чем определяется электропроводность полупроводников?
3. Что такое процесс термогенерации электронно-дырочных пар?
4. Чем и с какой целью легируются полупроводники?
5. Изложите основные положения зонной теории полупроводников.
6. Что такое уровень Ферми в полупроводниковых структурах?
7. Как определяется коэффициент диффузии?
8. Как охарактеризовать процесс диффузии носителей заряда в полупроводниках?
9. Как охарактеризовать процесс дрейфа носителей заряда в полупроводниках?
10. Чем характеризуется подвижность носителей в полупроводниках?
11. Какими параметрами характеризуется /»-«-переход?
12. Что такое прямое и обратное включение р-л-перехода?
13. Определите понятие диффузионной емкости.
14. Определите понятие барьерной емкости.
15. Что такое гетеропереход? Назовите основные типы гетеропереходов.
16. Какие типы контактов вы знаете?
17. Что такое барьер Шоттки?
ГЛАВА 6
Дата добавления: 2016-06-13; просмотров: 2149;
