ГЛАВА 7 ЭЛЕМЕНТНАЯ БАЗА МИКРОЭЛЕКТРОНИКИ
Микроэлектроника — раздел электроники, в котором на основе физических принципов твердотельной электроники и новых процессах групповой технологии разрабатываются микроэлектронные приборы, интегральные схемы и системы на кристалле.
Интегральная схема (Integrated circuit, IC, microcircuit, microchip, J
silicon chip) представляет собой микроэлектронное устройство, из- 1
готовленное на полупроводниковом кристалле и помещенное в неразборный герметичный корпус. }
Основной тенденцией в развитии микроэлектроники является J
рост степени интеграции приборов на одном кристалле интегральной схемы и расширение их функциональных возможностей (рис. 7.1). э
Один из основателей фирмы «Intel» Гордон Мур высказал предпо- 3
ложение о том, что число транзисторов на кристалле будет удваи- 3
ваться каждые два года. Это эмпирическое предположение вскоре э
получило название закон Мура и стало на десятилетия ориентиром для инженеров и исследователей. Если в 1980 г. стояла задача достижения технологической нормы производства микропроцессоров в 1 мкм, то в 1990 гг. встала задача внедрить технологическую нор- му в 0,1 мкм. В первой декаде XXI в. ищут пути преодоления барь- ера в 0,01 мкм. Полагают, что закон Мура будет действовать еще не одно десятилетие.
Интегральные схемы в основном производят по планарной тех- нологии, в соответствии с которой формирование их структур производится с одной стороны полупроводниковой подложки. С ЭТОЙ ^
целью в прецизионных технологических процессах в приповерхно- ^
стном эпитаксиальном слое монокристаллической пластины созда- ^
ют локальные области с заданным типом проводимости. Эта техно- Тц
Рис. 7.1. Годовой рост числа транзисторов в микропроцессорах фирмы «.Intel»
логия получила название эпитаксиально-планарной и является основой производства интегральных схем.
По физическому принципу работы интегральные транзисторы условно можно разделить на три основных класса: униполярные (полевые); биполярные; квазипланарные транзисторные структуры.
В униполярных транзисторах физические процессы протекания электрического тока в полупроводнике обусловлены носителями заряда одного знака — электронами или дырками. Основным физическим процессом перемещения носителей является дрейф в электрическом поле.
В биполярных транзисторах физические процессы обусловлены переносом носителей заряда обоих знаков. В основе работы лежат процессы инжекции неосновных носителей, диффузии и дрейфа основных и неосновных носителей тока. В настоящее время известно большое число различных типов транзисторов. На основе интегральных транзисторов формируют различные пассивные и ак- вные элементы: емкости, резисторы, диоды, транзисторы.
К квазипланарным транзисторным структурам отнесем транзи- рные структуры, которые могут иметь объемную структуру вне Дложки, использующие различные физические явления в полу- оводниках. К таким структурам отнесем, например: транзисторы па Terahertz; транзисторы с проницаемой базой; баллистические
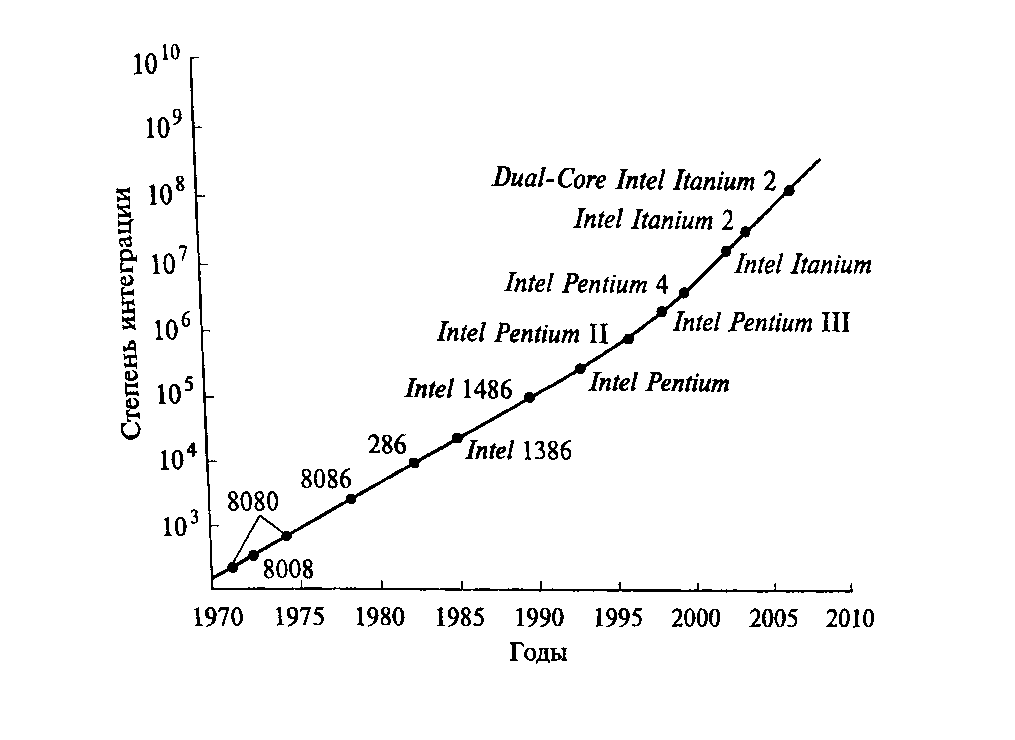
транзисторы; МОП-транзисторы с управляемой проводимостью канала; МОП-транзисторы с двойным затвором.
В рамках данного курса микроэлектроники будут рассматриваться интегральные транзисторные структуры, применяемые в интегральных схемах различных типов.
7.1. Интегральные униполярные транзисторы
Транзисторы с изолированным затвором — это полевые, или униполярные, планарные транзисторы, в которых управление происходит под действием электрического поля, перпендикулярного току.
На рис. 7.2 приведена конструкция полевого транзистора с изолированным затвором. Проводящий слой, по которому протекает ток, называют каналом.
Различают р- и «-канальные транзисторы. Каналы могут быть приповерхностными и объемными, горизонтальными и вертикальными.
Транзисторы с приповерхностным каналом имеют структуру металл — диэлектрик — полупроводник (МДП). Такие транзисторы принято называть МДП-транзисторами. Если диэлектриком является диоксид кремния 8102, то это МОП-транзисторы. В свою очередь, приповерхностные каналы делятся на обогащенные или обедненные носителями заряда либо инверсионные слои. Их формирует внешнее электрическое поле. Обедненные каналы — участки однородного полупроводника, отделенные от поверхности обедненным слоем. МДП-транзистор с индуцированным каналом имеет три электрода: исток, сток и затвор (см. рис. 7.2). Исток и сток формируют методом диффузии или методом ионной имплантации.
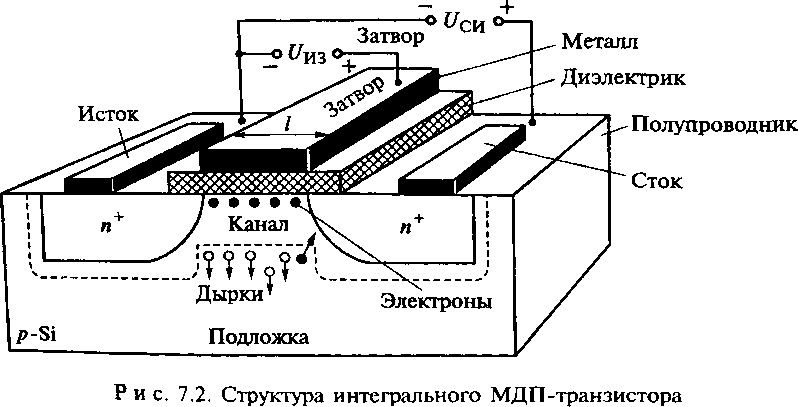
авляюшим электродом является затвор — металлический элек- од перекрывающий канал между истоком и стоком. Иногда ис- |ок напрямую замыкают на электрод подложки.
Если на электроды подан нулевой потенциал, то вблизи /^-областей истока и стока имеются области объемного заряда, возникающие за счет разности работ выхода электронов из полупроводника с различными типами электропроводности. Между истоком и стоком при 11т ~ 0 существует большое сопротивление, эквивалентное сопротивлению двух встречно включенных диодов при нулевом смещении, поэтому при подаче напряжения Ьси ток во внешней цепи будет мал. Если на затвор подать отрицательное напряжение, то приповерхностный слой обогатится дырками, но это не изменит ток во внешней цепи.
Если на затвор подать положительное напряжение иш >0, то под действием электрического поля основные носители (дырки) «отожмутся» полем в глубь полупроводника (эффект поля). В полупроводниках эффектом поля называют изменение концентрации свободных носителей заряда в приповерхностном слое под действием внешнего электрического поля, перпендикулярного каналу. Сначала образуется обедненный слой (объемный заряд акцепторов), куда устремляются неосновные носители — электроны. У самой поверхности границы раздела полупроводник — диэлектрик, электроны образуют инверсионный слой — проводящий канал. Это произойдет тогда, когда концентрация неосновных носителей (электронов) превысит концентрацию основных. В зависимости от приложенного к затвору потенциала меняется толщина инверсионного слоя. Такой тип канала называют индуцированным. Ток стока резко возрастает и в дальнейшем зависит от напряжения Цсц.
Толщина индуцированного канала зависит от технологии производства транзисторов и обычно лежит в пределах долей нанометра. Напряжение на затворе, при котором образуется канал и транзистор начинает работать, называют пороговым Щ. На рис. 7.3 приведено семейство стоко-затворных вольт-амперных характеристик МДП-транзисторов. Пороговое напряжение ¿70 определяется удельной емкостью затвор — канал, зонной диаграммой металл — диэлектрик — полупроводник. Практические значения полного порогового напряжения лежат в пределах 0,5...1,5 В. Стоково-затворные характеристики транзистора зависят от режима его работы. При напряжении V,си > 0 ток протекает по каналу, создавая распределение потенциала по длине канала от истока к стоку. Разность потенциалов между затвором и поверхностью в направлении стока
10* 147
уменьшается, одновременно уменьшается напряженность поля в диэлектрике и удельный заряд электронов в канале.
В МДП-транзисторе технологическим путем можно создать канал, соединяющий исток со стоком. Такой транзистор получил название — транзистор со встроенным каналом. На стоково-затворной характеристике (см. рис. 7.3) видно, что при нулевом напряжении на затворе по его каналу течет ток и транзистор способен усиливать сигнал. При подаче на затвор отрицательного напряжения ток в канале уменьшается вследствие действия отрицательного поля затвора и при некотором напряжении и0Тс. Это объясняется тем, что при отрицательном напряжении на затворе канал обедняется носителями и, следовательно, ток стока уменьшается. При увеличении напряжения канал обогащается неосновными носителями и ток увеличивается. Выходная характеристика МДП-транзистора имеет участок насыщения. На рис. 7.4 приведено семейство выходных характеристик транзистора со встроенным каналом. Примерно такие же формы характеристики у транзистора с индуцированным каналом. На рис. 7.5 приведены условные обозначения транзисторных структур. Тип проводимости канала противоположен типу проводимости подложки. Проводимость подложки обозначается стрелкой: для /ьподложки стрелка направлена к каналу, для «-подложки — от канала.
Комплементарная структура (КМОП) — это сочетание транзисторных структур с каналами п- и /?-типов (рис. 7.6). Отличительной особенностью комплементарных структур является противоположная полярность питающих и управляющих напряжений каждого транзистора. Такая комбинация транзисторов позволяет сочетать высокое быстродействие и предельно малое потребление энергии от источника питания. В зависимости от типа подложки один из транзисторов делают в изолирующем кармане. Создаются также
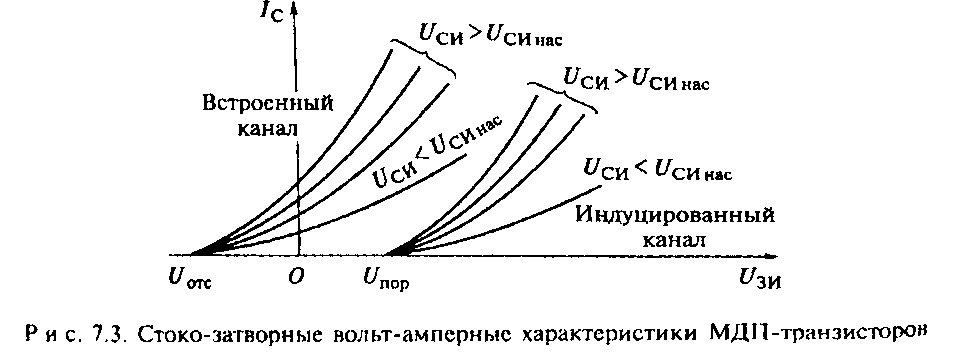
охранные области, позволяющие устранить утечки тока и паразитные связи между МДП-транзисторами. По надежности предпочтение отдается КМОП-транзисторам, которые реализованы на диэлектрической подложке, например на сапфире.
Это позволяет получать транзисторы без токов утечки, с отсутствием паразитных емкостных связей между областями транзистора и подложки. Такая технология позволяет повысить быстродействие транзисторов, создать на их основе радиационно стойкие интегральные схемы так называемые КНС-структуры (кремний на сапфире).
ПТШ-транзистор — это полевой транзистор с управляющим ^-«-переходом с затвором в виде барьера Шоттки (ПТШ) существенно отличается от транзистора с изолированным затвором и составляет отдельный тип транзисторных структур. Такие структуры реализованы на арсениде галлия, имеют высокие значения подвижности электронов в слабых электрических полях и скорости насыщения в сильных полях, а также большую ширину запрещенной зоны. Это приводит к высокому удельному сопротивлению нелегированного арсенида галлия, который имеет проводимость р-типа. На основе нелегированного арсенида галлия создают полуизоли- рующие подложки микросхем.
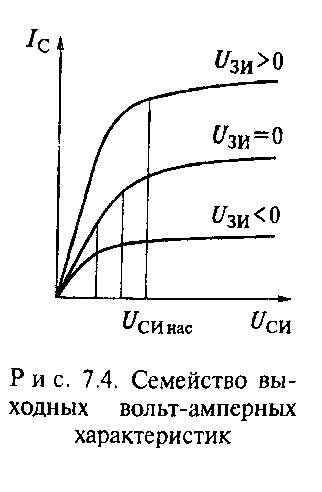

Рис. 7.6. Комплементарные п+-р-п+- и /?+-л-/?+-транзисторные структуры
На основе арсенида галлия изготавляют полевой транзистор с затвором в виде барьера Шоттки (ПТШ) или, как его еще называют, с управляющим переходом металл — полупроводник, МЕП-транзи- стор. Методом ионного легирования кремнием, серой или селеном формируют сильнолегированные области истока и стока я+-типа, а затем напыляют сплав Т\ — W. Остальная поверхность покрывается диэлектриком, например 5Ю2 (рис. 7.7, а). Металлический электрод затвора образует с каналом барьер Шоттки, типичная равновесная высота которого равна 0,8 В. Проводящий канал расположен между истоком и стоком и ограничен сверху обедненной областью. При изменении положительного напряжения на затворе %з толщина проводящего канала уменьшается. Одновременно меняется его проводимость и ток стока /с. На сток при этом подается положительный потенциал относительно стока.
Пороговое напряжение соответствует моменту, когда граница обедненного слоя достигает полуизолирующей подложки, канал перекрывается и ток стока равен нулю (рис. 7.7, б, кривая /). При малой толщине канала ¿/0 пороговое напряжение может быть положительным. Значения порогового напряжения лежат в пределах от -2,5В (¿/ПОр1) до +0,2В (ип0Р2).

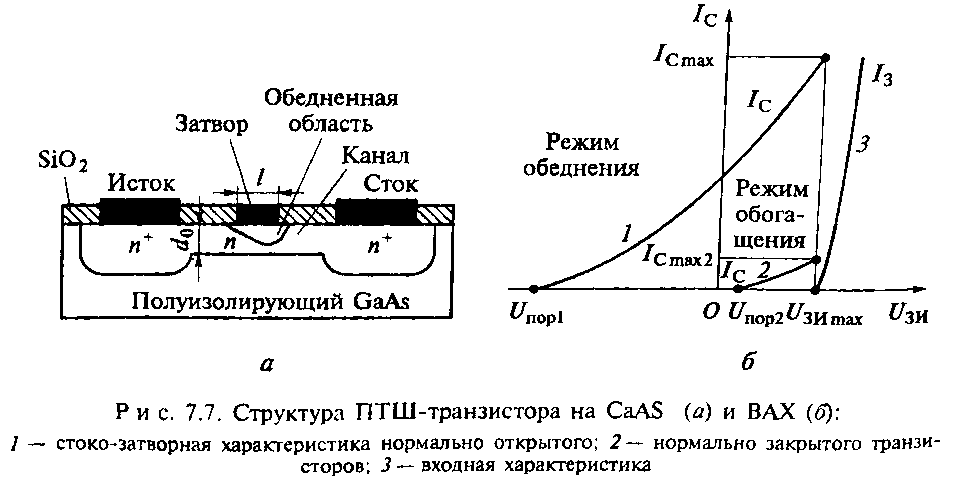
Если пороговое напряжение отрицательно, то при ит = 0 канал является проводящим и транзистор называют нормально открытым (рис. 7.7, б, кривая 1). Такой транзистор аналогичен МОП- транзистору со встроенным каналом.
Если пороговое напряжение и0 > 0, то канал перекрыт обедненным слоем и транзистор называют нормально закрытым, что аналогично МДП-транзистору с индуцированным каналом (рис. 7.7, б, кривая 2). При больших положительных напряжениях на затворе в его цепи может возникнуть паразитный ток /3 (рис. 7.7, б, кривая 3). Это обусловлено открытием перехода металл — полупроводник. Поэтому ток стока ограничивается значением /с тах.
Полевой транзистор на гетероструктурах. Комбинации различных гетеропереходов представляют собой гетероструктуры. Гетеропереход — это полупроводниковый переход между двумя разнородными по химическому составу или фазовому состоянию полупроводниками. Гетеропереходы формируют в объеме одного полупроводникового кристалла. Анизотипные переходы предусматривают контакт полупроводников с электронной и донорным типами проводимости. Изотипные переходы возникают при контакте полупроводников с одним типом проводимости.
На границе гетероперехода происходит скачкообразное изменение таких свойств, как: ширина запрещенной зоны; подвижность носителей заряда; эффективная масса носителей; энергия сродства к электрону и др.
Энергетическая диаграмма гетеропереходов характеризуется скачками энергии в зоне проводимости и валентной зоне. Высота потенциальных барьеров в них различна. В частности, в таких структурах возможно получение односторонней инжекции носители. На рис. 5.5 приведены зонные диаграммы гетеропереходов ^ипа Р~п И п-Р.
^ Широко распространены гетеропереходы между арсенидом гал- и арсенидом галлия — алюминия С а Аз — А^ва^Ая (х показы- ет содержание алюминия), поэтому с ростом х увеличивается Ирина запрещенной зоны данного твердого раствора. Для типич- 010 значения х = 0,3 ширина запрещенной зоны твердого раство- а А10 3Сао,7А5 равна 1,8 эВ.
У границы раздела двух полупроводников в зоне проводимости южет образоваться квантовый колодец, или зона двумерного электронного газа.
| Двумерный электронный газ, или 2/)-газ, представляет собой [систему электронов, энергетические состояния которых соответствуют свободному движению только вдоль определенной плоскости.
Важным свойством двумерного электронного газа является то, чт0 возможно регулирование в широких пределах плотности Электра нов под воздействием поперечного электрического поля. Электро. ны в ДЭГ имеют повышенную эффективную концентрацию и подвижность.
На основе таких гетероструктур изготовляют гетеротранзисторы. Эта конструкция многослойна (рис. 7.8). Между металлическим затвором и легированным слоем на основе А1о,зСа0,7А8 формируется управляющий переход металл — полупроводник. Обедненная область этого перехода располагается в слоях арсенида галлия — алюминия. Различают нормально открытый (рис. 7.8, а) и нормально закрытый транзистор (рис. 7.8, б). При Vиз < 0 в слое нелегированного арсенида галлия на границе с гетеропереходом в области ДЭГ формируется канал нормально открытого транзистора. На рис. 7.8, а эта область ограничена штриховой линией.
Под действием управляющего напряжения £/из изменяется толщина обедненной области перехода металл — полупроводник, концентрация электронов в области ДЭГ и ток стока. Электроны в ДЭГ поступают из истока. При отрицательном напряжении затвор — исток, равного пороговому значению, обедненная область расширяется настолько, что перекрывает поток электронов, и ток стока становится равным нулю. В нормально закрытом транзисторе
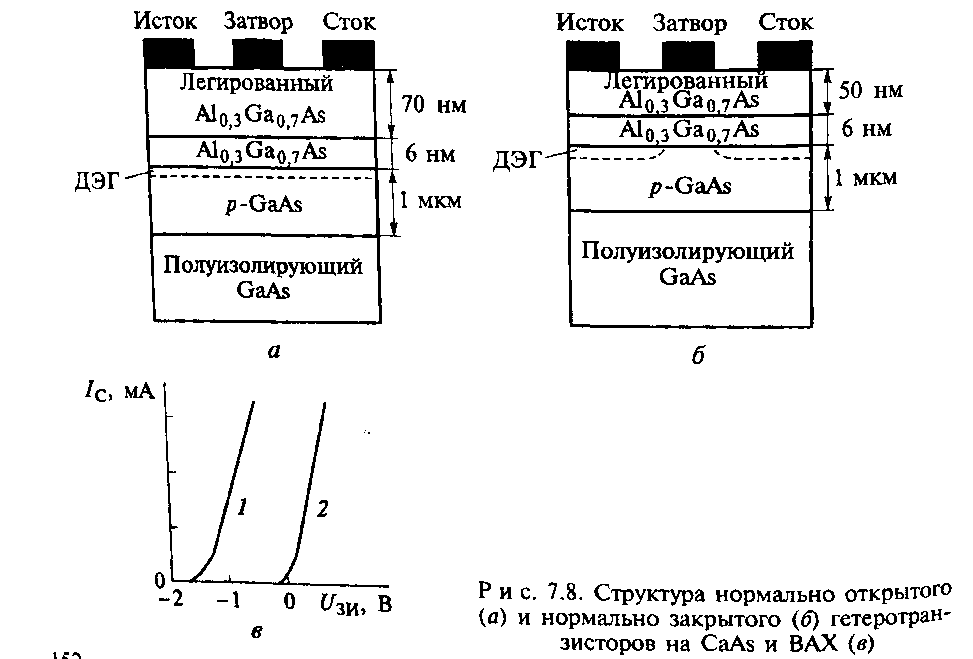
при í/из = 0 проводящий канал отсутствует вследствие того, что область ДЭГ двумерного электронного газа перекрыта объединенной областью управляющего перехода. При подаче напряжения Um > О, равного пороговому значению, обедненная область управляющего перехода сужается настолько, что ее нижняя граница попадает в область ДЭГ.
На рис. 7.8, в приведены стоково-затворные характеристики нормального открытого 1 и нормального закрытого 2 транзисторов. Большое значение крутизны для нормально закрытого транзистора обусловлено меньшей толщиной легированного донорами слоя AlGaAs. Этот тип транзисторов перспективен для использования в СВЧ-микросхемах.
#£МТ-транзисторы (High Electron Mobility Transistor). В основе работы транзисторов лежит идея использования квантового колодца в качестве канала. В квантовом колодце формируется двумерный электронный газ. За счет потери одной степени свободы подвижность носителей увеличивается примерно вдвое, возрастает и эффективная концентрация носителей.
Гетеропереход формируют из широкозонного полупроводника AlxGai_xAs и более узкозонного /-GaAs. На их границе происходит разрыв энергетического уровня Ес примерно на АЕС = 0,38 эВ. В качестве подзатворного диэлектрика используют широкозонный полупроводник AlGaAs, который вследствие искривления энергетических зон становится обедненным электронами (рис. 7.9, а). Канал представляет собой потенциальную яму, образованную в узкозонном проводнике на границе с более широкозонным. В этом канале речь идет о поверхностной плотности электронов, которая составляет примерно 2 • 1012 см-2.
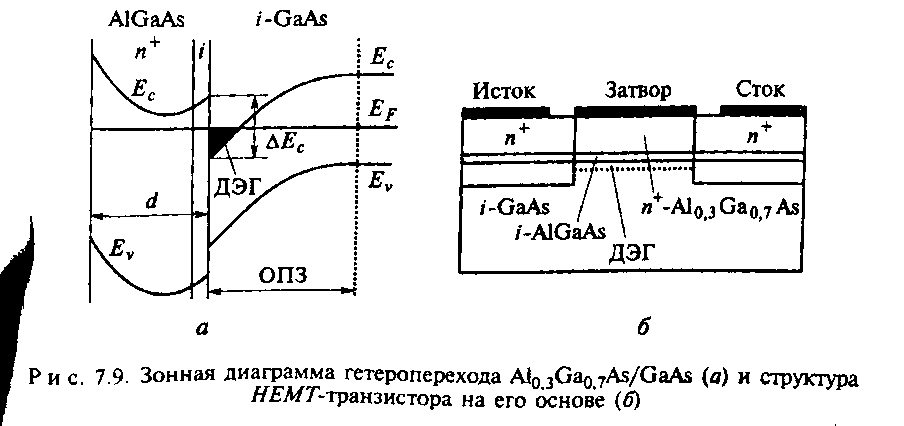
Конструкция НЕМ Г-транзистора представлена на рис. 7.9, б. За более чем четвертьвековую историю НЕМТ-транзисторы развились в большое семейство. Помимо соединений AInBv весьма перспективными оказались соединения InGaAs, InGaP, InAlAs, InP. Соединения на основе индия отличаются высокой подвижностью электронов, разрыв зоны проводимости АЕС достигает 0,5 эВ. Разработаны п- и /^-канальные НЕМТ-транзисторы, для которых, например, создается потенциальная яма для дырок в узкозонном слое InGaP.
Для использования в мощных СВЧ-устройствах, работы в экстремальных условиях разработаны #/ГЛ/У-транзисторы на основе GaN и SiC. Обычно канал у таких транзисторов формируют в узкозонном слое AlGaN. По частотным и усилительным свойствам #£А7Т-транзисторы на основе AlGaN/GaN уступают транзисторам на соединениях AlGaAs/GaAs, однако превосходят их по плотности снимаемого тока, мощности и рабочим напряжением исток — стока.
V-МДП-транзисторы. Рассмотренные структуры имеют планарную конструкцию, ток носителей в которых переносится в горизонтальном направлении. Транзисторы типа К-МДП (Verticals Replacement-Gate-VRG) относятся к типу транзисторов с вертикальным токопереносом — от расположенного в подложке истока к верхнему стоку.
Этот тип транзисторов изготовляют с помощью селективного травления в исходной структуре кремния К-образных канавок (рис. 7.10). V-МДП-структура является весьма компактной. Истоковая область играет роль шины земли и не требует дополнительной площади кристалла для заземления. Проводящий канал образуется в р-слое, его длина определяется микронными размерами, а ширина всем периметром F-образного углубления. Ббльшая ширина канала позволяет получить транзисторы с ббльшим током и ббльшим усиле-
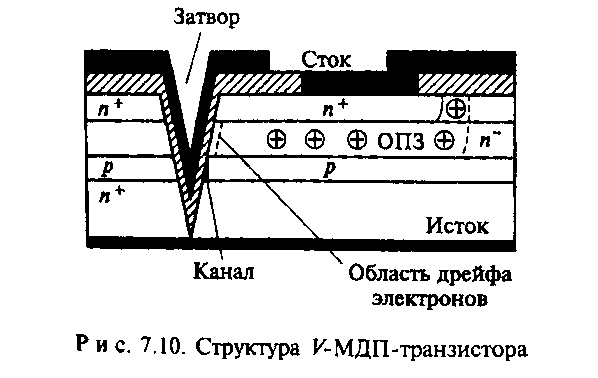
ем. Область объемного пространственного заряда (ОПЗ) позволяет увеличить пробивное напряжение транзистора и снизить значение паразитной емкости затвор — сток.
Разработанные вертикальные полевые транзисторы на основе ваМ имеют ряд преимуществ по сравнению с кремниевыми. Эти преимущества связаны с более высокой подвижностью и дрейфовой скоростью носителей, а также с возможностью использования гетеропереходов для инжекции электронов в активную область транзистора. Такие транзисторы имеют короткий канал, высокое быстродействие, малую потребляющую мощность. Этот тип транзисторов может стать основой разработок схем с высокой плотностью упаковки.
Трехмерность К-МДП-транзисторов является большим плюсом при создании объемных интегральных схем с высокой плотностью упаковки на кристалле.
7.2. Интегральные биполярные транзисторы
Эпитаксиально-планарный транзистор. Электронный прибор с тремя электродами и чередующимися полупроводниковыми областями электронного или дырочного типа проводимости, в котором протекание тока обусловлено носителями заряда обоих знаков, называют биполярным транзистором.
В основе работы биполярного транзистора лежат физические явления диффузии вследствие градиента концентрации и дрейфа носителей вследствие градиента электрического потенциала. Полный ток носителей состоит из диффузионной и дрейфовой составляющих. Различают биполярные транзисторы р-п~р- и я-/?-я-типов. Классическая конструкция биполярного транзистора, используе- Мая в интегральных схемах, выполняется по эпитаксиально-пла- НаРН0й технологии. Это означает, что транзистор выполняется в 1итаксиальном слое толщиной \Уэп, а выводы от эмиттерной, ба- вой и коллекторных областей расположены в одной плоскости на верхи ости подложки. Такая технология позволяет производить анзисторные структуры с высоким процентом выхода годных, а анарность выводов позволяет создать автоматизированную сис- МУ коммутации транзистора с другими элементами микросхемы с ^мощью пленочных металлических проводников.
Одним из важных требований, предъявляемым к технологии Изготовления транзисторных структур, является минимизация занимаемой площади, что позволяет повысить плотность упаковки Цементов интегральной схемы и способствует повышению степе-
пи интеграции на пластине. На рис. 7.11, а приведена классическая структура эпитаксиально-планарного транзистора с изоляцией /¿-«-переходом. Транзистор выполнен на высокоомной подложке р-типа. Диффузиями примесей через маску получены скрытый слой, п-, р- и я+-области. В данной конструкции транзистора используют изоляцию р-п-переходами: сбоку изолирующими областями, а снизу — скрытым слоем. Недостатком изоляции р-п-переходами является наличие барьерной емкости, которая снижает граничную частоту и увеличивает задержку переключения сигнала. Под эмиттерной областью расположена активная область транзистора, представляющая собой я+-/ь/?-структуру. Процессы диффузии и дрейфа носителей в этой области и определяют эффективность работы транзистора. Основные физические процессы, происходящие в этой активной области, идентичны процессам, рассмотренным в дискретном транзисторе (см. 6.2).
Биполярный эпитаксиально-планарный транзистор п+-р-п-типа является одним из основных элементов интегральных схем (см. рис. 7.11, а). По техническим параметрам он превосходит транзистор р-п-р-типа. Минимальные горизонтальные размеры транзистора определяются прежде всего топологическими нормами литографического процесса и глубиной боковой диффузии примеси под оксид. Топология транзистора может быть асимметричной и симметричной, при которой базовые и коллекторные электроды симметрично облегают эмиттер.
Коллектор
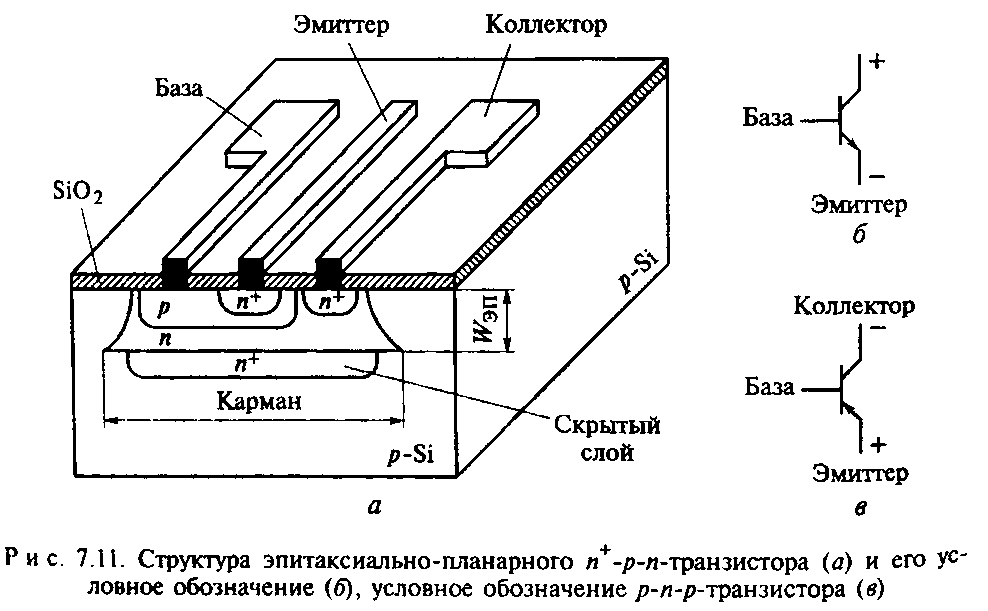
При проектировании транзисторов большой мощности следует обеспечить максимальное отношение периметра эмиттера к его площади. С этой целью создают гребенчатые конструкции, позволяющие создать узкие эмиттеры с большим периметром. Характеристики транзистора зависят от частоты сигнала, структуры транзистора и наличия в ней паразитных элементов. Транзисторы п-р-п-типа имеют более высокую предельную частоту, чем р-й-/>-транзисторы.
Многоэмиттерные и многоколлекторные транзисторы. Широко используют в микросхемах многоэмиттерный биполярный транзистор (МЭТ). Число эмиттеров в них составляет 2...8. Поэтому МЭТ можно рассматривать как совокупность транзисторов с общей базой и соединенными коллекторами (рис. 7.12, а). Каждая пара смежных эмиттеров вместе с /ьслоем образуют горизонтальные транзисторные структуры п+-р-п+-шш. При этом, если на одном из эмиттеров действует прямое напряжение, то на соседнем обратное. В этом случае первый будет инжектировать носители заряда, а соседние будут их собирать. Это паразитный транзисторный эффект. Для подавления «паразитных» транзисторов п+-р-п+-типа расстояния между соседними эмиттерами должны быть больше диффузионной длины носителей в базовом слое (около 10 мкм).
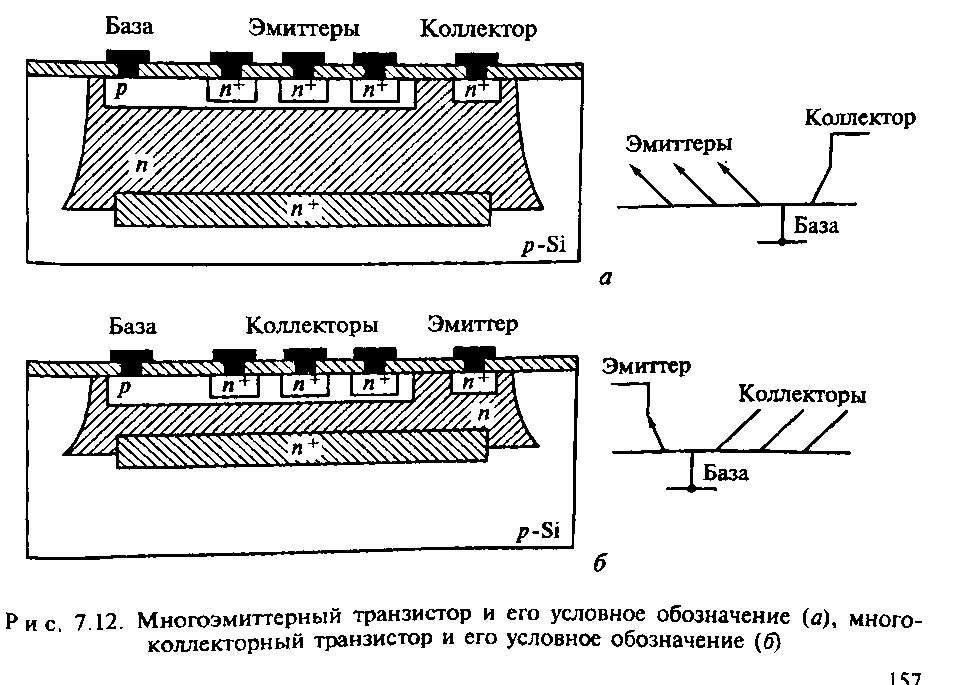
Основная область применения МЭТ лежит в области цифровых микросхем, например в логических интегральных схемах семейства ТТЛ и ТТЛШ.
Многоколлекторный биполярный транзистор (МКТ) представлен на рис. 7.12, в. Он представляет собой транзистор, работающий в инверсном режиме. Под инверсным режимом будем понимать режим, при котором полярность смещений на эмиттерном и коллекторном переходах меняется на противоположную. В этом случае большая часть неосновных носителей заряда, инжектированных коллектором, не достигает эмиттерного перехода, поскольку площадь коллекторного перехода значительно больше площади эмиттерного перехода. Общим эмиттером служит общий эпитаксиальный слой, а коллектором является сильно легированные небольшие области пГ.
При конструировании МКТ основное внимание уделяют обеспечению высокого коэффициента передачи тока от общего эмиттера к каждому из я+-коллекторов. Коэффициент передачи тока базы по каждому из «-коллекторов примерно в п раз меньше, чем в одноколлекторном транзисторе. Поэтому скрытый слой максимально приближают к базовому слою, а я+-области располагают близко друг к другу. Условное обозначение этого класса транзисторов приведено на рис. 7.12. Транзисторы этого типа широко применяют в интегральных схемах интегральной инжекционной логики (ИЛ), транзисторно-транзисторной логики (ТТЛ).
Транзисторные структуры интегрально-инжекционной логики. Появление весьма эффективной интегрально-инжекционной логики (И2Л) способствовало разработке биполярного транзистора со встроенным инжектором (рис. 7.13, а). Транзисторы с инжектором состоят из горизонтального транзистора Т\ р-п-р-тш\г., выполняющего функции генератора тока, и вертикального транзистора тока 7г п-р-п-типа, выполняющего функции инвертора.
Оба транзистора реализованы в одном кристалле так, что базовая область транзистора Т\ совмещена с эмиттерной областью транзистора Т2, а коллекторная область Т\ совмещается с базовой областью Т2. Эмиттерную область Т\ называют инжектором носителей, она подключена к источнику питания. Транзистор Т\ может быть многоэмиттерным, а транзистор Т2 всегда является многоколлекторным, электроды которого являются логическими выходами- Условное обозначение транзисторов типа И2Л приведено на рис. 7.13, б. Транзисторы этого типа имеют низкое напряжение питания, обладают небольшой работой переключения, позволяют на их основе создавать схемы с высокой степенью интеграции. Глав-
Рис. 7.13. Структура биполярного транзистора для И Л (а) и условное обозначение (Я)
ный недостаток таких транзисторов — низкое быстродействие, обусловленное процессами рассасывания зарядов неравновесных основных носителей в режиме насыщения. Это и заряды дырок и эмиттерной области, и заряды электронов в базе.
Заметим, что транзистор с инжекционным питанием для совмещенных транзисторных структур является интересным инженерным решением.
Транзистор с барьером Шоттки. В радиотехнике известен инже нерный прием: чтобы предотвратить насыщение биполярного транзистора, необходимо между базой и коллектором включить Диод. В микроэлектронике инженеры нашли изящный способ избежать режима насыщения транзистора. С этой целью в структуру транзистора на границе базовой и коллекторной областей «вмонтирован» диод Шоттки (рис. 7.14). Когда транзистор заперт или работает в активном режиме, потенциал коллектора положителен относительно базы. В этом случае диод находится под обратным смещением и не влияет на работу транзистора. Если потенциал коллектора становится отрицательным относительно базы, то диод отпирайся и на нем падает прямое напряжение порядка 0,5 В. Коллек- торный переход запирается и исключается накопление избыточно- г° заряда.
На рис. 7.14, а приведена схема встраивания диода Шоттки в |анзисторную структуру. Условное обозначение транзистора с [одом Шоттки приведено на рис. 7.14, б. Конструктивно диод (оттки представляет собой несколько расширенный электрод 1ы, частично перекрывающий область коллектора. Такие транзиты отличаются высоким быстродействием. Транзисторы с дио- Шоттки широко используют при конструировании интеграль- *х логических схем с высоким быстродействием (ТТЛШ). Разра- гана интегральная Шоттки-логика на основе транзисторов с дио-
1и Шоттки.
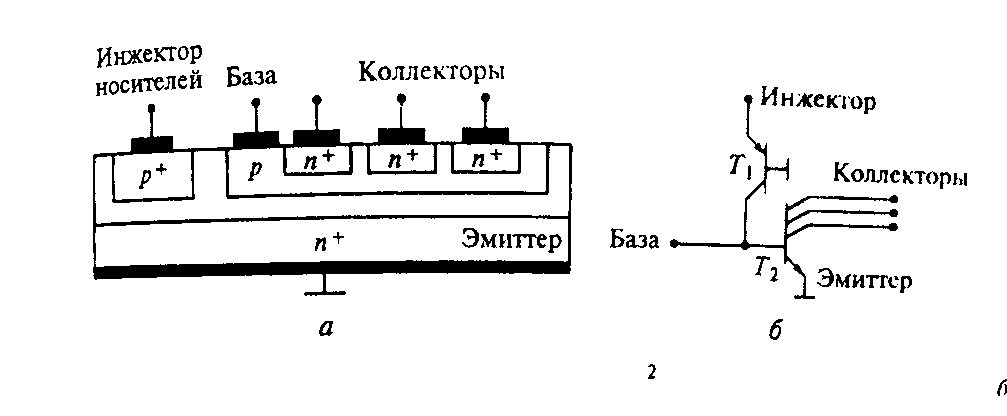
Диод Шотгки а о
Рис. 7.14. Структура транзистора с диодом Шоттки (а) и его условное обозначение (б)
7.3. Квазипланарные транзисторные структуры
Проблемы перехода от микро- к нанотранзисторным структурам. Основная тенденция развития микроэлектроники заключается в увеличении степени интеграции, соответственно уменьшении линейных размеров структур и энергопотребления, но в увеличении надежности. Идет интенсивный поиск новых конструктивных решений транзисторных структур, переход из микро- в нанометро- вый диапазон размеров. Появились первые действующие прототипы нанотранзисторов.
Если первые транзисторы имели характерный сантиметровый размер, то за полвека транзистор уменьшился примерно в 100 ООО раз по линейному размеру и в 1010 раз — по массе. Количественные превращениями приводят к существенным изменениям качества, так как устройства переключения электрических сигналов достигают минимально возможных размеров, обусловленных атомной структурой вещества. Меняются и свойства самих электрических сигналов в наномире. Электрический ток в наномире нельзя интерпретировать в виде некоего подобия электрической жидкости или электронного газа, протекающих через транзистор-вентиль. В наномире квантованность электрического заряда выходит на первый план. Электрический заряд, которым можно манипулировать, кратен заряду электрона д. Как бы точно ни производилось измерение электрического тока, количество информации, которое можно передать с его помощью, строго ограничено и определено числом переданных элементарных зарядов.
Логические элементы срабатывают на определенный зарядовый пакет. Возникнут сбои, если пакет окажется недостаточно велик. Так, при кодировании логической единицы пакетом из десяти элементарных зарядов с порогом срабатывания в пять зарядов логический элемент будет неправильно срабатывать примерно в 3 % случаев. В процессе уменьшения длины канала и соответственно дли- 160
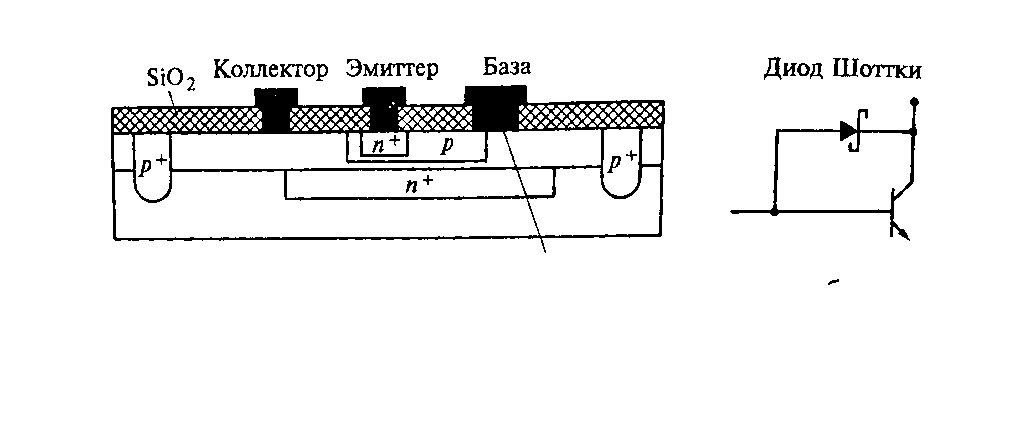
ны затвора достигнуто значение порядка 100 нм, а толщина подза- творного оксида в схемах микропроцессоров ныне составляет 0,8 нм, или три атомных слоя. Это позволило увеличить быстродействие микропроцессоров, снизить потребление энергии. Вместе с тем возросли токи утечки, в том числе за счет туннельного тока через слой оксида. Причем токи утечки весьма существенны даже для отключенного транзистора. В этой ситуации транзистор постоянно работает в цепи. С уменьшением толщины областей истока — стока возрастает их сопротивление. В таком случае необходимо большее напряжение для переключения транзистора, при этом увеличивается плотность потребляемой мощности. С увеличением напряжения возрастает опасность пробоя слоя диэлектрика из трех атомных слоев. Круг замкнулся. Дальнейшее уменьшение длины канала требует увеличения степени легирования в канале до 1018 см-3. Это приведет к снижению подвижности носителей и росту порога включения транзистора.
Кроме эффекта квантования электрического заряда, на малых расстояниях начинают сказываться волновые свойства частиц. Длина когерентности электронной волны в твердом теле при обычной температуре составляет единицы нанометров. Поэтому на расстояниях, меньших 1 нм, начинают проявляться волновые свойства электронов: когда вещество берется в малых количествах, то не всегда можно однозначно отнести его к изоляторам, проводникам или полупроводникам. Например, некоторые химические элементы, взятые, допустим, по 20, 50 и 100 атомов, будут последовательно проходить стадию изолятора, полупроводника и проводника соответственно. Использование ресурсов вещества, пространства, времени, энергии и информации в наномире строго регламентиру- ется особыми правилами, которые базируются на законах квантовой механики. Конструирование нанотранзисторов превращается в ожную квантово-механическую задачу. «Овеществление» кванто- -механических схем и чертежей требует разработки сложнейших хнологических процессов.
Когда же будет достигнут предел миниатюризации обычной лектроники? Уже сейчас микроэлектронной промышленностью в опытном порядке создаются транзисторы с размером рабочих элементов 5...30 нм. Эта область перехода от классической твердотельной электроники к квантовой получила название области меза- структур. Еще способны работать мезаструктуры с обычными электрическими сигналами, однако при дальнейшем уменьшении размеров очень быстро нарастают проблемы, решить которые весьма затруднительно. В соответствии с законом Мура полное освое-
ние области мезоэлектроники ожидается примерно через 10 лет. Таким образом, мезотранзисторы — это последний рубеж существования обычных транзисторов, за которым последует поколение нанотранзисторов. Разработки транзисторных структур для субмик- ронной технологии следующих поколений на 0,13; 0,10; 0,07 мкм ведется по разным направлениям. Технология нанометрового диапазона будет промышленной технологией на ближайшие полвека.
МОП-транзистор с двумя затворами — транзистор с двумя затворами принципиально новой конструкции. Конструкция ЕтЕЕТ- транзистора представляет собой кремниевое тело (столбик, вставка-/?«), которое обернуто затвором. Конструкция затвора такова, что формируются два самосовмещенных канала с двух сторон кремниевого тела (рис. 7.15). Выступающая передняя область тела представляет собой исток транзистора, а задняя область — сток. Ток течет в плоскости, параллельной плоскости тела. Активная ширина прибора IV равна высоте тела-столбика и может быть увеличена за счет включения нескольких столбиков. Каналы индуцируются напряжением на затворах вдоль обеих сторон пластины. Активная ширина прибора равна высоте тела-плавника. Это тело можно увеличивать путем параллельного включения многих столбиков, формирующих исток и сток. Таким образом, формируют активную область транзистора. Трехмерная конструкция ЕтЕЕТ- транзистора позволяет значительно снизить потери на тепловыделение.
Структура ПпРЕТ аналогична традиционной МОП-структуре, хотя и является квазипланарной. Отличительной особенностью является активная область, которая в данном случае формируется вставками. Высота тела вставки составляет 180 нм, толщина за-

творного диэлектрика — 2,2 нм, поликремниевого затвора — 75 нм. Разработаны симметричные и асимметричные п- и /?-канальные транзисторы с длиной канала примерно 30 нм. Типичный ток в «-канальном транзисторе составляет 1300 мкА/мкм, в ^-канальном — 850 мкА/мкм. Созданы /,ш/г£Т-транзисторы с длиной канала 20 нм, в котором размеры кремниевой вставки определяются промежутками между поликремниевыми затворами, а области истока и стока формируются процессами литографии. Характеристики Яя/^ЕГ-транзисторов позволяют надеяться на их использование в интегральных схемах с увеличенной плотностью упаковки и уменьшенной рассеиваемой мощностью.
Технологический процесс изготовления /гш/г£’7’-транзистора предусматривает формирование, методами литографии плавника-вставки толщиной 20 нм и высотой 180 нм. Области стока-истока изготовляют с помощью ионной имплантации под углом 45° с четырех сторон пластины. Удается создать транзисторы с длиной канала порядка 30 нм. Пороговое напряжение транзистора составляет порядка 0,1 В, управляющий ток не превышает 60 нА/мкм. Пороговое напряжение насыщения составляет 0,15 В при рабочем токе 55 нА/мкм и токе утечки 7 нА/мкм.
Тега tfeffc-транзистор. Транзисторы на основе кремния на изоляторе по-прежнему являются перспективными в микроэлектронике. В таких транзисторах имеется полностью или частично обедненное носителями основание. Вследствие обеднения подложки зарядами электрическое поле в инверсионном слое прибора существенно меньше, чем в обычных приборах с сильнолегированной областью канала.
Структуры с ультратонким основанием изготовлялись по различным технологиям. По одной из них фирма «Intel» создала Тега Hertz-транзистор. Эти транзисторы имели полностью обедненное основание слоя кремния толщиной 30 нм. Для Тега //еп^-транзи- сторов характерны низкая емкость перехода, высокая стойкость к облучению. Этот тип транзисторов обладает высоким быстродейст- ием и низкой потребляемой мощностью. При напряжении 1,3 В абочий ток /^-канального транзистора, например, равен 650 мкА/мкм, ток утечки всего 9 нА/мкм. Приборы с тонкой подложкой имеют значительное паразитное сопротивление. Формирование слоя оксида под всей структурой транзистора позволяет снизить токи утечки на два—четыре порядка в зависимости от типа диэлектрика. Толщина подзатворной пленки составляет три атомных слоя. На рис. 7.16 представлена структура обычного и Тега
Hertz~ транзисторов.
В транзисторных структурах при длине канала порядка 10 нм возможно прямое туннелирование электронов между истоком и стоком. Транзистор можно считать туннельным, ток которого позволяет управлять напряжением на затворе, изменяя высоту барьера. Такие транзисторные структуры вселяют надежду создать на их основе микропроцессоры с топологическими нормами 20 нМ, быстродействием до 20 ГГц и рабочим напряжением 1 В. В чипе микропроцессора будет находиться 109—101 Тега #ег#-транзисторов.
Транзистор с проницаемой базой формируют путем размещения тонкой вольфрамовой сетки внутри арсенид-галлиевого эпитаксиального слоя (рис. 7.17).
Металл образует барьер Шоттки с ваАБ, встроенный потенциал которого полностью обедняет ваАБ в местах между полосками сетки. Положительный потенциал на базовом электроде уменьшает ширину обедненного слоя, и между эмиттером и коллектором воз-
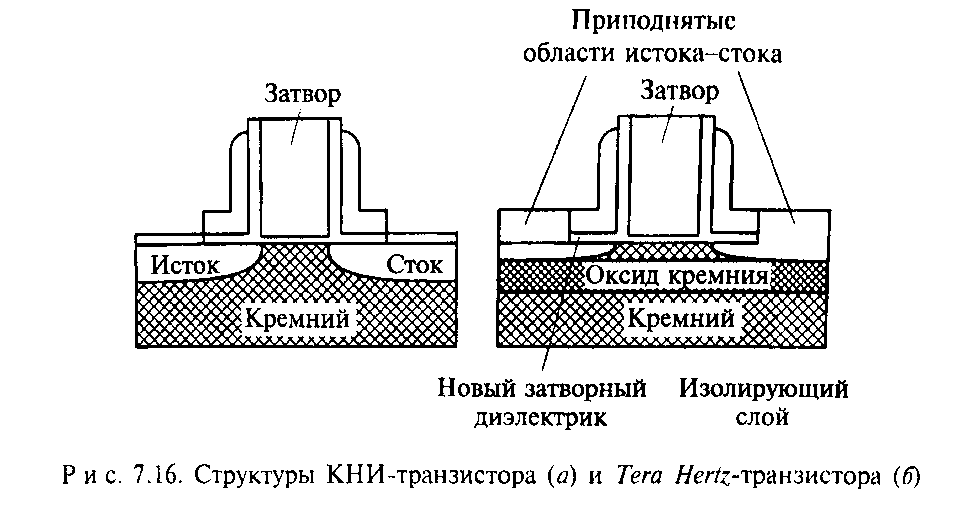
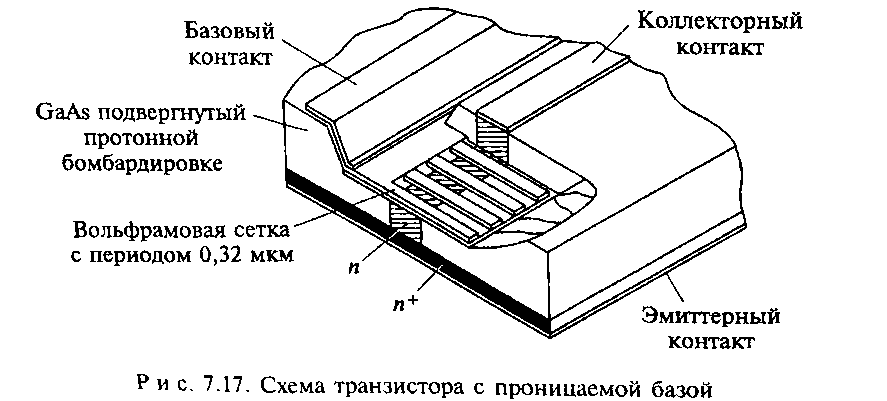
никают проводящие каналы. Электроны движутся от эмиттера к коллектору через окно в сетке транзистора. Такие транзисторы могут работать на частоте до 200 ГГц.
Появление новейших типов нолевых микротранзисторов означает коренное изменение элементной базы электронных устройств. Прогнозы, в том числе следующие из закона Мура, показывают, что к 2010 г. число транзисторов на кристалле СБИС, включая микропроцессоры, превысит 1 млрд ед., что позволит резко расширить функциональные возможности интегральных микросхем.
7.4. Элементная база интегральных схем
Изоляция элементов. Обработку информации в электронике, использующей традиционную дискретную элементную базу, осуществляют схемами различного функционального назначения. В микроэлектронике также исповедуют принципы схемотехнической обработки информации. В качестве элементов схемы используют активные элементы (транзисторы, диоды) и пассивные элементы (диоды, резисторы, конденсаторы).
Элементы интегральных схем (ИС) — неделимые и составные части ИС, которые нельзя автономно специфицировать и поставлять их как отдельные изделия. Отличительная технологическая особенность элементов ИС по сравнению с дискретными приборами, или электрорадиоэлементами, состоит в том, что они органически связаны общей полупроводниковой подложкой и друг с другом. Другой особенностью является то, что транзисторные структуры и пассивные элементы ИС производятся в едином технологическом процессе. При этом номинал элемента (емкость конденсатора, сопротивление резистора) определяется как геометрическими размерами (топологией), так и заданными электрофизическими свойствами. используемых материалов (толщиной диэлектрика, проводимостью полупроводника и т.д.). С другой стороны, геометрические параметры изготовляемых элементов оптимизируются в соответствии с основной тенденцией микроэлектроники — ростом степени интеграции и уменьшением топологических норм.
В этой связи необходимо отметить факт создания принципиально новых элементов, ранее неизвестных в дискретной электронике, таких как многоэмиттерные и многоколлекторные транзисторы, диоды Шоттки, встраиваемые в транзисторную структуру, и т.п.
Компоненты гибридных интегральных схем в отличие от элементов ИС выполняют те же функции, что и элементы, но их можно отдельно сертифицировать и поставлять в виде отдельных изделий, так как они, как правило, навесные детали. Их отличие от дискретных элементов заключается в конструктивном решении (бескорпусные диоды, транзисторы, сборки и т.д.). И еще одна особенность пассивных элементов полупроводниковых (монолитных) ИС: в них отсутствуют аналоги индуктивности, дросселя, трансформатора. Если же встает острая необходимость использования индуктивных элементов, то индуктивный эффект реализуют схемным путем, используя операционные усилители с ЛС-цепями обратной связи, активные фильтры и т.д. В гибридных СВЧ-мик- росхемах широко используют микрополосковые линии и их элементы.
При острой необходимости использования резисторов или конденсаторов больших номиналов используют дискретные миниатюрные элементы, подключая их через специальные выводы интегральных схем.
Транзисторные структуры и элементы интегральных схем, расположенных на одной подложке необходимо изолировать друг от друга, а соединение осуществлять в соответствии с принципиаль
ной схемой, используя металлическую развязку или подложку.
На рис. 7.18 приведены три способа изоляции транзисторных биполярных структур.
Метод изоляции обратносмещенным р-п-переходом базируется на свойстве такого перехода иметь очень высокое удельное сопротивление при обратном смещении. Изоляция /?-л-переходом является однофазным способом, потому что материал по обе стороны и в пределах изолирующего слоя один и тот же. Изоляция р-л-перехо- дом по существу сводится к формированию двух встречно включенных диодов между изолируемыми элементами (рис. 7.18, а). Для того чтобы изолирующие диоды находились под обратным смещением, на подложку подают максимальный отрицательный потенциал от источника питания.
Изоляция р-я-переходом органически вписывается в основной технологический цикл производства кремниевых интегральных схем. Используют изолирующую диффузию, методы тройной диффузии, встречной диффузии. К недостаткам этого способа изоля- \ ции следует отнести наличие обратных токов в р-п-переходах, особенно при повышении температуры, а также наличие барьерных емкостей и необходимостью создания максимального отрицательного напряжения.
Рис. 7.18. Три способа изоляции транзисторных биполярных структур: а — р-и-переходом; б — полная диэлектрическая изоляция; в — комбинированная
Метод изоляции диэлектриком сводится к созданию кармана из диэлектрика, в котором располагается транзисторная структура. Это более совершенный, чем предыдущий метод, прежде всего из-за чрезвычайно малых токов утечки, которые на три—пять порядков меньше обратных токов в ¿»-«-переходах. Увеличивая толщину диэлектрика и выбирая материал с малой диэлектрической проницаемостью, можно снизить и значения паразитных емкостей. На рис. 7.18, б показан один из способов изоляции диэлектриком транзисторных структур. Он получил название КВД — кремний в диэлектрике. Одним из технологических процессов полной диэлектрической изоляции является эпик-процесс, обеспечивающий изоляцию элементов оксидным слоем 5102-
Наибольшее распространение получили процессы, связанные с Изданием транзисторных структур на диэлектрической подложке — кремний на диэлектрике (КНД). В качестве диэлектрической Подложки часто используют сапфир, такой способ изоляции получил название кремний на сапфире (КНС). На сапфировой подложке выращивают эпитаксиальный слой кремния, в котором методом прецизионного травления формируют кремниевые карманы. Карманы снизу изолированы сапфиром, сбоку и сверху — воздухом. В изолированных карманах и размещают транзисторные структуры, которые затем коммутируются пленочной металличе-
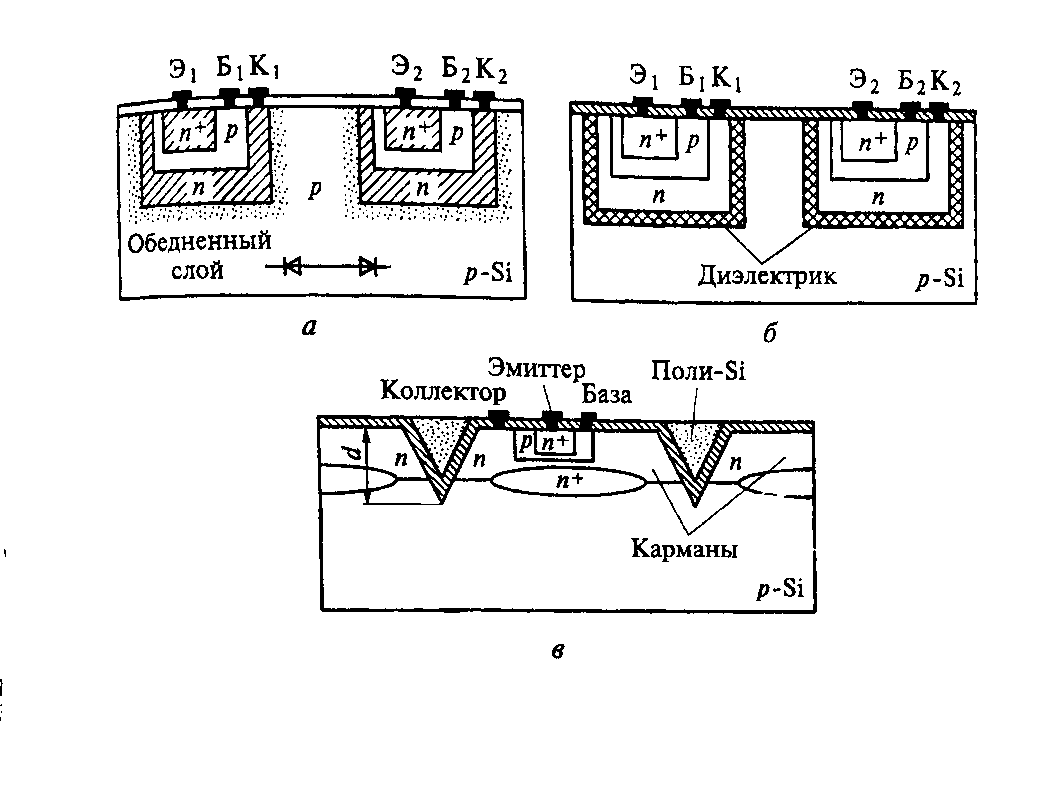
ской разводкой. Изоляцию диэлектриком относят к двухфазному способу, потому что используют одновременно две фазы — диэлектрик и полупроводник. К недостаткам этого способа изоляции следует отнести необходимость совмещения нескольких разнородных технологических процессов, а также непланарность межсоединений.
Комбинированный метод, при котором сочетаются изоляция диэлектриком и изоляция р-п-переходом, является самым распространенным методом изоляции транзисторных структур. Основной технологический процесс — изопланарная технология, в основе которой лежит локальное окисление тонкого эпитаксиального слоя кремния. Результатом этого является образование карманов, которые сбоку изолированы диэлектриком, а от подложек изолируется р-п-переходом. В таких карманах и располагаются транзисторные структуры, а также элементы интегральных схем. В изопланарном процессе для локального прокисления кремния используют маски из нитрида кремния. Этот технологический процесс позволяет обеспечить большую плотность упаковки элементов на кристалле и получить высокие частотные и переходные характеристики транзисторных структур.
Большое распространение получил метод боковой диэлектрической изоляции V-канавками. В этом технологическом процессе вместо сквозного прокисления эпитаксиального слоя используют локальное анизотропное травление поверхности кристалла, ориентированной по плоскости 100. В этом случае травление идет в плоскости 111 так, что грани 111 сходятся ниже границы эпитаксиального слоя. Образовавшиеся К-образные канавки заполняют диоксидом кремния либо поликристаллическим кремнием (рис. 7.18, в). Используя метод реактивного ионного травления, можно уменьшить ширину канавки и превратить ее из V- в ¿/-образную.
Недостатком такого способа изоляции является использование плоскости 100, что сопряжено с повышенной плотностью поверхностных дефектов. К изоляции МДП-транзисторных структур и элементам интегральных схем требования менее жестки в силу физических особенностей их работы. Эти же методы изоляции используют и в униполярных интегральных схемах.
Интегральные диоды. В интегральных микросхемах диоды предназначены для выполнения ряда логических функций, переключения электрических сигналов, выпрямления электрического тока, детектирования сигналов. Любой из />-и-переходов транзисторной структуры, а также их комбинация, могут быть использованы в качестве интегрального диода (рис. 7.19).
Эквивалентные схемы включения транзисторных структур в качестве диодов содержат собственную емкость диода и паразитные емкости, которые оказывают существенное влияние на характеристики диодов.
Пробивные напряжения диодов зависят от типа используемого перехода. Если используется небольшой эмиттерный переход с сильно легированной областью эмиттера, то пробивные напряжения небольшие. Напротив, при использовании протяженного, слаболегированного коллекторного перехода пробивные напряжения достаточно велики. Время восстановления обратного тока /в определяет время переключения диода в открытое или закрытое состояние. Сравнительный анализ параметров биполярных интегральных диодов показывает, что в зависимости от функционального назначения диода можно выбрать нужную структуру.
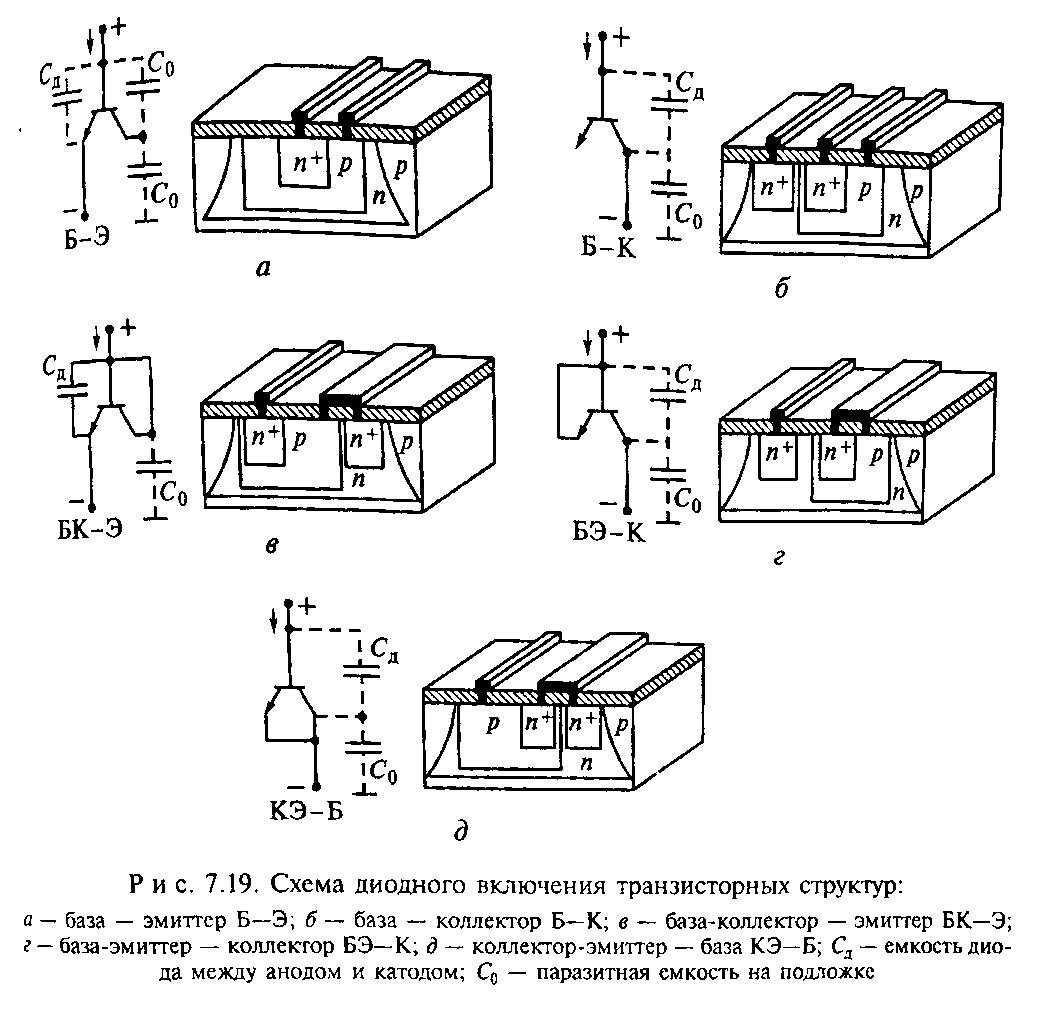
В целом, оптимальным вариантом для интегральных схем являются структуры типа БК—Э на основе перехода база — эмиттер с закороченным на базу коллектором и тип Б—Э на основе перехода база — эмиттер с разомкнутой цепью коллектора.
В интегральных схемах используют интегральные стабилитроны, представляющие собой полупроводниковые диоды с быстрым нарастанием обратного тока при пробое р-п-перехода и нормированным значением пробивного напряжения. Они предназначены для стабилизации напряжения на нагрузке. Интегральные стабилитроны формируют на базе структуры биполярного транзистора в зависимости от необходимого напряжения. Обратное включение перехода база — эмиттер позволяет получить стабилизированное напряжение в пределах 5... 10 В, обратное включение перехода БЭ—К применяют, когда нужно получить стабилизированное напряжение 30...50 В.
Несколько последовательно включенных в прямом направлении диодов типа БК — Э могут быть использованы как источники стабилизированного напряжения, кратного прямому переходу (0,7 В). Температурная чувствительность таких стабилитронов лежит в пределах нескольких милливольт на градус.
В интегральных схемах используют также диоды Шоттки, представляющие собой контакт металла с кремнием, легированный до- норной примесью (менее 1017 см-3).
Интегральные МДП-транзисторные диоды формируют также на базе р-я-переходов транзисторов с индуцированным каналом (рис. 7.20).
Интегральные резисторы представляют собой элемент интегральных схем с заданными электросопротивлениями и топологией, используются в электрических цепях для обеспечения требуемого распределения тока и напряжений между отдельными участками цепи. В монолитных интегральных схемах роль резисторов
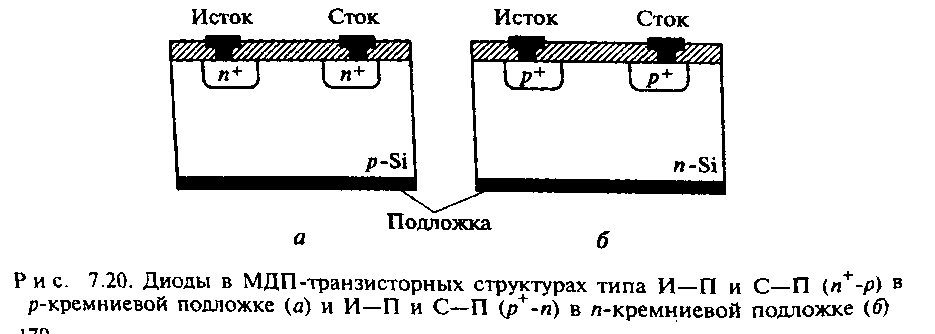
играют участки легированного полупроводника одной из областей транзисторной структуры. В гибридных интегральных схемах используют металлические пленки и пасты.
Интегральные резисторы на биполярных структурах подразделяются на диффузионные резисторы, пит-резисторы, ионно-легированные резисторы, пленочные резисторы на основе поликристамиче- ского кремния (рис. 7.21).
Обычно тело резистора отождествляется с полоской длиной /, шириной b и толщиной d. Если ток протекает параллельно плоскости полоски с удельным сопротивлением материала р, то его сопротивление
R = pl/bd = кфЯ3,
где £ф, 1/Ь — коэффициент формы; R = p/d — удельное сопротивление слоя.
При коэффициенте формы кф < 1 резисторы изготавливают в виде полоски. Если необходимы большие номиналы, то резистор выполняют в виде зигзагообразной конструкции. Максимальное сопротивление диффузионных резисторов не превышает 60 кОм. Таким образом, номинальное значение резистора может быть получено выбором топологических параметров, коэффициентом формы кф или отношением длины I тела резистора к его ширине Ь, а также технологическими параметрами — выбором материала резистора и его толщины.
Диффузионные резисторы изготовляют в эпитаксиальном слое транзисторной структуры. В зависимости от требуемого номинала и точности изготовления диффузионные резисторы могут изготавливаться в эмиттерной, базовой или коллекторной областях. Чаще всего диффузионный резистор формируют в базовой области транзисторной биполярной структуры. Выбор этого слоя является ком-
р (имплантированный) р (диффузионный)
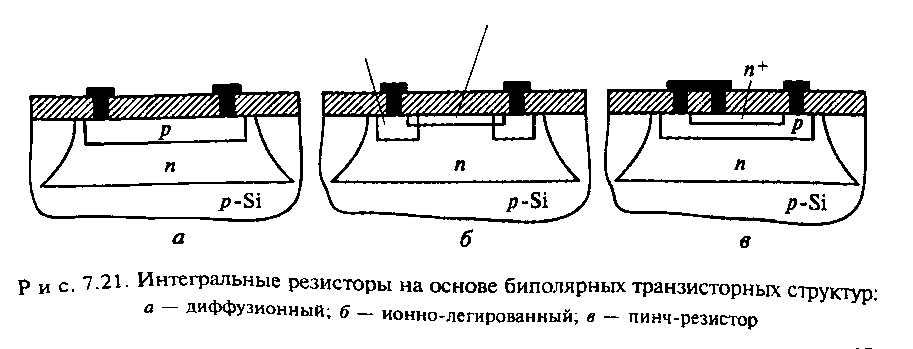
промиссом между большими геометрическими размерами, которые потребовались бы при изготовлении в эмиттерной области, и высоким температурным коэффициентом сопротивления резистора, если бы резистор выполнялся бы в слабо легированной коллекторной области.
В микроэлектронике используют понятие удельного поверхностного сопротивления слоя, или пленки, измеряемое в ом на квадрат (квадрат — безразмерная величина).
Конструкция ионно-легированных резисторов позволяет получить высокие удельные сопротивления. Их структура аналогична диффузионным резисторам. Глубина залегания легированного и резистивного слоев составляет 0,2...0,3 мкм. Поскольку толщина имплантированного слоя мала и к резистивному слою трудно создать омические контакты, формируют диффузионные слои, осуществляющие омический контакт (рис. 7.21, б).
Если необходимые номиналы превышают 60 кОм, используют конструкцию пинч-резистора (рис. 7.21, в). Большое удельное сопротивление достигается за счет использования донной части слаболегированной /^-области. Максимальное сопротивление пинч-резистора может достигать 200...300 кОм при простой полосковой конфигурации. Недостатком пинч-резисторов является большой разброс параметров изготовляемых структур, а также большой температурный коэффициент сопротивления. Структура пинч-резистора сходна со структурой полевого транзистора, и именно этот факт позволяет получить большие значения сопротивления. Эмит- терная сильно легированная низкоомная область позволяет получить сопротивления в несколько ом с температурным коэффициентом 0,01...0,02 %/°С.
Тонкопленочные резисторы применяют в полупроводниковых биполярных интегральных схемах в основном СВЧ-диапазона, а также в схемах на арсениде галлия. Резистивный слой наносится непосредственно на поверхность нелегированной подложки. Преимущество использования тонкопленочные резисторов заключается в простоте технологии изготовления и в возможности лазерной подгонки номиналов. Но технология изготовления не совместима с эпитаксиально-планарной технологией, что является недостатком.
В кремниевых цифровых ИС используют резистивные слои по- ликристаллического кремния толщиной 0,2...0,3 мкм. Такие резисторы размещают над транзисторами, что позволяет уменьшить площадь используемого кристалла.
Интегральные резисторы МДП-транзисторных структур представляют собой, как правило, встроенные или индуцированные между истоком и стоком каналы (рис. 7.22). Номиналы резистора определяются как топологией резистивных структур, так и технологией изготовления. Обычно канал встраивается методом ионной имплантации, по своим свойствам аналогичен ранее рассмотренному ионно-легированному резистору.
Высокие удельные сопротивления могут быть обеспечены конструкцией ионно-легированных резисторов. Их структура аналогична диффузионным резисторам. Глубина залегания легированного и резистивного слоев составляет 0,2...0,3 мкм. Поскольку толщина имплантированного слоя мала и к резистивному слою трудно создать омический контакт, формируют диффузионные слои, осуществляющие омический контакт.
Интегральные конденсаторы представляют собой элементы интегральных схем, состоящие из проводящих электродов (обкладок), разделенных диэлектриком и предназначенные для использования в электрических цепях для обеспечения требуемого распределения тока и напряжения между отдельными элементами цепи. В интегральных схемах роль конденсаторов играют обратносмещенные р-я-переходы, выполненные на основе транзисторной структуры в едином технологическом процессе.
В биполярных транзисторных структурах в конструкции интегрального конденсатора используют один из переходов: эмиттер — база, база — коллектор, коллектор — подложка. Эти переходы формируют диффузией и поэтому часто называют диффузионными конденсаторами. Емкость конденсатора определяется емкостью перехода, имеющего диффузионную и барьерную составляющие. Основную роль играет барьерная емкость. Барьерная емкость связана с образованием области объемного заряда и потенциального барьера между п- и ^-областями перехода. Область объемного заряда р-я-перехода можно интерпретировать как аналог диэлектрика
Исток Сток Исток Сток
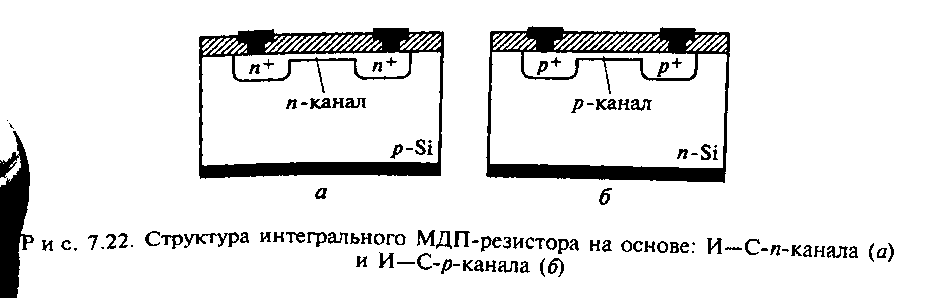
обычного конденсатора вследствии того, что концентрация подвижных носителей зарядов в нем весьма мала. Ширина этой области и плотность объемных зарядов неподвижных ионов донорных и акцепторных примесей зависят от обратного напряжения на /¿-«-переходе. С повышением обратного напряжения ширина области объемного заряда увеличивается, что приводит к уменьшению барьерной емкости, которая может быть определена из соотношения: С = 8805'/хй — х где в — относительная диэлектрическая
проницаемость; е0 — абсолютная диэлектрическая проницаемость; ^ — площадь /?-я-перехода, х„, хр — границы области объемного заряда в материалах п- и /¿-типов.
Барьерная емкость зависит от приложенного внешнего напряжения. При обратном напряжении дырки в /¿-области и электроны в я-области под действием поля уходят от границ перехода. Переход расширяется, перемещение носителей приводит к появлению токов. Переход ведет себя как плоский конденсатор с удельной барьерной емкостью С0 » К(\/Ц)т, где К — коэффициент пропорциональности, зависит от закона распределения концентрации примесных атомов в окрестности /¿-я-перехода; т — коэффициент 1 1\
-> т >- . На рис. 7.23 приведены конструктивные решения инте-
2 3/
гральных конденсаторов, выполненных на основе биполярной структуры.
Наибольшую удельную барьерную емкость С0 имеет переход эмиттер — база (рис. 7.23, а). Низкое пробивное напряжение этого перехода ограничивает возможность его широкого применения. Конденсатор, сформированный на базе перехода база — коллектор (рис. 7.23, б), имеет более высокое пробивное напряжение (примерно 50 В). Обычно используют переход база — коллектор при его низком обратном смещении, но одновременно высоком обратном смещении перехода коллектор — подложка (рис. 7.23, в). В этом случае соотношение СБк/СКп имеет большее значение.

Конденсаторы, сформированные на основе перехода коллек- тор _ подложка, имеют ограниченное применение,' потому что подложка обычно заземлена по переменной составляющей тока. Однако конденсатор этого типа является неотъемлемой частью интегральных схем с изоляцией по /?-л-переходу.
Иногда в интегральных схемах используют комбинированный конденсатор, например, на основе параллельно включенных емкостей эмиттерного и базового переходов. Оптимальной конфигурацией конденсатора является квадрат. Общая емкость складывается из боковой и донной составляющих /ья-перехода. Обычно боковая составляющая в десятки раз меньше донной и ею пренебрегают.
При проектировании интегральных схем задают условие: общая площадь всех конденсаторов интегральной схемы не должна превышать 25 % площади кристалла.
Важным параметром интегрального конденсатора является добротность 0 = 1/2п/СК, где / — рабочая частота; С — емкость конденсатора, К — сопротивление резистора, последовательно включенного с конденсатором. Добротность характеризует потерю мощности при протекании емкостного тока. Добротность возрастает с уменьшением частоты и с уменьшением сопротивления нижних слоев транзисторной структуры. Типичное значение добротности на частоте 500 Гц составляет 50... 100.
Интегральные конденсаторы, сформированные на основе биполярной транзисторной структуры, имеют ряд недостатков. Прежде всего на основе таких структур невозможно создать конденсатор большой емкости. Для этого необходимо использовать большую площадь подложки. Конденсаторы такой конструкции имеют малую добротность, и их емкость существенно зависит от приложенного напряжения.
Недостатки диффузионных конденсаторов могут быть в схеме устранены, если воспользоваться конструкцией МДП-конденсатора (рис. 7.24). Над эмиттерным я+-слоем, служащим нижней обкладкой конденсатора, выращивается тонкий слой кремния БЮ2 (0,05...0,12 мкм), а затем наносится верхняя металлическая обкладка.
Важным достоинством МОП-конденсаторов является возможность их работы при любой полярности напряжения на обкладках. Другая важная особенность — слабая зависимость значения емкости от приложенного напряжения. И, наконец, добротность МДП-конденсаторов значительно превосходит добротность интегральных
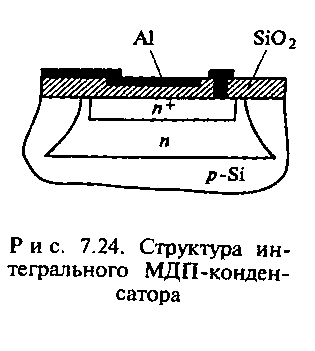
конденсаторов, выполненных в биполярных транзисторных стру турах. Индуктивные элементы в основном пленочные и примен ются в гибридных интегральных СВЧ-схемах, индуктивность добротность которых имеют небольшие значения.
Контрольные вопросы
1. Что такое униполярный транзистор?
2. Нарисуйте структуру и ВАХ транзистора с индуцированным каналом. ?
3. Нарисуйте структуру и ВАХ транзистора со встроенным каналом.
4. Что такое пороговое напряжение?
5. В чем заключается эффект поля? £
6. Что такое КМОП-транзисторы? Щ
7. Что такое Я^Л/Г-транзисторы?
8. Какова структура и ВАХ арсенид-галиевого ПТШ-транзистора? Я
9. Какие конструкции транзистора с вертикальным токопереносом вы Я
знаете? 9
10. Расскажите о транзисторе с двойным затвором.
11. Что такое биполярный транзистор?
12. Объясните физические принципы работы биполярного транзистора.
13. Какие режимы работы транзистора вы знаете?
14. Что такое многоэмиттерный транзистор?
15. Что такое многоколлекторный транзистор?
16. Объясните принцип работы транзистора с инжектором?
17. Объясните принцип работы транзистора с диодом Шотгки?
18. Что такое элементы и компоненты интегральных схем?
19. Какие методы изоляции транзисторных структур вы знаете?
20. Расскажите о методе изоляции типа КНС, КВД.
21. Каковы функции диодов в интегральных схемах?
22. Какие схемы диодного включения транзистора вы знаете?
23. Расскажите о интегральном резисторе.
24. Как связано сопротивление резистора с коэффициентом формы?
25. Что такое диффузионный резистор?
26. Как устроен интегральный резистор МОП-структуры?
27. Дайте определение интегральному конденсатору.
28. Как рассчитать емкость интегрального конденсатора?
29. Дайте определение добротности интегрального конденсатора.
Дата добавления: 2016-06-13; просмотров: 6013;
